消息稱三星和 SK 海力士改進 HBM 封裝工藝,即將量產 12 層產品
IT之家 9 月 12 日消息,根據韓國 The Elec 報道,三星電子和 SK 海力士兩家公司加速推進 12 層 HBM 內存量產。生成式 AI 的爆火帶動英偉達加速卡的需求之外,也帶動了對高容量存儲器(HBM)的需求。HBM 堆疊的層數越多,處理數據的能力就越強,目前主流 HBM 堆疊 8 層,而下一代 12 層也即將開始量產。
本文引用地址:http://www.j9360.com/article/202309/450467.htm
報道稱 HBM 堆疊目前主要使用正使用熱壓粘合(TCB)和批量回流焊(MR)工藝,而最新消息稱三星和 SK 海力士正在推進名為混合鍵合(Hybrid Bonding)的封裝工藝,突破 TCB 和 MR 的發熱、封裝高度等限制。
Hybrid Bonding 中的 Hybrid 是指除了在室溫下凹陷下去的銅 bump 完成鍵合,兩個 Chip 面對面的其它非導電部分也要貼合。因此,Hybrid Bonding 在芯粒與芯粒或者 wafer 與 wafer 之間是沒有空隙的,不需要用環氧樹脂進行填充。
IT之家援引該媒體報道,三星電子和 SK 海力士等主要公司已經克服這些挑戰,擴展了 TCB 和 MR 工藝,實現最高 12 層。

報道稱采用 Hybrid Bonding 工藝之后,顯著提高了輸入 / 輸出(IO)吞吐量,允許在 1 平方毫米的面積內連接 1 萬到 10 萬個通孔(via)。









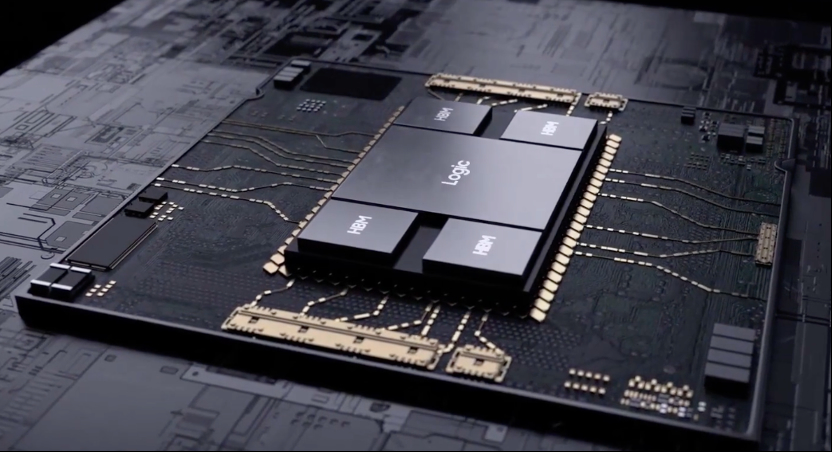




評論