比利時IMEC等開發出60μm厚的柔性三維封裝技術
比利時研究機構IMEC開發出了厚度不足60μm的柔性三維封裝“ultra-thin chip package(UTCP)”(新聞發布)。并在09年3月10~11日于比利時舉行的“SMART SYSTEMS INTEGRATION 2009”上發布。UTCP由IMEC與其合作伙伴比利時根特大學(Ghent University)共同開發。通過使用該技術,用于監測健康狀態等的電子底板可以隱蔽地內置于衣服中。
本文引用地址:http://www.j9360.com/article/92797.htmUTCP制造工藝,首先要將芯片厚度減薄至25μm,接著對其進行薄柔性封裝。并利用普通的柔性底板和原制造工藝將這個封裝好的芯片嵌入雙層結構的柔性底板中。之后可在底板上安裝其它部件實現高密度封裝。以UTCP制造的柔性底板與原柔性底板兼容,布線間距支持100μ~300μm。
IMEC等此次應用UTCP技術試制了無線測量心率和肌電位的模塊。以UTCP技術封裝微控制器并將其內置于柔性底板,還在柔性底板表面安裝了測量身體用放大器芯片和RF晶體管等。








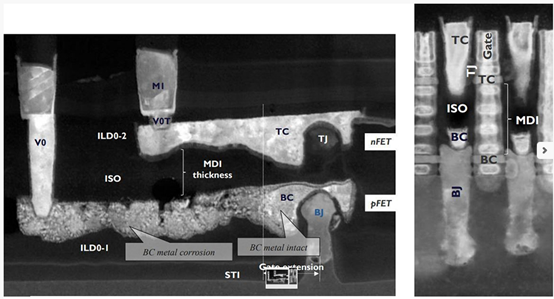


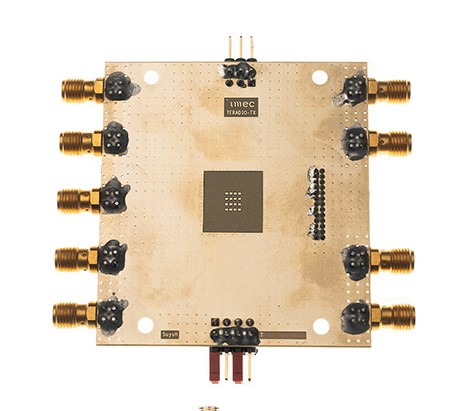

評論