臺積電打算將FOPLP封裝技術帶入美國,以滿足當地客戶的需求
上個月臺積電(TSMC)宣布,有意增加1000億美元投資于美國先進半導體制造,擴大投資計劃包括了三座新建晶圓廠、兩座先進封裝設施、以及一間主要的研發團隊中心。臺積電在美國亞利桑那州鳳凰城的晶圓廠名為Fab 21,前后花了大概五年時間才完成第一間晶圓廠。不過隨著項目的推進,臺積電在當地的設施建造速度變得更快。
本文引用地址:http://www.j9360.com/article/202504/469487.htm據TrendForce報道,臺積電打算將FOPLP封裝技術帶入美國,以滿足當地客戶日益增長的需求。臺積電正在確定FOPLP封裝的最終規格,以加快大規模生產的時間表。初代產品預計采用300mm x 300mm的面板尺寸,比之前測試使用的515mm x 510mm規格要小一些。
目前臺積電在中國臺灣桃園建造一條試點生產線,預計最早2027年開始試產。臺積電還曾嘗試與群創等面板廠商合作,不過最后選擇自行開發,原因是目前面板行業的精度和技術實力不足以滿足臺積電的標準。
臺積電的3D Fabric系統集成平臺對先進封裝進行了分類,包括了三個部分,分別是用于3D芯片堆疊技術的前端封裝SoIC、以及用于后端先進封裝的CoWoS和InFO系列,其中基于FOWLP(扇出晶圓級封裝)的InFO封裝在2016年首次應用于iPhone 7的A10處理器。
近年來又發展出了FOPLP技術,提供了單位成本更低的封裝,客戶也被更具成本效益的解決方案所吸引,從而導致需求不斷上升,不少芯片設計公司計劃用在新一代AI芯片上。



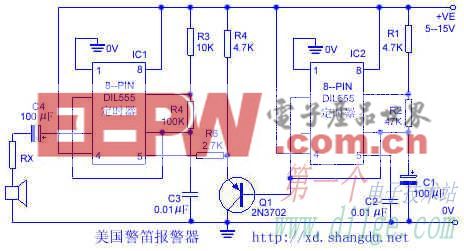











評論