- 隨著從 HBM 到 3D 封裝中的集成 RF、電源和 MEMS 等所有產品的需求不斷增長,晶圓廠工具正在針對 TSV 工藝進行微調。
- 關鍵字:
TSV 封裝

- 隨著半導體行業的快速發展,先進封裝技術成為了提升芯片性能和功能密度的關鍵。近年來,作為2.5D和3D封裝技術之間的一種結合方案,3.5D封裝技術逐漸走向前臺。什么是3.5D封裝技術3.5D封裝技術最簡單的理解就是3D+2.5D,通過將邏輯芯片堆疊并將它們分別粘合到其他組件共享的基板上,創造了一種新的架構。能夠縮短信號傳輸的距離,大幅提升處理速度,這對于人工智能和大數據應用尤為重要。不過,既然有了全新的名稱,必然要帶有新的技術加持 —— 混合鍵和技術(Hybrid Bonding)。混合鍵合技術的應用為3.
- 關鍵字:
封裝技術 TSV 中介層 3.5D
- 8月8日,江蘇芯夢TSV先進封裝研發中心揭牌儀式在中吳潤金先進制造產業園舉行。據江蘇芯夢介紹,其TSV先進封裝研發中心為江蘇芯夢半導體設備有限公司打造,中心以水平式電化學沉積工藝為核心,以自主研發為導向,構建先進封裝產業全工藝流程測試平臺。該研發中心總面積1232.8㎡,擁有千級和百級兩種測試潔凈環境。配備自研生產的Xtrim-ECD
電鍍設備及全套涂膠、曝光、顯影、蝕刻等先進封裝主流程工藝設備,可實現先進封裝中RDL、Bumping、TSV等電鍍工藝的打樣測試;同時還配備了Xtrim-FC
- 關鍵字:
江蘇芯夢 TSV 先進封裝
- 前言從HBM存儲器到3D NAND芯片,再到CoWoS,硬件市場上有許多芯片是用英文稱為TSV構建的,TSV是首字母縮寫,TSV(Through Silicon Via)中文為硅通孔技術。它是通過在芯片與芯片之間、晶圓和晶圓之間制作垂直導通;TSV技術通過銅、鎢、多晶硅等導電物質的填充,實現硅通孔的垂直電氣互聯,這項技術是目前唯一的垂直電互聯技術,是實現3D先進封裝的關鍵技術之一。在本文中,我們將告訴您它們是什么,它們如何工作以及它們的用途。在2000年的第一個月,Santa Clara Universi
- 關鍵字:
芯片 TSV HBM NAND 先進封裝
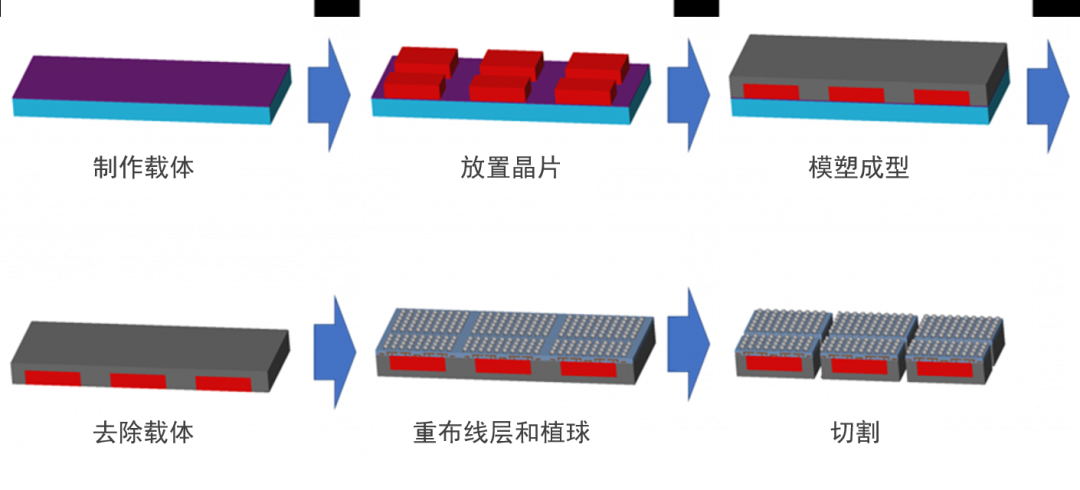
- 芯片封裝早已不再僅限于傳統意義上為獨立芯片提供保護和I/O擴展接口,如今有越來越多的封裝技術能夠實現多種不同芯片之間的互聯。先進封裝工藝能提高器件密度并由此減小空間占用,這一點對于手機和自動駕駛汽車等電子設備的功能疊加來說至關重要。芯片封裝行業的發展使國際電氣電子工程師協會電子元件封裝和生產技術學會(IEEE-CPMT)意識到必須要拓展自身的技術范疇,并于2017年正式更名為國際電氣電子工程師協會電子封裝學會(IEEE- EPS)。有一種先進封裝技術被稱為“晶圓級封裝”(WLP),即直接在晶圓上完成集成電
- 關鍵字:
TSV WLP
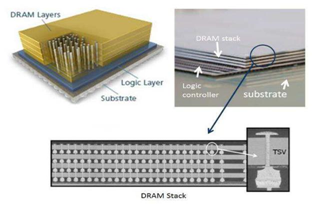
- 摘要從低密度的后通孔TSV 硅3D集成技術,到高密度的引線混合鍵合或3D VSLI CoolCubeTM解決方案,研究人員發現許多開發新產品的機會。本文概述了當前新興的硅3D集成技術,討論了圖像傳感器、光子器件、MEMS、Wide I/O存儲器和布局先進邏輯電路的硅中介層,圍繞3D平臺性能評估,重點介紹硅3D封裝的主要挑戰和技術發展。硅的 3D應用機會從最初為圖像傳感器設計的硅2.5D集成技術[1],到復雜的高密度的高性能3D系統,硅3D集成是在同一芯片上集成所有功能的系統芯片(SoC)之外的另一種支持各
- 關鍵字:
TSV 硅3D
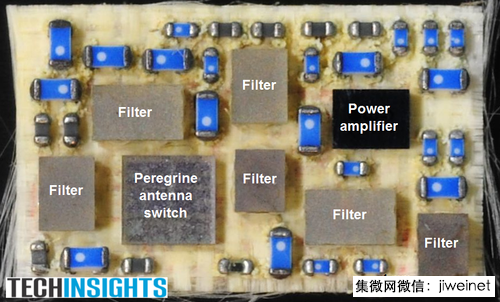
- 新興封裝技術的出現,主要的驅動力量就來自于永無止境地追求更輕薄短小的智慧型手機。
- 關鍵字:
封裝 TSV
- 日前,Alchimer, SA 宣布與法國研究機構CEA-Leti 達成協作合約,以評估和實施Alchimer為300mm 大批量生產的濕式沉積工藝。該專案將為隔離層、阻擋層和晶種層評估Alchimer 的Electrografting (eG?) 和Chemicalgrafting (cG?) 制程。
- 關鍵字:
Alchimer 3D TSV
- 市調機構Yole Developpement稍早前發布了一份針對3DIC與矽穿孔 ( TSV )的調查報告,指出過去一年來,所有使用TSV封裝的3DIC或3D-WLCSP平臺(包括CMOS影像感測器、環境光感測器、功率放大器、射頻和慣性MEMS元件)等產品產值約為27億美元,而到了2017年,該數字還可望成長到400億美元,占總半導體市場的9%。
Yole Developpement的先進封裝部市場暨技術分析師Lionel Cadix 指出,3DIC通常使用TSV 技術來堆疊記憶體和邏輯IC,預
- 關鍵字:
半導體 3D TSV

- 單片型3D芯片集成技術與TSV的研究,盡管晶體管的延遲時間會隨著晶體管溝道長度尺寸的縮小而縮短,但與此同時互聯電路部分的延遲則會提升。舉例而言,90nm制程晶體管的延遲時間大約在 1.6ps左右,而此時互聯電路中每1mm長度尺寸的互聯線路,其延遲時間會
- 關鍵字:
TSV 研究 技術 集成 3D 芯片 單片
- 3D-IC設計者希望制作出高深寬比(HAR>10:1)硅通孔(TSV),從而設計出更小尺寸的通孔,以減小TSV通孔群在硅片上的占用空間,最終改進信號的完整性。事實上,當前傳統的TSV生產供應鏈已落后于ITRS對其的預測。以干法和濕
- 關鍵字:
TSV 電接枝 助力
- 通孔硅技術(TSV)代工廠商Allvia購買了位于Hillsboro Ore的一處制造工廠。
該工廠將用于基于TSV技術產品的量產。該廠房擁有178000平方英尺的大樓,60000平方英尺的凈化間,并將擴展至80000片平方英尺。
該公司預計該工廠于2010年投入運營。
- 關鍵字:
Allvia TSV
- 經國家發改委批準,以國內集成電路封測領軍企業江蘇長電科技股份公司為依托,聯合中科院微電子研究所、清華大學微電子所、深圳微電子所、深南電路有限公司等五家機構,共同組建的中國首家“高密度集成電路封裝技術國家工程實驗室”日前在位于無錫江陰的長電科技掛牌,標志著國家重點扶持的集成電路封裝技術產學研相結合的工程實驗平臺正式啟動。
近年來,國內外集成電路( IC)市場的需求不斷上升,產業規模發展迅速, IC產業已成為國民經濟發展的關鍵。旺盛的封測市場需求給國內的封測企業帶來了良好的發
- 關鍵字:
集成電路 WLCSP SiP 封測 IC封裝 FCBGA TSV MIS
tsv介紹
TSV TSV的英文全拼是“Through Silicon Vias”,中文意思為“通過硅片通道”。
英特爾公司首席技術官賈斯廷·拉特納表示,TSV技術是英特爾公司的工程師首先為未來的80核處理器產品開發的。這項技術的實質,是每一個處理內核通過一個TSV通道直接連接一顆256KB的內存芯片(充當了緩存),隨著緩存數量的增加,這些緩存將可以替代另外的內存芯片。
拉特納指出,雖然TSV技 [
查看詳細 ]
關于我們 -
廣告服務 -
企業會員服務 -
網站地圖 -
聯系我們 -
征稿 -
友情鏈接 -
手機EEPW
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產品世界》雜志社 版權所有 北京東曉國際技術信息咨詢有限公司

京ICP備12027778號-2 北京市公安局備案:1101082052 京公網安備11010802012473