IGBT等功率器件:芯片更薄,封裝散熱更好,集成度更高
近日,三菱電機功率半導體制作所參加了上海2014年PCIM亞洲展,總工程師佐藤克己介紹了IGBT等功率器件的發展趨勢。
本文引用地址:http://www.j9360.com/article/256794.htmIGBT芯片發展進程
IGBT芯片始于19世紀80年代中期。30年以來,就FOM(優點指數)來說,今日的IGBT芯片比第一代性能提升了20倍左右,其中改良技術包括:精細化加工工藝、柵式IGBT的開發(如三菱電機的CSTBT),以及薄晶圓的開發等等。如今,三菱電機的IGBT芯片已經踏入第7代,正朝第8代邁進。
隨著產品的更新換代,功耗越來越低,尺寸越來越小。從80年代中期至今,芯片尺寸只是原來的1/4。

根據IGBT電流容量和市場需求,功率器件分成四大類,包括用于家電變頻器的小功率器件,用于工業的較大功率器件,應用在電動汽車的中功率器件,用于電力和牽引的大功率器件。今后都將朝高電流密度、小型化封裝及低損耗方向演進。
具體改良措施
三菱電機第7代IGBT模塊,功耗降低了約15%~20%,分NX(通用)系列和STD(標準)系列兩種封裝,取消了絕緣基板,提高了散熱性,使產品變得更輕,效率提升了35%。為了降低反復開關造成的噪音,三菱電機增強了通過柵極電阻調節dv/dt的可控性。
● 晶圓片更薄。芯片變薄,使功耗得以降低,但變薄后耐壓特性會變差,所以要適度逐層調整,才能使之更耐用和更有效。第7代IGBT芯片涵蓋的電壓等級有600V、1200V和1700V。 在晶圓尺寸方面,從2000年開始的5英寸,發展至今日的8英寸,最薄達到50微米。晶圓還會繼續朝12英寸發展,產品變得更薄,電阻更低。
目前之所以8英寸晶圓是主流,除了晶圓尺寸外,還要考慮基板問題。現在還沒有供應商能提供12英寸穩定高壓IGBT使用的基板;反觀8英寸單晶硅的硅板基板供貨穩定,價格比12英寸低很多。
● 封裝。功率器件的封裝技術決定其散熱性能。為了保護裸晶圓不受外界干擾,所有IGBT及IPM模塊都要封裝起來,甚至把功能集成起來,這樣使用起來更方便及安全,也縮短客戶產品開發周期。在最新一代的封裝技術中,三菱電機采用了針型散熱器,結合到銅基板或鋁基板上,系統將更小型化。
● 應用。需要根據一些特殊應用調整產品。例如電動汽車IGBT與一般工業用的IGBT在技術工藝性能上的主要區別在生產工序,因為是車載產品,需要實現超高品質車載級模塊。在IGBT加工工序的開始,每個生產工序都需要管理,對生產過程進行精細控制,產品出貨時要有檔案管理。如果有一個產品出問題,馬上可以查到數據。目前,日系混合動力車基本上使用三菱電機的模塊。
未來方向
*第8代IGBT。1200V第7代IGBT芯片100微米厚,但通過理論計算,要達到1200V耐壓值,芯片厚度可以減少到80微米。第8代IGBT將朝芯片晶圓超薄化,并提升加工工藝的方向發展,不僅提升晶圓性能,同時達到降低損耗的效果。
*SiC/混合SiC。目前碳化硅(SiC)價格較高,適合高性價比的場合。對于一般的家用或低壓變頻器產品,就算是混合碳化硅的價格也沒法接受。在研發混合碳化硅產品時,目標是價格不超過同等電流等級單晶硅產品的兩倍。在生產中,由于碳化硅本身的基板上壞點比單晶硅多,成品率低,造成價格居高不下。估計至少5至8年碳化硅/混合碳化硅才能商品化。
三菱電機已開始引入混合碳化硅產品,即IGBT芯片用傳統單晶硅,續流二極管用碳化硅,恢復特性特別好,開關頻率越高,節能效果更好。例如,在30kHz開關的應用條件下,混合碳化硅產品的功耗可以降低50%,非常適合應用于醫療設備,如核磁共振和CT彩超等應用中。
可控硅相關文章:可控硅工作原理
比較器相關文章:比較器工作原理








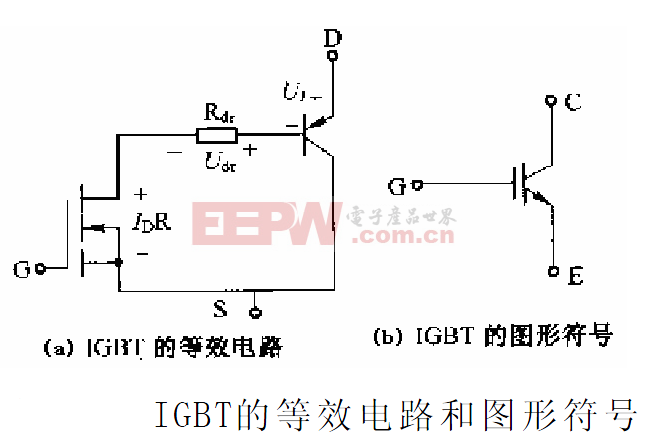
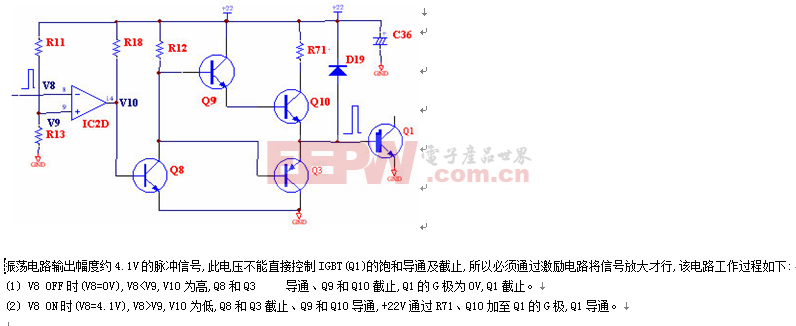
評論