玻璃基板,走到臺前
人工智能對高性能、可持續計算和網絡硅片的需求無疑增加了研發投入,加快了半導體技術創新的步伐。隨著摩爾定律在芯片層面的放緩,人們希望在 ASIC 封裝內封裝盡可能多的芯片,并在封裝層面獲得摩爾定律的好處。
本文引用地址:http://www.j9360.com/article/202503/467541.htm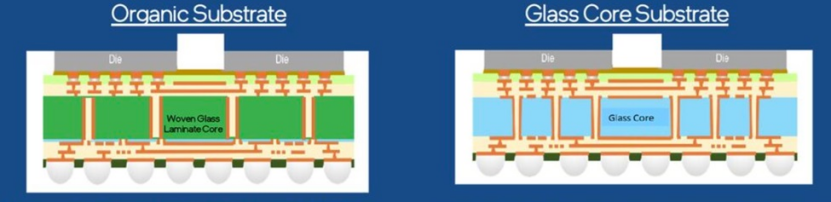
英特爾關于玻璃基板的演示
承載多個芯片的 ASIC 封裝通常由有機基板組成。有機基板由樹脂(主要是玻璃增強環氧層壓板)或塑料制成。根據封裝技術,芯片要么直接安裝在基板上,要么在它們之間有另一層硅中介層,以實現芯片之間的高速連接。有時在基板內部嵌入互連橋而不是中介層來提供這種高速連接。
有機基板的問題在于它們容易出現翹曲問題,尤其是在芯片密度較高的較大封裝尺寸中。這限制了封裝內可封裝的芯片數量。這時,玻璃基板可能會改變游戲規則。
玻璃基板的優點
它們可以做得非常平坦,從而實現更精細的圖案化和更高的(10 倍)互連密度。在光刻過程中,整個基板會受到均勻曝光,從而減少缺陷。
玻璃具有與其上方的硅芯片相似的熱膨脹系數,可降低熱應力。
它們不會翹曲,并且可以在單個封裝中處理更高的芯片密度。初始原型可以處理比有機基板高 50% 的芯片密度。
可以無縫集成光學互連,從而產生更高效的共封裝光學器件。
這些通常是矩形晶圓,可增加每個晶圓上的芯片數量,從而提高產量并降低成本。
玻璃基板有可能取代封裝內的有機基板、硅中介層和其他高速嵌入式互連。
然而,也存在一些挑戰:玻璃易碎,在制造過程中容易破裂。這種脆弱性需要小心處理和使用專門的設備,以防止在制造過程中損壞。確保玻璃基板與半導體堆棧中使用的其他材料(如金屬和電介質)之間有適當的粘合是一項挑戰。材料特性的差異會導致界面處產生應力,從而可能導致分層或其他可靠性問題。雖然玻璃的熱膨脹系數與硅相似,但它與 PCB 板/凸塊中使用的材料有很大不同。這種不匹配會在溫度循環過程中引起熱應力,影響可靠性和性能。
由于缺乏既定的玻璃基板行業標準,導致不同供應商的性能存在差異。由于該技術尚屬新興技術,因此缺乏足夠的長期可靠性數據。需要進行更多的加速壽命測試,才能確保將這些封裝用于高可靠性應用。
盡管存在缺點,玻璃基板對于 HPC/AI 和 DC 網絡硅片仍有很大的前景,其重點是在 ASIC 封裝內封裝盡可能多的吞吐量,以提高系統的整體規模、性能和效率。
英特爾、臺積電、三星和 SKC 等主要代工廠都在大力投資這項技術。2023 年 9 月,英特爾推出行業首個玻璃基板先進封裝計劃,宣布在 2030 年之前面向先進封裝采用玻璃基板。英特爾預計到 2030 年末,半導體行業可能會達到其使用有機材料在硅封裝上縮放晶體管的極限。
隨著對更強大計算的需求增加,半導體行業進入在封裝中使用多個「小芯片」的異構時代,提高信號傳輸速度、功率傳輸、設計規則和封裝基板的穩定性將是至關重要的。與目前使用的有機基板相比,玻璃基板具有優異的機械、物理和光學性能,可以在封裝中連接更多的晶體管,提供更好的可擴展性,并組裝更大的小芯片復合體(SoC,系統級封裝)。玻璃基板技術或成為幫助英特爾在一個封裝上擴展 1 萬億個晶體管目標的關鍵。
去年 5 月初,三星電機 (Samsung Electro Mechanics) 宣布預期 2026 年面向高端 SiP 開始生產玻璃基板。在 1 月的 CES 2024 上,三星電機已提出,今年將建立一條玻璃基板原型生產線,目標是 2025 年生產原型,2026 年實現量產。京東方、臺積電、群升工業、安普電子等也在積極探索玻璃基板技術。先進封裝產能擴張速度難以跟上 AI 芯片爆發式增長的需求,使用玻璃基板的先進封裝是優秀解決方案。
在芯片設計方面,AMD 正積極進行芯片產品導入玻璃基板測試;玻璃基板業務已經趨于成熟,康寧、旭硝子、肖特均具備高精度玻璃晶圓或基板供應能力;在激光通孔業務上,LPKF、Samtec 等廠商能夠提供成熟的激光通孔(TGV)解決方案。



評論