玻璃基板,成為新貴
隨著AI和高性能電腦對計算能力和數據處理速度的需求日益增長。半導體行業也邁入了異構時代,即封裝中廣泛采用多個“Chiplet”。
本文引用地址:http://www.j9360.com/article/202404/457609.htm在這樣的背景下,信號傳輸速度的提升、功率傳輸的優化、設計規則的完善以及封裝基板穩定性的增強顯得尤為關鍵。然而,當前廣泛應用的有機基板在面對這些挑戰時顯得力不從心,因此,尋求更優質的材料來替代有機基板。
玻璃基板,是英特爾作出的回答。
英特爾已在玻璃基板技術上投入了大約十年時間。去年9月,英特爾宣布率先推出用于下一代先進封裝的玻璃基板,并計劃在未來幾年內向市場提供完整的解決方案,從而使單個封裝內的晶體管數量不斷增加,繼續推動摩爾定律,滿足以數據為中心的應用的算力需求。
英特爾表示,將于本十年晚些時候使用玻璃基板進行先進封裝。第一批獲得玻璃基板處理的產品將是其規模最大、利潤最高的產品,例如高端HPC(高性能計算)和AI芯片。
那么,玻璃基板究竟擁有哪些顯著優勢?它在未來的發展中又將如何發揮重要作用?
01
為什么需要玻璃基板?
基板的需求始于早期的大規模集成芯片,隨著晶體管數量增加,需要將它們連接到更多的引腳上。在過去20多年的時間里,打造基板所用的主要材料是有機塑料,但隨著單個封裝內的芯片和連線數量越來越多,有機基板正在接近物理極限。
因此,近年來出現了超高密度互連接口技術,如CoWoS和Intel的EMIB技術。這些技術使公司能夠用快速、高密度的硅片來橋接芯片的關鍵路徑,但成本相當高,而且沒有完全解決有機基板的缺點。
在這樣的背景下,業內公司開始致力于探索有機基板的真正替代者,尋求一種能與大型芯片完美融合的基板材料。盡管這種材料在最高級別的需求上可能無法完全替代CoWoS或EMIB技術,但它卻能夠提供比現有有機基板更出色的信號傳輸性能和更密集的布線能力。
玻璃基板如何適用于大芯片和先進封裝?


首先,玻璃的主要成分是二氧化硅,在高溫下更穩定。因此,玻璃基板可以更有效地處理更高的溫度,同時有效管理高性能芯片的散熱。這使得芯片具有卓越的熱穩定性和機械穩定性。
其次,玻璃基板可實現更高的互連密度,這對于下一代封裝中的電力傳輸和信號路由至關重要,這將顯著增強芯片封裝內晶體管的連接性。典型的例子:英特爾將生產面向數據中心的系統級封裝(SiP),具有數十個小瓦片(tile),功耗可能高達數千瓦。此類SiP需要小芯片之間非常密集的互連,同時確保整個封裝在生產過程中或使用過程中不會因熱量而彎曲。玻璃基板便是當下的最優解。
最后,玻璃更容易變得平坦,這使得封裝和光刻變得更容易,這對于下一代SiP來說非常重要。據悉,同樣面積下,玻璃基板的開孔數量要比在有機材料上多得多,并且玻璃芯通孔之間的間隔能夠小于 100 微米,這直接能讓芯片之間的互連密度提升10倍。英特爾消息人士稱,玻璃基板可將圖案畸變減少 50%,從而提高光刻的聚焦深度,從而確保半導體制造更加精密和準確。英特爾預計玻璃基板能夠實現容納多片硅的超大型24×24cm SiP,憑借單一封裝納入更多晶體管,從而實現更強大的算力。
02
業界巨頭爭相布局
不只是英特爾,在當今半導體領域的激烈競爭中,玻璃基板作為半導體行業的一顆璀璨新星,正受到包括三星、LG以及蘋果在內的眾多科技巨頭的青睞。
三星組建“軍團”加碼研發
近日,根據韓媒 sedaily 報道,三星集團已組建了一個新的跨部門聯盟,三星電子、三星顯示、三星電機等一眾旗下子公司們組成“統一戰線”,著手聯合研發玻璃基板,推進商業化。其中,預計三星電子將掌握半導體與基板相結合的信息,三星顯示將承擔玻璃加工等任務。
三星將玻璃基板視為芯片封裝的未來,在1月的CES 2024上,三星電機已提出,今年將建立一條玻璃基板原型生產線,目標是2025年生產原型,2026年實現量產。
組建“軍團”加碼研發,這足以見得三星集團對玻璃基板的重視,而在這項技術領域中,已有多個強勁對手入局。
LG Innotek已著手準備
今年3月,LG Innotek CEO Moon Hyuk-soo 在例行股東大會上表示:“將把半導體基板和電子系統組件業務發展到第一。”在回答有關發展半導體玻璃基板業務的問題時,Moon Hyuk-soo 表示:“我們半導體基板的主要客戶是美國一家大型半導體公司,該公司對玻璃基板表現出極大的興趣。當然,我們正在為此做準備。”
AMD開始性能評估測試
AMD正對全球多家主要半導體基板企業的玻璃基板樣品進行性能評估測試,計劃將這一先進基板技術導入半導體制造。據悉,此次參與的上游企業包括日企新光電氣、臺企欣興電子、韓企三星電機和奧地利AT&S。業界預測AMD最早于2025—2026年的產品中導入玻璃基板,以提升其HPC產品的競爭力。
蘋果積極探索玻璃基板
據悉,蘋果也正積極探索將玻璃基板技術應用于芯片封裝 。玻璃基板的應用不僅是材料上的革新,更是一場全球性的技術競賽,它有望為芯片技術帶來革命性的突破,并可能成為未來芯片發展的關鍵方向之一。蘋果公司的積極參與可能會加速玻璃基板技術的成熟,并為芯片性能的提升帶來新的突破。
除了芯片制造領域,玻璃基板還有望在智能手機、平板電腦、電視等消費電子產品的顯示屏制造中發揮重要作用。這些產品的更新換代速度不斷加快,對高質量玻璃基板的需求也將持續增長。
目前來看,臺積電在CoWoS領域火力全開,接連獲得大廠訂單享受紅利,因而它并不急于投入巨資押注玻璃基板,仍將繼續沿著現有路徑升級迭代,以保持領先地位不可撼動。或許等臺積電覺得時機成熟,將會大幅加碼。
03
先進封裝中,主流的有機基板
在SiP及先進封裝中最常用到的基板包含三類:有機基板、陶瓷基板、硅基板。
有機基板由于具有介電常數低、質量密度低、加工工藝簡單、生產效率高和成本低等優點,是目前市場占有率最高的基板。有機基板是在傳統印制電路板(PCB)的制造原理和工藝的基礎上發展而來的,其尺寸更小、電氣結構復雜,其制造難度遠高于普通PCB。
有機基板主要包含:剛性有機基板、柔性有機基板以及剛柔結合有機基板。
其中,剛性有機基板以熱固性樹脂為基材,采用無機填料和玻璃纖維作為增強材料。這種基板通過熱壓成型工藝制成層壓板,然后與銅箔復合制成。剛性有機基板適用于多種封裝形式,如WB-BGA(通用芯片封裝)、FC-BGA(處理器及南北橋芯片封裝)和FC-CSP(智能手機處理器及其它部件封裝)等。
柔性有機基板以CTE低且平整度高的PI薄膜為介質層,由介質層與銅箔復合制成。這種基板在LED/LCD、觸控屏、計算機硬盤、光驅連接及功能組件、智能手機、平板電腦和可穿戴設備等領域有廣泛應用。
除了上述兩種基板,還有一些其他類型的有機基板也在先進封裝中得到應用,例如ABF樹脂、BT樹脂和MIS基板等。這些基板材料的選擇取決于具體的應用需求、封裝形式以及芯片類型等因素。
目前中國封裝材料和封裝基板的國產化率都比較低,先進基板領域仍待突破。中國臺灣、日本及韓國地區在全球封裝基板市場中份額較高,行業競爭相對穩定。欣興電子、景碩科技、南亞電路、日月光材料等中國臺灣地區企業主要生產WB-CSP、WB-BGA、FC-CSP、FCBGA等封裝基板。
從中國大陸企業布局來看,近年來,越來越多的中國企業正拓展封裝基板領域,中國大陸目前仍處于快速擴產階段,高端FC-BGA基板可以應用于AI、5G、大數據等領域要求的高性能CPU、GPU,但目前FC-BGA基板市場由欣興電子、揖斐電、三星電機等企業壟斷,中國大陸頭部代表企業包括興森科技、深南電路等在2023年對于高端FC-BGA封裝基板方面積極布局,未來高端FC-BGA產能有望進一步擴充。
04
取代有機基板?
根據MarketsandMarkets最近的研究,全球玻璃基板市場預計將從2023年的71億美元增長到2028年的84億美元,2023年至2028年的復合年增長率為3.5%。
如此來看,玻璃基板的市場前景是樂觀的,但是這一賽道依然面臨著諸多不容忽視的挑戰。比如技術的不成熟和居高不下的成本是擋在玻璃基板商用面前的兩大攔路虎
玻璃基板雖然具有優異的物理特性,如高平整度、低熱膨脹系數等,但其硬度大、脆性高的特點也增加了加工難度。如何在保證性能的同時,降低加工難度,提高良品率,是玻璃基板生產中的一大挑戰。
此外在玻璃基板的復雜的生產過程中,需要高精度的工藝和設備,對技術要求極高。同時,為了保持競爭優勢,企業需要持續投入大量研發資金,進行技術創新和產品升級。這也意味著,與任何新技術一樣,玻璃基板的生產和封裝成本將比經過驗證的有機基板更昂貴。這包括原材料成本、加工成本以及后續的封裝和測試成本。就連英特爾目前也還沒有談論具體的量產時間。
玻璃基板作為新生事物,其市場接受度還有待提高。同時,相關的行業標準和技術規范也尚未完善,這可能會影響其推廣和應用。如此來看,玻璃基板距離大范圍的商用或許需要十年以上的時間。
再者,玻璃基板與有機基板在各自的應用領域具有不同的特點和優勢,這使得它們各自在某些特定的使用場景中更為適用。有機基板多用于消費電子領域,而玻璃基板大概率應用于高性能運算等場景,雖然玻璃基板在某些技術上展現出的潛在優勢是有機基板不具備的,但有機基板因其成本效益和在某些特定應用中的成熟性,仍具有穩定的市場需求。因此,兩者并不會完全取代對方,而是在各自的領域里發揮各自的優勢。
05
帶動玻璃通孔技術成為熱門
不只是加速玻璃基板技術的研發,英特爾還計劃引入玻璃通孔技術TGV(Through Glass Via),將類似于硅通孔的技術應用于玻璃基板。
在此之前簡單了解什么是硅通孔,硅通孔技術即TSV(Through Silicon Via),它是通過在芯片與芯片之間、晶圓和晶圓之間制作垂直導通;TSV技術通過銅、鎢、多晶硅等導電物質的填充,實現硅通孔的垂直電氣互聯,這項技術是目前唯一的垂直電互聯技術,是實現3D先進封裝的關鍵技術之一。
玻璃通孔是穿過玻璃基板的垂直電氣互連。與TSV相對應,作為一種可能替代硅基板的材料被認為是下一代三維集成的關鍵技術。
與硅基板相比,玻璃通孔互連技術具有優良的高頻電學特性、大尺寸超薄玻璃基板成本低、工藝流程簡單、機械穩定性強等優勢。可應用于2.5D/3D晶圓級封裝、芯片堆疊、MEMS傳感器和半導體器件的3D集成、射頻元件和模塊、CMOS 圖像傳感器 、汽車射頻和攝像頭模塊。基于此,玻璃通孔三維互連技術成為當前先進封裝的研究熱點。
英特爾在玻璃基板領域的突破無疑為整個行業帶來了新的活力,同時也成功激發了業界對TGV技術以及基板性能的廣泛興趣和深遠期待。這一突破不僅彰顯了英特爾在技術創新上的領先地位,也為整個電子產業帶來了全新的發展機遇。







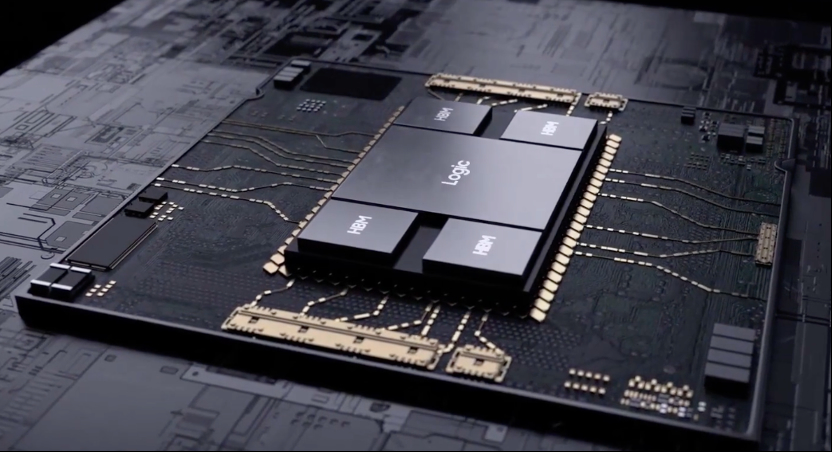



評論