HBM3E起飛,沖鋒戰鼓已然擂響
HBM 即高帶寬內存,是一款新型的 CPU/GPU 內存芯片。如果說傳統的 DDR 就是采用的"平房設計"方式,那么 HBM 則是采用"樓房設計"方式。
本文引用地址:http://www.j9360.com/article/202404/457050.htm目前,HBM 產品以 HBM(第一代)、HBM2(第二代)、HBM2E(第三代)、HBM3(第四代)、HBM3E(第五代)的順序開發。

可以看到,HBM 每一次更新迭代都會伴隨著處理速度的提高。
HBM3 自 2022 年 1 月誕生,便憑借其獨特的 2.5D/3D 內存架構,迅速成為高性能計算領域的翹楚。HBM3 不僅繼承了前代產品的優秀特性,更在技術上取得了顯著的突破。它采用了高達 1024 位的數據路徑,并以驚人的 6.4 Gb/s 的速率運行,實現了高達 819 Gb/s 的帶寬,為高性能計算提供了強大的支持。
而今,SK 海力士、美光等廠商將這一標準再度提升,HBM3E 一經問世便迅速贏得市場的熱烈追捧。
三大存儲巨頭的 HBM3E 技術特點
HBM3E 技術的主要引領者依然是美光、SK 海力士與三星這三大巨頭,它們繼續在這一領域發揮重要作用,共同推動著技術的創新與進步。以下是這三大廠商在 HBM3E 技術方面的精彩呈現。
SK 海力士-獨創的 MR-MUF 技術等
2023 年 8 月 21 日,SK 海力士宣布成功開發出面向 AI 的超高性能 DRAM 新產品 HBM3E,并開始向客戶提供樣品進行性能驗證。
據悉,SK 海力士采用了先進的 MR-MUF(Molding with Rubberand UFP)技術,使得 HBM3E 的散熱性能比上一代產品提高 10%。這種技術通過在半導體芯片堆疊后的空間中注入液體形態的保護材料并進行固化,與每堆疊一個芯片時鋪上薄膜型材料的方式相較,工藝效率更高,散熱方面也更加有效;其 HBM3E 的最高數據處理速度可達每秒 1.18TB(太字節),這意味著它能夠在極短的時間內處理大量數據。相當于在 1 秒內處理 230 部全高清(FHD)級別的電影。
另外,其 HBM3E 提供高達 8Gbps 的傳輸速度,這是相較于前一代 HBM3 的顯著提升。這種高速度對于需要快速數據處理的應用場景,如高性能計算和人工智能,尤為重要。
美光- 1β、先進的硅通孔(TSV)技術等
2023 年 9 月,SK 海力士的 HBM3E 內存迎來新競爭對手-美光。
美光也利用其 1β(1-beta)技術、先進的硅通孔(TSV)和其他實現差異化封裝解決方案的創新技術開發出業界領先的 HBM3E 設計。
憑借其卓越的性能、出色的能效等優勢,美光的 HBM3E 收獲內存市場的諸多青睞。比如美光 HBM3E 引腳速率超過 9.2Gb/s,提供超過 1.2TB/s 的內存帶寬,助力人工智能加速器、超級計算機和數據中心實現超高速的數據訪問;美光 HBM3E 目前提供 24 GB 容量,使數據中心能夠無縫擴展其人工智能應用。無論是用于訓練海量神經網絡還是加速推理任務,美光的解決方案都提供了必要的內存帶寬。
三星-先進的熱壓非導電薄膜技術等
三星也一直在致力于提供更為優秀的產品以滿足人工智能時代對高性能和大容量解決方案的更高要求。
2023 年 10 月 21 日,三星在其一年一度的「存儲器技術日」活動中,發布了名為「Shinebolt」的新一代 HBM3E DRAM。
三星 Shinebolt 支持新一代 AI 應用,可提高總體擁有成本,加速數據中心的 AI 模型訓練和推理。HBM3E 的每個引腳速度高達 9.8Gbps,這意味著整體傳輸速率可超過 1.2TBps。為實現更高的堆疊層數并改善熱特性,三星優化了非導電薄膜 (NCF) 技術,以消除芯片層之間的間隙并盡可能提高導熱性。
2024 年 2 月,三星成功發布其首款 12 層堆疊 HBM3E DRAM——HBM3E 12H,這是三星目前為止容量最大的 HBM 產品。
三星 HBM3E 12H 支持全天候最高帶寬達 1280GB/s,產品容量也達到了 36GB。相比三星 8 層堆疊的 HBM3 8H,HBM3E 12H 在帶寬和容量上大幅提升超過 50%。
HBM3E 12H 采用了先進的熱壓非導電薄膜(TC NCF)技術,使得 12 層和 8 層堆疊產品的高度保持一致,以滿足當前 HBM 封裝的要求。HBM3E 12H 產品的垂直密度比其 HBM3 8H 產品提高了 20% 以上。三星先進的熱壓非導電薄膜技術還通過允許在芯片之間使用不同尺寸的凸塊(bump)改善 HBM 的熱性能。
相比 HBM3 8H,HBM3E 12H 搭載于人工智能應用后,預計人工智能訓練平均速度可提升 34%,同時推理服務用戶數量也可增加超過 11.5 倍。
各家的量產進度
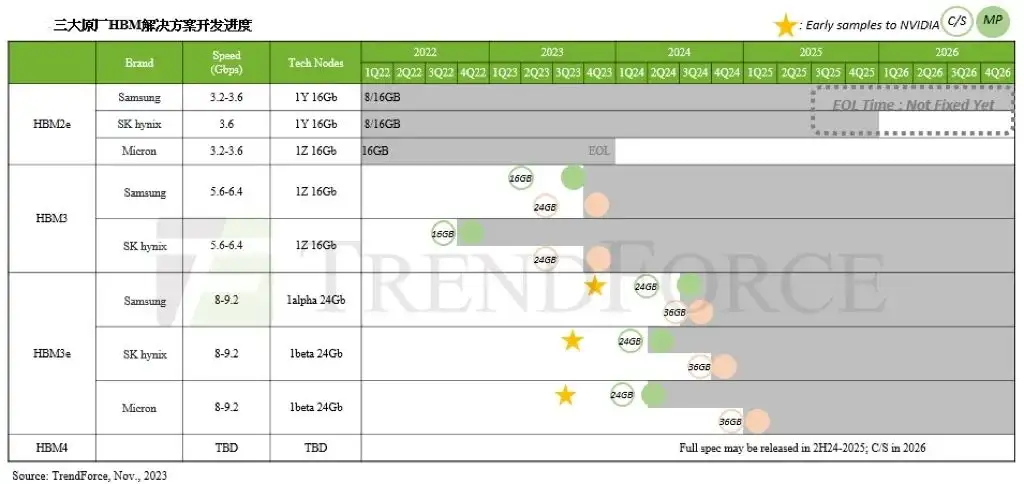
2024 年 3 月 19 日,SK 海力士宣布,公司率先成功量產超高性能用于 AI 的存儲器新產品 HBM3E,將在 3 月末開始向客戶供貨。
SK 海力士作為全球首家推出 HBM3E 的供應商,自去年 8 月宣布開發計劃至今,僅用了短短七個月時間便實現了量產。據悉,SK 海力士的首批 HBM3E 產品將按照預定計劃準時交付給英偉達。
2024 年 2 月 26 日,美光宣布開始量產其 HBM3E 高帶寬內存解決方案。據悉,英偉達 H200 Tensor Core GPU 將采用美光 8 層堆疊的 24GB 容量 HBM3E 內存,并于 2024 年第二季度開始出貨。
目前,三星已開始向客戶提供 HBM3E 12H 樣品,預計于今年下半年開始大規模量產。
競購 HBM3E,英偉達既要又要還要
隨著 AI 服務器的流行,AI 加速卡的需求也呈現出強勁的增長勢頭。而作為 AI 加速卡的重要組成部分,高頻寬存儲器 HBM 正逐漸成為其不可或缺的 DRAM 模塊。
英偉達的下一代 AI 加速卡 B100(Blackwell 架構)的存儲器規格,將采用 HBM3E。而這種規格的存儲器,目前只有 SK 海力士、三星電子和美光能提供。為了保障 HBM 的穩定供應,英偉達甚至需要以大量預付款的形式提供資金支持內存供應商研發 HBM 產品。要知道客戶向內存供應商大規模預付款項的情況是很少見的。
畢竟,急切需要 HBM3E 產能的并非只有英偉達一家,眾多企業都競相爭奪這一稀缺資源,比如 AMD、微軟、亞馬遜等都在排隊購買。
據悉,AMD 將在今年晚些時候推出采用 HBM3e 內存的升級版 MI300 AI 加速器,隨后于 2025 年推出新一代 Instinct MI400。除英偉達和 AMD 之外,亞馬遜和微軟則是云服務領域的兩大巨頭,之前已引入生成式人工智能技術,并大幅追加了對于 AI 領域的投資。報道稱,SK 海力士正忙于應對客戶對 HBM3E 樣品的大量請求,但滿足英偉達首先提出的樣品數量要求非常緊迫。
在這場競賽的伊始,兩大 HBM 供應商的產能迅速被搶購一空。
近日,SK 海力士副總裁 Kim Ki-tae 在一篇博文中表示,雖然 2024 年才剛開始,但今年 SK 海力士旗下的 HBM 已經全部售罄。同時,公司為了保持市場領先地位,已開始為 2025 年預作準備。美光科技也表示今年 HBM 產能已銷售一空,2025 年絕大多數產能已被預訂。
此前英偉達聯合創始人兼 CEO 黃仁勛在 GTC 2024 大會上表示,英偉達正在測試三星的 HBM 芯片,可能會在未來采用。
這也意味著,在當前供需關系異常緊張的背景下,英偉達不僅依賴 SK 海力士和美光兩家提供 HBM3E 產能,還急需三星的加入以滿足其日益增長的需求。
如此來看,在 AI 發展如日中天的當下,HBM3E 的 2024 年產能存在嚴重不足。
2024 年 HBM 供給位元年增長率有望高達 260%
據集邦咨詢,截至 2024 年底,整體 DRAM 產業規劃生產 HBM TSV 的產能約為 250K/m,占總 DRAM 產能(約 1,800K/m)約 14%,原廠持續加大投入,供給位元年增長率有望高達 260%。
占比方面,HBM 需求持續旺盛,2024 年訂單已基本被買家鎖定,占 DRAM 總產值比重有望從 2023 年的 8.4% 提升至 2024 年的 20.1%,成長迅速。
該機構同時預估了三大 HBM 廠商的 HBM/TSV 產能,其中三星 HBM TSV 年產能將在 2024 年達到 130K/m。SK 海力士次之,可達 120~125K/m;美光相對較少,僅為 20K/m、目前三星、SK 海力士規劃提高 HBM 產能最積極,其中 SK 海力士在 HBM3 市場的占有率逾 90%,而三星將連續數個季度緊追,未來將受惠于 AMD MI300 芯片的逐季放量。

HBM 高帶寬存儲芯片晶圓的尺寸相比同容量、同制程的 DDR5 大 35%~45%,然而良率(包含 TSV 封裝良率)要低 20%~30%。生產周期方面,HBM 的制造工藝(包含 TSV)較 DDR5 長 1.5~2 個月不等。由于 HBM 芯片生產周期更長,從投片到產出、封裝完成需要兩個季度以上。因此,急需取得充足供貨的買家更早鎖定訂單。
去年 6 月有媒體報道稱,SK 海力士正在準備投資后段工藝設備,將擴建封裝 HBM3 的利川工廠,預計到今年年末,該廠后段工藝設備規模將增加近一倍。
近日,SK 海力士正計劃投資大約 40 億美元,在美國印第安納州西拉斐特新建大型的先進芯片封裝工廠,力爭擴張 HBM 存儲產能以滿足英偉達龐大需求。該大型先進封裝工廠可能于 2028 年開始運營。
為了縮小差距,美光也對其下一代產品 HBM3E 下了很大的賭注。據悉,美光科技位于中國臺灣的臺中四廠已于 2023 年 11 月初正式啟用。美光表示,臺中四廠將整合先進探測與封裝測試功能,量產 HBM3E 及其他產品,從而滿足人工智能、數據中心、邊緣計算及云端等各類應用日益增長的需求。
三星電子從去年第四季度開始擴大第四代 HBM 即 HBM3 的供應,目前正進入一個過渡期。負責三星美國半導體業務的執行副總裁 Han Jin-man 在今年 1 月表示,公司對包括 HBM 系列在內的大容量存儲芯片寄予厚望,希望它能引領快速增長的人工智能芯片領域。他在 CES 2024 的媒體見面會上對記者說,「我們今年的 HBM 芯片產量將比去年提高 2.5 倍,明年還將繼續提高 2 倍。」
三星官方還透露,公司計劃在今年第四季度之前,將 HBM 的最高產量提高到每月 15 萬至 17 萬件,以此來爭奪 2024 年的 HBM 市場。此前三星電子斥資 105 億韓元收購了三星顯示位于韓國天安市的工廠和設備,以擴大 HBM 產能,同時還計劃投資 7000 億至 1 萬億韓元新建封裝線。
然而值得注意的是,日前,海外分析師表示,三星 HBM3 芯片的生產良率約為 10%~20%,而 SK 海力士的 HBM3 良率可達 60%~70%。最大的原因就在于三星堅持使用熱壓非導電薄膜(TC NCF)制造技術,這會導致一些生產問題。而 SK 海力士則大規模采用回流模制底部填充(MR-MUF)技術,可以克服 NCF 的弱點。為提高產量,三星正在積極與材料制造商展開談判,其中包括日本的 Nagase 等公司,旨在獲取 MUF 材料的穩定供應。據悉,盡管三星已經下達了用于 MUF 技術的芯片制造設備采購訂單,但由于需要進行更多的測試和優化,使用 MUF 技術大規模生產高端芯片最早可能要到明年才能準備就緒。
HBM 量價齊升,國產廠商迎頭趕上
國內存儲廠商也在入局 HBM 市場。
根據采招網,近日,武漢新芯發布《高帶寬存儲芯粒先進封裝技術研發和產線建設》招標項目,利用三維集成多晶圓堆疊技術,打造更高容量、更大帶寬、更小功耗和更高生產效率的國產高帶寬存儲器產品,推進多晶圓堆疊工藝產業化,新增生產設備約 17 臺/套,擬實現月產出能力≥3000 片(12 英寸)。
面對海外大廠對于 HBM3E 的量產,國內存儲廠商也在 HBM 技術上進行著加速突破,有望在 AI 大浪潮的需求下提升競爭實力。
例如中國臺灣的華邦電于去年 8 月介紹了其類 HBM 高帶寬產品 CUBEx,采用 1~4 層 TSV DRAM 堆疊,I/O 速度 500M~2Gbps,總帶寬最高可達 1024GB/s,顆粒容量為 0.5~4GB,功耗低至不足 1pJ/bit。這種比常規 HBM 擁有更高帶寬的 CUBEx 可用于 AR、VR、可穿戴等領域。
中國大陸方面,目前國際一線廠商 DRAM 制程在 1alpha、1beta 水平,國產 DRAM 制程在 25~17nm 水平,中國臺灣 DRAM 制程在 25~19nm 水平。國內 DRAM 制程接近海外,且國內擁有先進封裝技術資源和 GPU 客戶資源,有強烈的國產化訴求,未來國產 DRAM 廠商有望突破 HBM。
目前中國大陸只有長電科技、通富微電和盛合晶微等一線封裝廠商擁有支持 HBM 生產的技術(如 TSV 硅通孔)和設備。長電科技在投資者互動中表示,其 XDFOI 高密度扇出封裝解決方案也同樣適用于 HBM 的 Chip to Wafer 和 Chip to Chip TSV 堆疊應用;通富微電此前表示,南通通富工廠先進封裝生產線建成后,公司將成為國內最先進的 2.5D/3D 先進封裝研發及量產基地,實現國內在 HBM 高性能封裝技術領域的突破,對于國家在集成電路封測領域突破「卡脖子」技術具有重要意義。
在其余供應鏈上,芯片設計企業國芯科技則表示已與合作伙伴一起正在基于先進工藝開展流片驗證相關 chiplet 芯片高性能互聯 IP 技術工作,和上下游合作廠家積極開展包括 HBM 技術在內的高端芯片封裝合作。
紫光國微表示,公司 HBM 產品為公司特種集成電路產品,目前還在研發階段。
香農芯創此前表示,公司作為 SK 海力士分銷商之一具有 HBM 代理資質。公司未來根據下游客戶需求,在原廠供應有保障的前提下形成相應銷售。
飛凱材料表示,環氧塑封料是 HBM 存儲芯片制造技術所需要的材料之一,MUF 材料按性狀和工藝分不同品種,目前公司 MUF 材料產品包括液體封裝材料 LMC 及 GMC 顆粒封裝料,液體封裝材料 LMC 已經量產并形成少量銷售,顆粒填充封裝料 GMC 尚處于研發送樣階段。
興森科技表示,公司的 FCBGA 封裝基板可用于 HBM 存儲的封裝,但目前尚未進入海外 HBM 龍頭產業鏈。
HBM3 和 HBM3E,作為 HBM 芯片的最新迭代版本,正逐漸成為市場的寵兒。它們與核心微處理器芯片的緊密結合,為生成式人工智能處理海量數據提供了強有力的支持。未來,隨著 HBM3 和 HBM3E 技術的不斷完善和成熟,我們有理由相信,它們將在更多領域大放異彩,成為推動人工智能發展的重要力量。無論是國內還是國際的廠商,都將在這一領域中迎來新的發展機遇和挑戰。



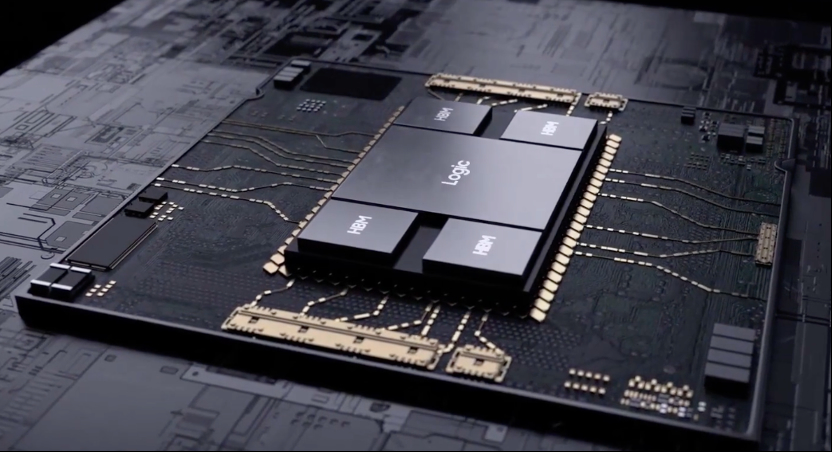
評論