光刻機發展要另辟蹊徑?
最近,光刻機話題異常火熱,似乎全世界都在關注中國本土相關產業的發展。
本文引用地址:http://www.j9360.com/article/202309/450928.htm要想制造出一臺可商用的高端光刻機(可制造 7nm 及更先進制程芯片),是一項復雜的工程,因為高端光刻機所需要的精密零部件太多了,每一種的技術含量都非常高,而且,要想把這些零部件組合成一臺可用的機器,需要長期的技術和實踐積累。
光刻這個概念,有廣義和狹義之分。在狹義層面,就是用光去「復印」集成電路圖案,這也是我們常說的光學光刻技術,特別是紫外線光刻技術(DUV 和 EUV)。在廣義層面,光刻泛指各種集成電路「復印」和「印刷」技術,這些技術中,有的用光,有的不用光(如電子束和納米壓印光刻)。
按應用劃分,半導體光刻技術主要用在三個領域:前道工序的集成電路制造,后道工序的芯片封裝,以及顯示面板的制造。其中,技術含量最高、受關注度最高的就是前道工序光刻工藝,我們常說的 DUV 和 EUV,就是這一部分應用。本文主要討論這一領域的光刻技術。
光刻技術總覽
首先,我們先從廣義層面了解一下各種光刻技術。
在半導體行業,光刻技術的發展經歷了多個階段,接觸/接近式光刻、光學投影光刻、分步(重復)投影光刻出現時間較早。目前,集成電路制造主要采用光學光刻技術,包括掃描式光刻、浸沒式掃描光刻、極紫外光刻工藝。此外,還有 X 射線、電子束光刻、聚焦粒子束光刻、納米壓印、激光直寫技術。
光學光刻,是通過照射,用投影方法將掩模上的大規模集成電路結構圖形「畫」在涂有光刻膠的硅片上,通過光的照射,光刻膠的成分發生化學反應,從而生成電路圖,光學光刻需要掩模。集成電路的最小特征尺寸與光刻系統的分辨率直接相關,而減小照射光源的波長是提高分辨率的有效途徑。因此,開發新型短波長光源光刻機一直是業界的研究熱點。
電子束光刻,該技術不需要掩模,直接將會聚的電子束斑打在表面涂有光刻膠的襯底上。電子束光刻存在的一些問題阻礙了該技術的普及,例如:電子束高精度掃描成像曝光效率低;電子在抗蝕劑和基片中的散射和背散射現象造成的鄰近效應;在實現納米尺度的加工中,電子抗蝕劑和電子束曝光及顯影、刻蝕等工藝技術問題。

聚焦離子束(Focused Ion beam, FIB)光刻,是利用電透鏡將離子束聚焦成小尺寸的顯微切割儀器,它的工作原理與電子束光刻相近。目前,商用的離子束為液態金屬離子源,金屬材質為鎵。典型的離子束顯微鏡包括液相金屬離子源、電透鏡、掃描電極、二次粒子偵測器、5-6 軸向移動的試片基座、真空系統、抗振動和磁場的裝置、電子控制面板,以及計算機等設備。外加電場于液相金屬離子源,可使液態鎵形成細小尖端,再加上負電場,牽引尖端的鎵,導出鎵離子束,通過電透鏡聚焦,經過一連串變化孔徑 (Automatic Variable Aperture, AVA) 可調整離子束的大小,再經過二次聚焦至試片表面,利用物理碰撞來達到切割的目的。
納米壓印光刻,采用電子束等技術將電路圖案刻制在掩模版上,然后通過掩模使對象上的聚合物變形,再采用某種方式使聚合物固化,進而完成圖案的轉移。納米壓印分辨率高,成本低,但存在刻套誤差大、缺陷率高、掩模版易被污染的缺點。
主流光學光刻工藝
如前文所述,狹義層面的光刻,也就是目前的主流光刻技術,其基本原理是:利用光通過具有圖形的光罩(掩模版)對涂有光刻膠的晶圓曝光,光刻膠見光后會發生性質變化,使光罩上的電路圖復印到晶圓上,形成電子線路圖。
光刻系統非常復雜,整個設備由光源、投影物鏡、工件臺、掩模臺、對準與測量、掩模傳輸、晶圓傳輸等部分組成。此外,還需要環境與電氣系統、光刻計算(OPC)與掩模優化(SMO)軟件、顯影、涂膠設備提供支持。
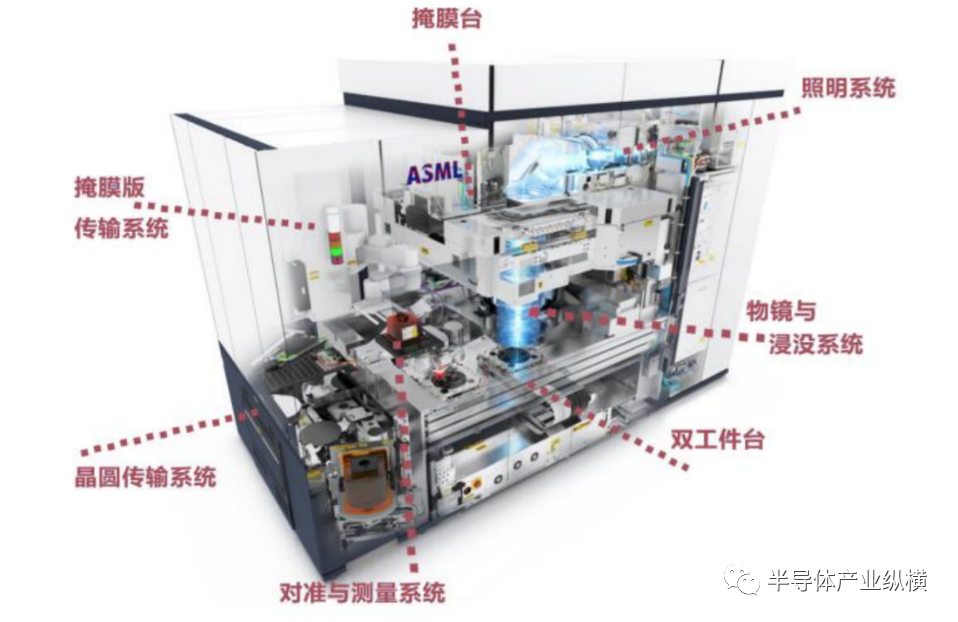
隨著制程工藝的演進,光刻機各個系統也在不斷優化升級,雙工件臺技術與浸液技術相繼被采用。
目前,在前道工序集成電路制造方面,主要采用的都是紫外線光刻工藝,包括深紫外 DUV 和極紫外 EUV。而在早些年,半導體制程工藝還沒演進到 180nm 節點,那時的光刻精度沒現在這么高,也不需要用到 DUV 和 EUV,采用的是接觸/接近式光刻機(Aligner),掃描投影/重復步進光刻機(Stepper)。
當制程工藝發展到 0.25 微米后,步進掃描式光刻機(Scanner)的掃描曝光視場尺寸與曝光均勻性更具優勢,逐步成為主流光刻設備(DUV 和 EUV)。其利用 26mm x 8mm 的狹縫,采用動態掃描的方式(掩模版與晶圓片同步運動),可以實現 26mm x 33mm 的曝光場。當前曝光場掃描完畢后,轉移至下一曝光場,直至整個晶圓曝光完畢。
為了滿足不斷提升的性能指標要求,光刻機的各個組成系統不斷突破光學、精密機械、材料等領域的技術瓶頸,實現了多項高精尖技術的融合。最近這幾年,在 EUV 光刻系統中,光源的重要性似乎更加凸出,也受到了更多關注。
通過配置不同類型的光源(i 線、KrF、ArF,EUV),步進掃描光刻機可以支持所有集成電路制程節點,但為滿足最先進制程的要求,每一代步進掃描光刻機都歷經了重大技術升級,例如:步進掃描式光刻機 26mm x 8mm 的靜態曝光場相對較小,降低了物鏡系統制造的難度;但其工件臺與掩模臺反向運動的動態掃描方式,提升了對運動系統的性能要求。
從 DUV 到 EUV
自 1990 年 SVGL 公司推出 Micrascan I 步進掃描光刻機以來,光刻機產業就進入了 DUV 時代,一直到 7nm 芯片量產,DUV 都是市場的統治者。在這一過程中,DUV 技術也在不斷演進,以滿足制程工藝的發展要求。例如,越先進的制程,其線寬越小,這就需要光刻機具有更高的曝光分辨率,為了提升分辨率,要不斷提高光刻機物鏡的數值孔徑(NA),并采用波長更短的光源,另外,浸沒式光刻系統也是一大發明,它通過在物鏡鏡頭和晶圓之間增加去離子水來增大折射率,達到了提升分辨率的效果。
當制程工藝發展到 22nm 時,必須引入新的方法才能進一步提升光刻的分辨率,多重曝光技術誕生。多重曝光技術有多種類型,包括:雙重曝光(DE),曝光-固化-曝光-刻蝕(LFLE),雙重曝光(LELE),三重曝光(LELELE),自對準多重曝光(SAMP)。
多重曝光是把原來一層光刻圖形拆分到兩個或多個掩模版上,以實現圖像密度的疊加,這樣就實現了比光刻機極限分辨率更小的圖形。例如,用 DUV 加上四重曝光技術(SAQP)進行多次曝光處理,可使制程工藝水平由雙重曝光(SADP)的 40nm 提升到 20nm。
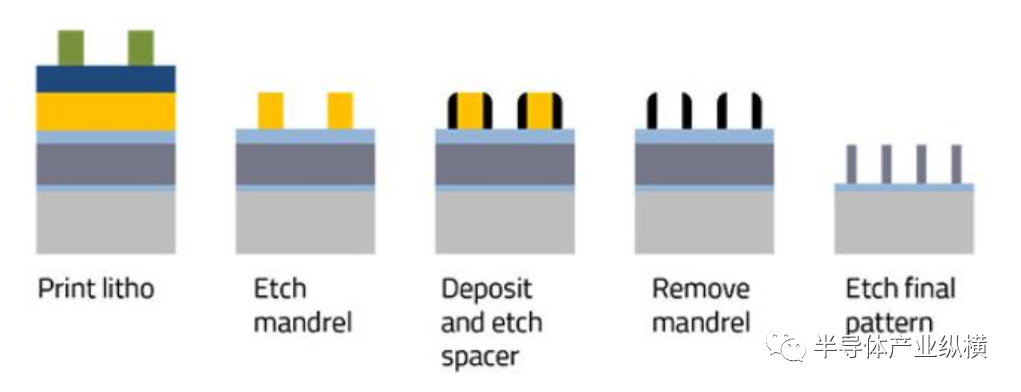
當制程節點演進到 5nm 時,DUV 和多重曝光技術的組合也難以滿足量產需求了,EUV 光刻機就成為前道工序的必需品了,沒有它,很難制造出符合應用需求的 5nm 芯片,即使不用 EUV 能制造出一些 5nm 芯片,其整個生產線的良率也非常低,無法形成大規模的商業化生產。
隨著制程節點不斷演進,3nm、2nm 芯片已經或即將問世,行業對 EUV 光刻機的要求越來越高,對其發展前景和發展路徑也提出了更多期待。
雖然 EUV 光刻系統每一個主要組成部分都需要高精尖技術,但光源的重要性更加凸出,特別是近些年,中國在發展 EUV 光刻機方面不斷積蓄力量,光源是重中之重。
光源波長越短,光刻機分辨率越高,制程工藝越先進。與 DUV 使用的準分子激光光源不同,EUV 光刻機采用 13.5nm 波長的離子體光源,這種光源是通過二氧化碳激光器轟擊霧化的錫(Sn)金屬液滴,將它們蒸發成等離子體(激光等離子體,LPP),通過高價錫離子能級間的躍遷獲得的。
EUV 的未來發展路徑
目前,3nm 制程芯片已經實現量產,未來 3 年內,2nm 量產幾無懸念,而在可預見的未來幾年內,1nm,甚至更先進制程芯片也將陸續量產。在這樣的行業背景下,EUV 光刻機的重要性愈加凸出。
目前來看,EUV 光刻機必須不斷演進,才能跟上制程工藝發展的步伐,而要提升光刻精度,除了提升物鏡的數值孔徑 NA,人們將主要精力放在了提升光源分辨率上,增加光源功率是一條重要發展路徑。
目前,最先進的 EUV 光刻機都是由 ASML 生產的,已商用的 EUV 的 NA 最高達到了 0.33,而 NA 值為 0.55 的 EUV 產品也將在 2024 年問世,并有望在 2025 年實現商用。
光源方面,要提升功率,有幾條發展路徑可供選擇。
一、傳統的 LPP 光源系統,可以在已有基礎上,不斷增加功率。
LPP 光源的好處是轉換率高,大廠都希望功率能達到 200W 以上的工業應用標準,這就需要龐大的二氧化碳激光裝置。在實際應用中,高水平的 EUV LPP 光源的激光器需要達到 20kW 的功率,而這樣的發射功率經過重重反射,達到焦點處的功率只有 350W 左右。
更小的功率并不是說不能正常運行,只是對于一臺售價上億美元的光刻機來說,這樣的功率還不足以最大化利用率,尤其是到了 3nm 和 2nm 制程節點后,為了最大化掃描速度,3nm 節點需要 1500W 的焦點功率,2nm 節點需要 2800W 的焦點功率。而這樣的功率是現有 LPP EUV 達不到的。目前,在這方面較為領先,也在加緊研究的是 ASML 公司。
二、可以采用分時高功率光纖激光器射擊液態錫靶技術,用這種方法制造的光源,其光源功率有望超過傳統 LPP 數倍。
三、使用能量回收型直線加速器(ERL)的 FEL(自由電子激光)方案,這種光源的極限功率也很高,最高可達 10kW。根據日本高能加速器研究機構給出的數據,FEL 可以做到近 LPP 方案七分之一的耗電成本。不過,這種光源存在不少需要突破的技術難點,而且造價高昂。
四、基于穩態微聚束(Steady-state microbunching,SSMB)技術的粒子加速器光源。SSMB 概念由斯坦福大學教授、清華大學訪問教授趙午與其博士生 Daniel Ratner 于 2010 年提出。
基于 SSMB 原理,能獲得高功率、高重頻、窄帶寬的相干輻射,波長可覆蓋從太赫茲到極紫外波段。下圖所示為 SSMB 原理驗證實驗示意圖。

基于 SSMB 的 EUV 光源有望實現大的平均功率,并具備向更短波長擴展的潛力,為大功率 EUV 光源的突破提供了新思路。
目前,清華大學正積極支持和推動 SSMB EUV 光源在國家層面的立項工作,清華 SSMB 研究組已向國家發改委提交「穩態微聚束極紫外光源研究裝置」的項目建議書,申報「十四五」國家重大科技基礎設施。
結語
光刻機從誕生到現在,經歷了多次迭代,發展出了多種應用技術,為了應對不斷發展的應用需求,新的技術高峰和難題也在等待業界去攀登和攻克。
對于中國半導體產業而言,面對外部壓力,需要在保持國際供應鏈通道的同時,不斷強化自研能力,光刻機,特別是 EUV 光刻機是重要一環。目前,中國本土企業在封裝和顯示面板用光刻機方面已經能夠實現自主,但在先進制程芯片制造方面,還有很長的路要走。
在提升 EUV 光源功率水平方面,已出現多條發展路徑,無論是走傳統技術路線,還是另辟蹊徑,尋找更好的追趕國際先進光刻技術水平的解決方案,都需要踏踏實實地進行技術研發和工程驗證工作,絕對不是短期內就能達到目標的,需要長期堅持,不懈努力。



評論