片內相位測量工具模擬光刻機
采用特殊照明方式的高/超高數值孔徑(NA)的193nm光刻機和相位移掩膜版(PSM),使得光刻分辨率的極限達到了32nm節點。不利的因素是掩膜的復雜度正在以指數級遞增,而業界又迫切需要通過精確的相位控制以達到必需的高成品率。
光刻機成像平面的相位受到其本身的數值孔徑、掩膜的斜率和3D掩膜效應極大的影響,特別是當特征尺寸接近分辨率極限的時候。在45nm和32nm節點,為了確保精確的刻寫PSM并獲得足夠的成品率,有必要測量產品特征中與光刻機相關的相位。然而控制需要精準的測量,直到現在相位的測量依然使用基于干涉儀的測量工具。如此產生的問題是,評估相位必須使用比產品特征高數量級的參考特征,這些測量平臺將受到局限。高分辨率原子力顯微鏡(AFM)也被迫面臨這樣的問題。雖然它們能夠測量產品相關特征中的刻蝕深度,但是卻無法描述3D掩膜效應。兩種方法都無法獲得由數值孔徑(NA)、掩膜斜率和嚴格的3D掩膜效應產生的衍射限度。
與Intel一起協作,Carl Zeiss半導體測量系統部門研究了光學相位測量工具的必要條件,它們要能夠把工藝控制從大型CD測試特征擴展到芯片內高分辨率相位移特征。因此,這些工具注定了必須為模擬光刻平臺的光學設置而設計,并需要獲得光波波長中特征尺寸產生的相位信息。
這樣的結果產生了一個叫做Phame的光學測量工具。考慮到偏振,在光刻機相關的設置下,它可以測量所有片內的相位移掩膜版的相位。它不但能完成現存工具所作的測量大型參考特征的工作,而且能夠通過獲得真實的掩膜效應來測量產品特征。該平臺的光束路徑可與NA為1.6的浸沒式光刻機的類比。結合一個低sigma元件,它的193nm激光持續照射一個面朝下的掩膜;根據PSM的類型決定使用同軸還是離軸的入射光。
光刻機的部分相干光照設置用于可調時間間隔的連續測量,它允許在光刻機相關的照射設定下進行相位控制。工具的0.4NA精確圖像光(1.6NA光刻機等效)使得系統與193nm浸沒式光刻機兼容并延伸至32nm節點。相位信息是通過相位操作和運算獲得的,CCD占用原來在一個真正的光刻機中應該屬于晶圓的位置。除了芯片中相位值,該工具也測量芯片內的傳輸。
系統提供三種不同的測量模式:手動,柱狀圖分析和定義區域。在測量的過程中獲得強度和相位影像,通過選擇一個伴有顯示相應相位數值的相位圖薄片,相位的輪廓可以手動生成。然后,柱狀圖分析法計算出整個測試區域的相位平均值。這一選項被用于PSM刻蝕和清洗后的相位控制。另外,其他區域可能在相位圖像內被定義或被軟件自動設置,并可對平均相位的差異進行評估。被定義區域間的相互關系可以用作修復驗證或是評估光學臨近效應。
該平臺可以測試所有類型的PSM。實驗證明,其相位精確度1°,小產品特征的靜態相位再現能力在0.15°和0.3°之間,對大的參考特征該值0.2°。
雖然使用測量系統進行工藝控制、優化工藝窗口以提升成品率,這些主要用于掩膜廠;但在改進掩膜和縮短設計優化時間方面,仍需要在研發領域擴大應用以優化光學鄰近修正(OPC)工藝。
干涉儀相關文章:干涉儀原理






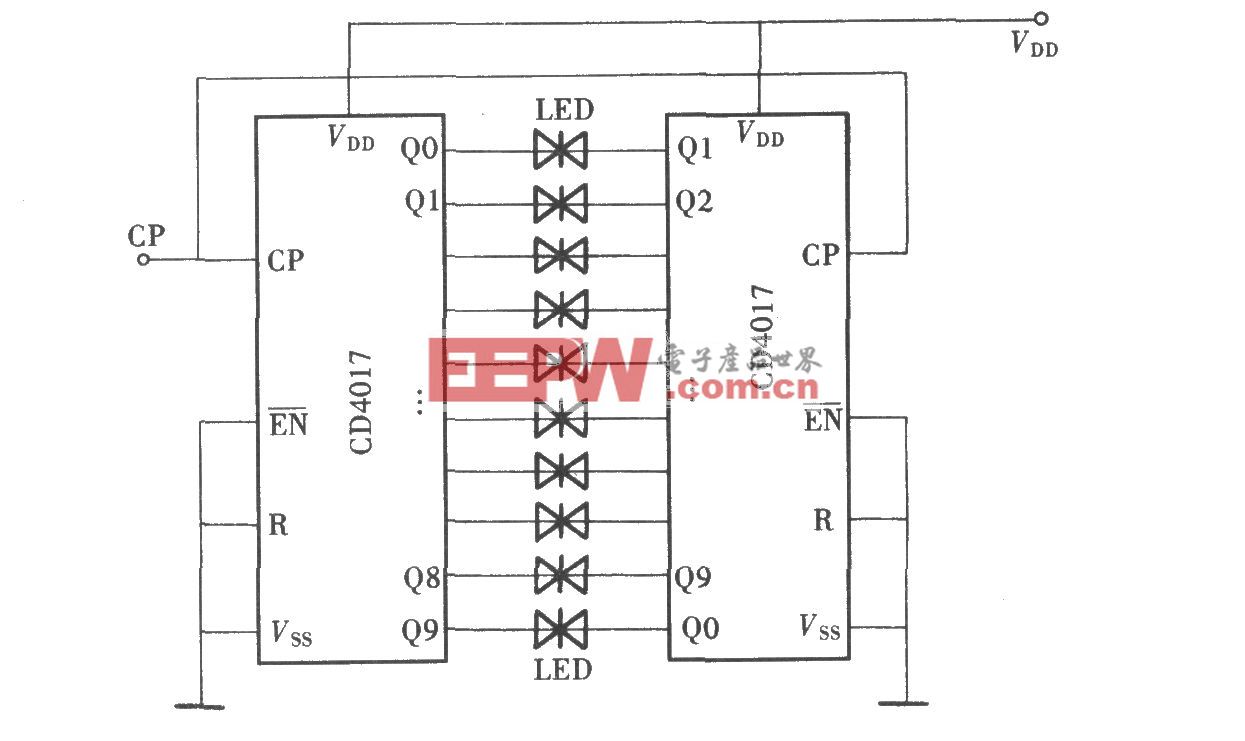

評論