KLA-TENCOR推出面向光刻設計檢測方案
——
DesignScan 可對 post-RET 掩膜版設計進行在線檢測,以發現光刻制程工藝窗口中的錯誤。通過與 LithoView 配合使用,具有的新功能可加強代工廠和無工廠芯片生產商之間的協作,DesignScan 能識別影響性能和成品率的圖形,并將這些信息向上反饋到無工廠的設計機構。LithoView 允許無工廠設計機構能查看由 DesignScan 檢測到的結果。DesignScan 可為晶片光刻制程工藝優化設計,為光刻制程工藝優化 post-RET 掩膜版版面,以及為設計優化光刻制程工藝,進而提高光刻制程工藝窗口的設計性能。
“由于掩膜版版面總是不斷偏離設計目標,因此為生產而設計 (DFM) 顯得非常重要,”KLA-Tencor 掩膜版和光掩膜檢測事業部 (RAPID) 總經理 Harold Lehon 指出。“作為一家致力于成品率管理的公司,KLA-Tencor 始終專注于使半導體生產公司能更好地進行決策,并在半導體價值鏈的所有層次上提高成品率。通過 DesignScan 等方案,我們可以將我們的成品率知識和專業技術向上延伸到 post-RET 設計階段。”
今天的光刻工藝要求對掩膜版版面采用極其復雜的 RET,例如 OPC 功能,以便獲得成功的圖形。在設計中加入 OPC 之后,必須通過檢測以確保沒有任何可能導致圖形缺陷的設計錯誤,并確保能在掩膜版生產之前為給定工藝設計提供合理的光刻制程工藝窗口。盡早地檢測到這些錯誤是非常關鍵的,因為在掩膜版生產之前發現的設計錯誤可能只需幾天或一周就能加以糾正,但是如果等到在代工廠才檢測到錯誤,則會導致數個月的時間延誤。DesignScan 為檢測和優化工藝窗口提供了最快的周轉時間。
“由于新一代芯片的設計復雜性不斷增加,系統性的成品率損失正在逐漸升高,”KLA-Tencor 負責光刻的副總裁 Chris Mack 認為,他也是 DesignScan 計劃的最初負責經理。“成品率提高的最大可能存在于光刻部分,這是因為由于聚焦和曝光偏差,設計版面和 RET/OPC 已經無法繼續優化。對芯片生產商而言,僅僅弄清最佳聚焦和曝光情況下的設計成品率是不夠的。要獲得最嚴格的參數化成品率分布,需要在整個光刻工藝窗口中進行設計檢測。”
KLA-Tencor 現已開始接受 DesignScan 的訂單。



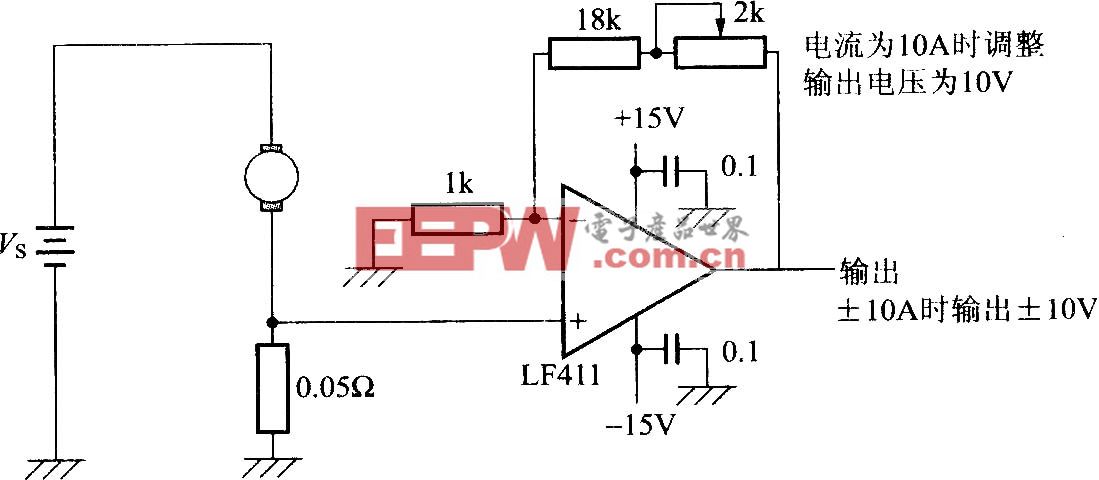










評論