光芯片,不只是引人注目
光通信行業市場研究機構 LightCounting 在最新報告中指出,光通信芯片組市場預計將在 2025 至 2030 年間以 17% 的年復合增長率(CAGR)增長,總銷售額將從 2024 年的約 35 億美元增至 2030 年的超 110 億美元。
本文引用地址:http://www.j9360.com/article/202504/468918.htm當前,光芯片正引起越來越多科研機構和大廠的興趣。
市場和研究的重點
推動市場增長的無疑是以太網和 DWDM 兩大巨頭,占據了絕對主導地位。而 PAM4 DSP 芯片則悄悄崛起,成為第三大細分市場。這種芯片主要用作交換機 ASIC 與可插拔端口之間的板載重定時器,聽起來可能有點復雜,但簡單來說,它就是讓數據傳輸更快、更穩的關鍵角色。根據 LightCounting 的數據,超大規模云服務商對 AI 基礎設施的投資正在推動 400G/800G 以太網光模塊的需求激增,進而拉動了 PAM4 芯片組的銷量。
超大規模云服務商對 AI 基礎設施的巨額投資推動 400G/800G 以太網光模塊出貨量激增。
中國云廠商開始跟進投資 AI 基礎設施。
無線前傳作為 PAM4 光器件新興市場,預計將在 2025 年復蘇,并在 2026 年繼續增長。

自 2024 年年以來,英偉達、英特爾等巨頭企業紛紛在光子技術上加碼,英偉達計劃在 2027 年推出 Rubin Ultra GPU 計算引擎,整合共封裝光學(CPO)技術,解決數據傳輸帶寬瓶頸,并計劃在 2025 年與臺積電、博通合作推動相關硅光子產品量產;英特爾則在光纖通信大會(OFC)大會上展示了其光學計算互連(OCI)芯片,實現與 CPU 共封裝,為滿足未來 AI 計算的高帶寬需求提供了解決方案;一個月后光子加速計算初創公司 Lightmatter 在 D 輪融資中融到了 4 億美元,估值達到 44 億美元,這筆資金將用于加速該公司光芯片的生產和部署,以滿足 AI 集群對低能耗、高性能計算的需求。
除此之外,國內外頂尖科研機構在光芯片領域有著先進的科研成果。
上海交通大學鄒衛文教授團隊研制了實現高速張量卷積運算的新型光子張量處理芯片。該研究創新提出基于光子集成手段構建張量運算過程的學科交叉研究思路,該思路無需進行張量到矩陣的轉換,可實現輸入張量到輸出張量的流式計算。基于這一創新思路,該團隊設計并研制一款光子張量處理芯片,在多通道圖像上驗證了時鐘頻率為 20 GHz 的高速張量卷積運算,芯片算力密度為 588 GOPS/mm2,后續通過提升光子器件集成規模有望達到 1 TOPS/mm2 以上。研究團隊利用該芯片構建了用于視頻動作識別的卷積神經網絡,網絡中的卷積層在光子張量處理芯片上完成,最終在 KTH 視頻數據集上實現了 97.9% 的識別準確率,接近理想識別準確率 98.9%。
上海交大電院消息指出,本研究成果表明光子集成芯片可在超高時鐘頻率下實現張量流式處理,解決額外內存占用與訪存問題,為構建高性能計算、寬帶信號處理等先進信息系統提供了新技術途徑。
清華大學的研究團隊開發了名為「太極」的光子芯片,其能量效率高于當前的智能芯片數個數量級。短短 4 個月,清華大學的光芯片就已經迅速進化到第二代,世界上第一款全光學 AI 芯片太極-Ⅱ了,能效已經超過英偉達著名的 H100。這不僅僅是技術上的突破,更可能是一種新的計算范式的開始,甚至可能徹底改變計算機的設計和構建方式,這項研究已發表在 8 月 7 日的《自然》雜志上。《自然》審稿人認為,它有望成為訓練光學神經網絡和其他光學計算系統廣泛采用的工具。
太極-Ⅱ全光學 AI 芯片是在新開發的全前向模式(FFM)上構建的,允許在光學系統中直接進行計算密集型 AI 訓練,而不需要復雜的反向傳播過程,是世界上第一個能夠進行「大規模光訓練」的芯片,可以更快、更省電地訓練人工智能模型。
香港城市大學副教授王騁團隊與香港中文大學研究人員合作開發出處理速度更快、能耗更低的微波光子芯片。可運用光學進行超快模擬電子信號處理及運算。據介紹,這種芯片比傳統電子處理器的速度快 1000 倍,耗能更低,應用范圍廣泛,涵蓋 5/6G 無線通訊系統、高解析度雷達系統、人工智能、計算機視覺以及圖像和視頻處理。
另外,IBM 光子芯片取得新突破,實現下一代高速光互聯技術,可以顯著改善數據中心訓練和運行生成式 AI 模型的方式,AI 速度提升 80 倍。與目前最先進的 CPO 技術相比,IBM 的創新使芯片制造商能夠在硅光子學芯片的邊緣添加六倍的光纖,即「海濱密度」。這些光纖的直徑大約是人類頭發的三倍,長度從幾厘米到幾百米不等,每秒能傳輸太比特的數據。IBM 團隊使用標準的組裝封裝工藝,在 50 微米間距的光學通道上組裝了一個高密度 PWG,與硅光子波導絕熱耦合。論文還指出,這些具有 50 微米間距 PWG 的 CPO 模塊已通過了制造所需的所有壓力測試,包括高濕環境、-40°C 至 125°C 的溫度以及機械耐久性測試,確保了光互連在彎曲時不會損壞或丟失數據。此外,研究人員已將 PWG 技術演示到 18 微米的間距,堆疊四個 PWG 可實現多達 128 個通道的連接。
這一突破延續了 IBM 在半導體創新領域的領先地位,包括首個 2nm 節點芯片技術、7nm 和 5nm 工藝技術的實現、納米片晶體管、垂直晶體管(VTFET)、單細胞 DRAM 和化學放大光刻劑等。CPO 技術為滿足 AI 日益增長的性能需求提供了新的解決方案,并有望取代模塊外的電氣通信方式。
光通信的發展趨勢:1.6T、硅光、LPO、CPO
光通信領域正加速向高速率、集成化、低功耗方向突破,1.6T、硅光、LPO 和 CPO 四大技術趨勢相互交織,共同驅動行業變革。
1.6T 高速光模塊?成為下一代數據中心的核心需求,通過 3nm 制程 DSP 芯片與硅光技術融合,實現單波 1.6Tbps 傳輸速率,功耗較前代降低 40%,支撐 AI 算力集群的長距離高密度互聯,但其信號完整性設計和散熱問題仍需攻克。?硅光技術?作為底層創新,借助硅基材料和 CMOS 工藝,將激光器、調制器等器件集成于單一芯片,顯著降低成本和功耗,成為 CPO 等先進封裝的關鍵支柱,但硅基激光器效率不足和封裝兼容性問題仍制約其大規模應用。
LPO(線性驅動可插拔模塊)?以「去 DSP 化」為核心,通過線性直驅技術降低 50% 功耗和 30% 延遲,保留可插拔特性,在中短距離場景(如數據中心架頂交換機互聯)實現性能與成本的平衡,但受限于傳輸距離和專用芯片配套能力。
CPO(光電共封裝)?則更激進,通過光引擎與交換芯片共封裝,將能效壓至≤5pJ/bit(降耗 70%),支持未來 3.2T/6.4T 超高速率,結合液冷散熱可提升單機架算力密度 40%,但高集成帶來的散熱難題和外置光源依賴成為商業化瓶頸。
從協同效應看,硅光與 CPO 深度綁定推動高密度集成,LPO 作為過渡方案填補中短距市場,1.6T 則牽引長距帶寬升級,形成多層次技術覆蓋。產業層面,頭部企業通過「硅光+CPO」組合搶占 AI 算力高地,而 LPO 廠商聚焦低成本場景,推動數據中心 PUE 從 1.25 優化至 1.12,加速綠色算力落地。這些趨勢共同指向一個核心目標:在 AI 與算力爆發時代,以更低能耗承載指數級增長的數據洪流。
磷化銦:光芯片的香餑餑?
最后我們來談談光芯片的風險。根據 Yole 統計顯示,到 2026 年全球光模塊器件磷化銦襯底(折合兩英寸)預計銷量將超過 100 萬片,2019 年-2026 年復合增長率達 13.94%,2026 年全球光模塊器件磷化銦襯底預計市場規模將達到 1.57 億美元。
而磷化銦(InP)光芯片制造工藝的核心難點集中在材料特性、制程精度與熱管理三方面。
磷化銦多晶合成需精確控制銦磷原子比(1:1±0.0001)及溫度(±0.5℃內),以規避非化學計量缺陷;單晶生長過程易受熱場擾動影響,導致位錯密度超過 1000/cm2,直接影響器件光電轉換效率?。
另外,納米級外延與光柵制造?。量子阱外延層厚度需控制在±1nm 以內,V/III 族氣體流量比波動須<0.1% 以保證界面陡峭度;分布式反饋(DFB)激光器的二階光柵刻蝕深度公差需≤5nm,否則導致波長偏移超過±0.5nm,難以滿足密集波分復用(DWDM)需求。
以及,高精度封裝與良率提升?。光纖耦合對準精度要求<0.15μm,但焊接應力易使 VCSEL 陣列光斑偏移超 0.2μm,導致 400G 光模塊封裝良率不足 75%;而 EML 激光器的端面反射率需穩定在 30%-40%,鍍膜厚度誤差超過±1nm 將引發模式跳變?。
總的來說,磷化銦的制備工藝相對復雜,成本較高,限制了其大規模應用。為了降低成本并提高生產效率,研究人員正在不斷優化制備工藝,并探索新的制備方法。





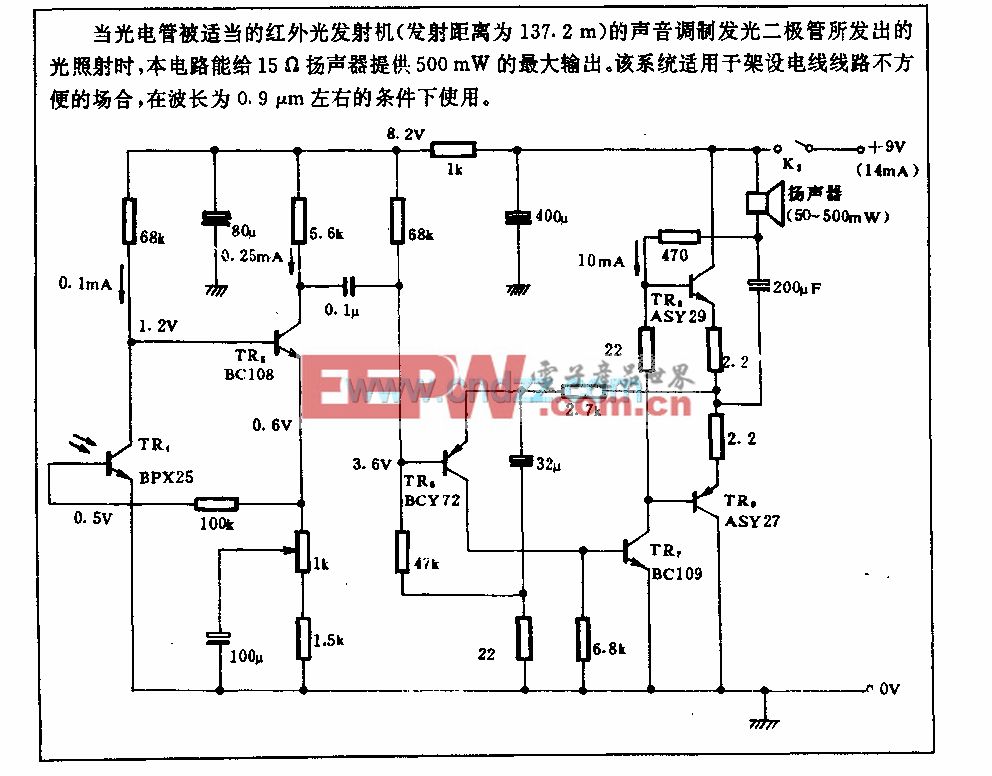


評論