三星電子展示3D晶圓封裝技術 可用于5納米和7納米制程
據臺灣媒體報道,三星電子成功研發3D晶圓封裝技術“X-Cube”,稱這種垂直堆疊的封裝方法,可用于7納米制程,能提高該公司晶圓代工能力。
本文引用地址:http://www.j9360.com/article/202008/417171.htm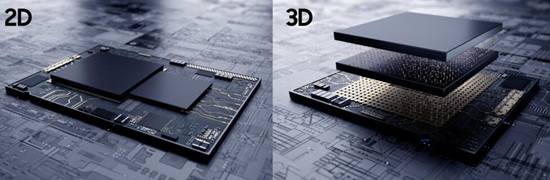
圖片來自三星電子官方
三星的3D IC封裝技術X-Cube,采用硅穿孔科技(through-silicon Via、簡稱TSV),能讓速度和能源效益大幅提升,以協助解決次世代應用嚴苛的表現需求,如5G、人工智能(AI)、高效能運算、行動和穿戴設備等。
三星晶圓代工市場策略的資深副總裁Moonsoo Kang表示,三星的新3D整合技術,確保TSV在先進的極紫外光(EUV)制程節點時,也能穩定聯通。
三星稱,X-Cube可用于5納米和7納米制程。有了X-Cube技術,IC設計師打造符合自身需求的定制化解決方案時,將有更多靈活性。














評論