臺積電3D芯片2021年量產:面向5nm工藝 蘋果或首發
上周臺積電發布了2018年報,全年營收342億美元,占到了全球晶圓代工市場份額的56%,可謂一家獨大。在先進工藝上,臺積電去年量產7nm工藝,進度領先友商一年以上,今年量產7nm EUV工藝,明年還有5nm EUV工藝,3nm工藝工廠也在建設中了。
本文引用地址:http://www.j9360.com/article/201904/399738.htm作為全球最大的晶圓代工公司,臺積電在半導體制造上的技術沒啥可說的了,但很多人不知道的是臺積電近年來加大了半導體封裝技術的研發,過去幾年能夠獨家代工蘋果A系列處理器也是跟他們的封裝技術進步有關。
日前在臺積電說法會上,聯席CEO魏哲家又透露了臺積電已經完成了全球首個3D IC封裝,預計在2021年量產,據悉該技術主要面向未來的5nm工藝,最可能首發3D封裝技術的還是其最大客戶蘋果公司。
在蘋果A系列處理器代工中,三星曾經在A9處理器分到一杯羹,與臺積電分享了蘋果訂單,不過從A10處理器開始都是臺積電獨家代工了,而臺積電能夠贏得蘋果青睞也不只是因為半導體制造工藝,還跟臺積電能夠整合先進封裝工藝有關。
在半導體制造黃金定律摩爾定律逐漸失效的情況下,單純指望制造工藝來提高芯片集成度、降低成本不太容易了,所以先進封裝技術這幾年發展很快。此前臺積電推出了扇出型晶圓級封裝(InFO WLP)以及CoWoS封裝工藝,使得芯片有更好的電氣特性,能實現更高的內存帶寬和低功耗運行能力,能使到移動設備有更好性能和更低功耗。
不過InFO WLP、CoWoS本質上還是2.5D封裝,業界追求的一直是真3D封裝,去年臺積電宣布推出Wafer-on-Wafer(WoW) 封裝技術,通過TSV硅穿孔技術實現了真正的3D封裝,而這個封裝技術主要用于未來的7nm及5nm換工藝。
雖然臺積電在上周的說法會上沒有明確提及他們首發的3D IC工藝是否為Wafer-on-Wafer(WoW)封裝技術,但猜測起來就是這個新技術了,畢竟3D封裝是2019年的熱門新技術,英特爾之前推出的Foreros封裝也是3D芯片封裝的一種。
根據臺積電的說法,他們的3D IC封裝技術已經完成了技術開發,不過2021年才會量產,這個時候他們的主力工藝還是5nm EUV級別的。至于哪家客戶都成為第一個吃螃蟹的,預計蘋果還是最先采用臺積電3D封裝的公司,以往也是蘋果率先使用臺積電2.5D封裝的,他們有這個需求,也有這個資本。
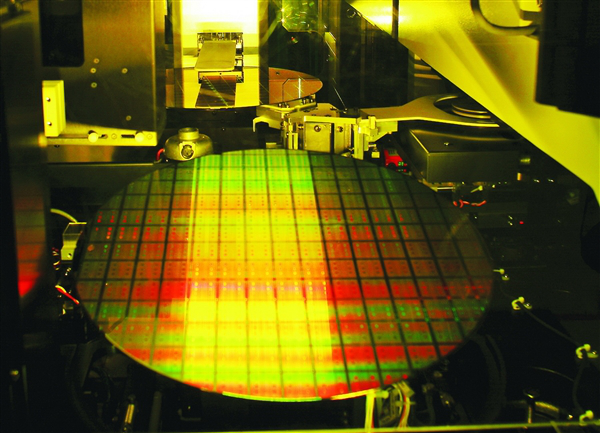












評論