Entegris 發(fā)布針對先進半導體制造的新型化學機械研磨后清洗解決方案
Entegris, Inc. (一家為先進制造環(huán)境提供良率提升材料和相關解決方案的領先企業(yè))日前發(fā)布了針對半導體制造的新型化學機械研磨(CMP)后清洗解決方案。新型 PlanarClean? AG 系列產品設計用于 10 nm 及以下的工藝中,并新增到 Entegris 的領先 CMP 后清洗解決方案產品組合。
本文引用地址:http://www.j9360.com/article/201602/286545.htm“多年來,Entegris 一直是 CMP 后清洗方面的行業(yè)領導者。我們的 PlanarClean 系列產品已廣泛用于全球的晶圓廠。由于許多新材料(如鈷和鎢)的添加,先進節(jié)點處的晶圓生產變得更加復雜,為了解決這個問題,我們仔細重制了PlanarClean 解決方案,既能提供卓越的清洗能力,同時不破壞先進薄膜或新材料”,Entegris CMP 后清洗解決方案總監(jiān) Cuong Tran 表示。“PlanarClean AG 滿足先進工藝的需求,同時還符合我們客戶制定的新安全指南。”
硅晶圓生產中的 CMP 工藝包含機械研磨步驟,該步驟使用化學研磨液配方將多余的導電或絕緣材料從集成設備表面上去除,實現(xiàn)平整、光滑的表面,用于構建多層集成電路。CMP 后清洗步驟去除納米級顆粒,減少潛在的晶圓缺陷,同時保持已經放置到位的材料層的完整性。
- 更多 -
在高級工藝中,接觸清洗過程的薄膜和材料的數(shù)量和類型發(fā)生了變化,凸顯了對特別配方清洗解決方案的需求。此外,研磨液中所使用的微粒也有所改變,使得許多傳統(tǒng) CMP 后清潔劑在領先技術中顯得無效和低效,特別是在前段 (FEOL) 流程中。如今這些挑戰(zhàn)迫使半導體制造商考慮使用配方清洗解決方案代替商品清洗解決方案。
PlanarClean AG 配方解決方案能夠滿足這些需求,在包含銅、鈷和鎢的高級工藝中提供一步式的卓越清洗,同時保護底層的薄膜和材料。其專有配方可以提高可靠性和產量、實現(xiàn)極低甚至零腐蝕和缺陷并增加待機時間,進而帶來更高的性能。此外,PlanarClean AG 可降低清洗步驟中所需的化學品量,提供使用成本優(yōu)勢,并滿足晶圓廠化學品的最新 EHS 安全要求。相關產品已在多家領先晶圓廠成功經過評估,目前可供所有客戶購買。
如想了解更多信息,請聯(lián)系您當?shù)氐?nbsp;Entegris 代表或訪問 www.entegris.com。




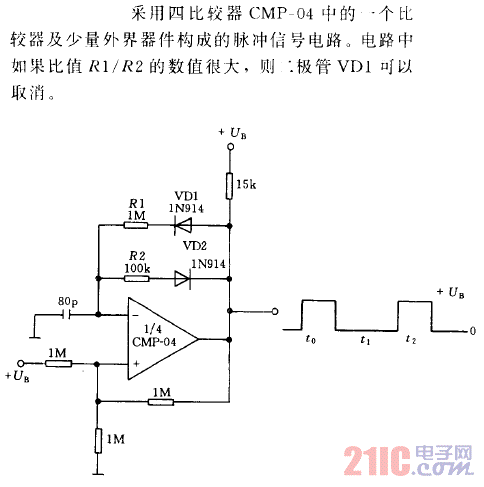

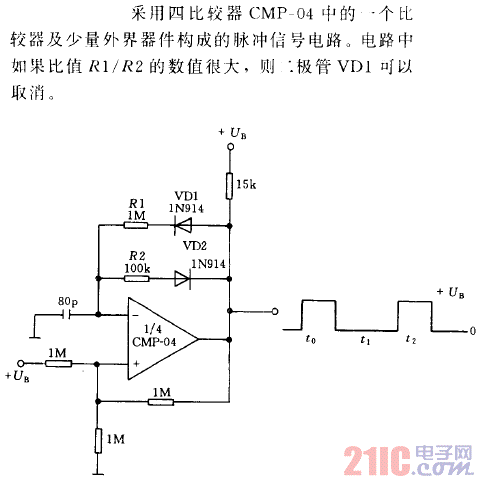
評論