芯片工業的革命:芯粒技術(Chiplet)
通過提供一種全新的芯片設計方法,芯粒技術(又稱小芯片)正在改變計算機芯片行業。這種創新的解決方案是將更小的芯片緊密地封裝在一起,制造出一個單一的電子設備。芯粒技術正被應用于所有主要的計算領域,蘋果、AMD和英特爾等公司都在探索和實現芯粒技術架構,AMD走在了最前面。
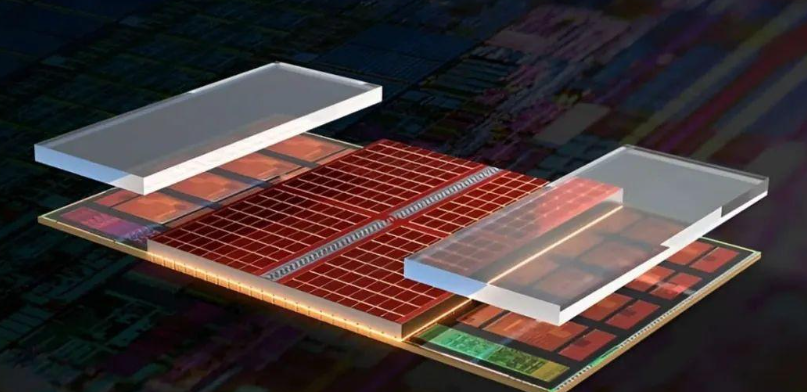
「芯片設計的模塊化方法」
芯粒是一種小型的模塊化芯片,可以組合成一個完整的系統(SoC)。這種技術提高了性能,降低了功耗,并增加了設計靈活性。芯粒概念已經存在了幾十年,但最近在解決傳統單片集成電路縮小的挑戰方面受到了關注。2007年5月,DARPA啟動了面向異構小芯片的COSMOS項目,隨后是面向芯粒模塊化計算機的CHIPS項目。
異構芯片集成市場正在迅速增長,AMD的Epyc和英特爾的Lakefield是值得注意的兩個例子。預計到2025年,小芯片的市場價值將達到57億美元,到2031年將達到472億美元。電子產品對高性能計算、數據分析、模塊化和定制化日益增長的需求正在推動這一增長。
「芯粒技術的優點」
通過使用針對特定任務優化的專門處理元素,芯粒設計提供了更好的性能,而且芯粒設計可以減少開發時間和成本,并且它們的尺寸和功率要求比傳統芯片小,從而允許更低的制造成本和更緊湊的設備設計。
靈活性是芯粒的另一個關鍵優勢,芯粒設計能夠快速適應市場條件和新技術,簡化生產過程。芯粒的混合匹配方法允許更快,更具成本效益的開發,從而提高產量并降低成本。
「蘋果、AMD等公司」
蘋果公司于2022年3月推出的M1 Ultra芯片采用了芯粒架構。M1 Ultra包含1140億個晶體管,提供20核CPU和64核GPU。基于芯粒的架構越來越受歡迎,英特爾、蘋果、ARM、三星和谷歌等行業巨頭組成了一個促進通用芯片互連快線(UCIe)標準的聯盟。

AMD的Zen 2芯片設計是對摩爾定律放緩的短期解決方案,該公司正在探索未來架構的3D芯片堆疊技術。AMD于2019年推出的Ryzen 3000處理器使用了芯片架構,但這種方法仍有其局限性。AMD數據中心集團高級副總裁Forrest Norrod表示,將芯粒設計與3D堆疊、可擴展互連、新內存架構和軟件框架相結合,將是未來發展的必要條件。
「芯粒技術的挑戰和未來」
盡管芯粒技術有許多優點,但其在確保低成本和高可靠性與先進的封裝技術方面面臨挑戰。由于產量問題持續存在,保持良好的質量和經濟的成品率至關重要。然而,隨著對封裝技術的關注,該行業正在轉向更先進的解決方案,例如臺積電開發的InFo和coos。
隨著芯片市場的持續增長和各大公司對該技術的投資,這種模塊化芯片設計方法的未來看起來很有潛力。具有革命性的計算性能、功耗和靈活性的潛力將使芯粒技術成為芯片行業未來不可或缺的一部分。
*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。












