應用材料公司推出亮場硅片檢測工具UVision3系統
——
近日,應用材料公司推出具有業界最高生產力的DUV(深紫外)亮場硅片檢測工具UVision® 3系統,它能滿足45納米前端制程和浸沒式光刻對于關鍵缺陷檢測靈敏度的要求。這個新一代的系統為應用材料公司突破性的UVision技術帶來了重要的進步,它將掃描硅片的激光束數量提升至3倍,使其生產速度比任何競爭對手的系統快40%。兩個新的成像模式將靈敏度擴展至20納米,全新靈活的自動缺陷分類引擎能夠迅速標定出有害缺陷從而達到更快的成品率學習進程。
應用材料公司副總裁,工藝診斷控制事業部總經理Gilad Almogy博士表示:“UVision 3系統的多光束DUV(深紫外)激光結構能夠突破傳統光學檢測的精度限制。領先的存儲器和浸沒式光刻制造商可以使用這個增強的系統以工程靈敏度進行量產,在更短的周期內得到有意義的數據。多套UVision 3系統已經運送給一些領先的客戶,該系統出眾的的靈敏度和突破性的DUV(深紫外)亮場檢測生產速度已經得到了驗證。”
在結合獨特的激光DUV(深紫外)結構,靈敏的光電倍增器(PMT)和可變偏振的情況下,UVision 3系統也能夠應對32納米存儲器發展的挑戰。在照射和收集光路下新的亮場成像模式滿足了浸沒式光刻對于多種對比度的要求。此外,該系統創新的高準確度缺陷檢測算法和(stitch-to-stitch)逐禎檢測提高了周邊邏輯區域的靈敏度,這是任何其他亮場系統都不具備的關鍵優勢。




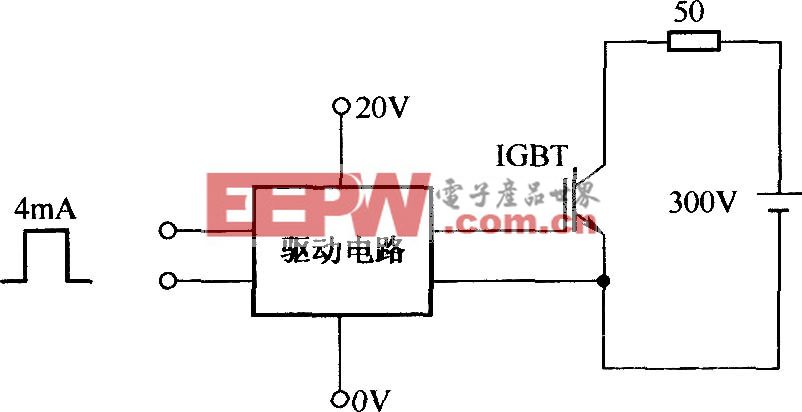


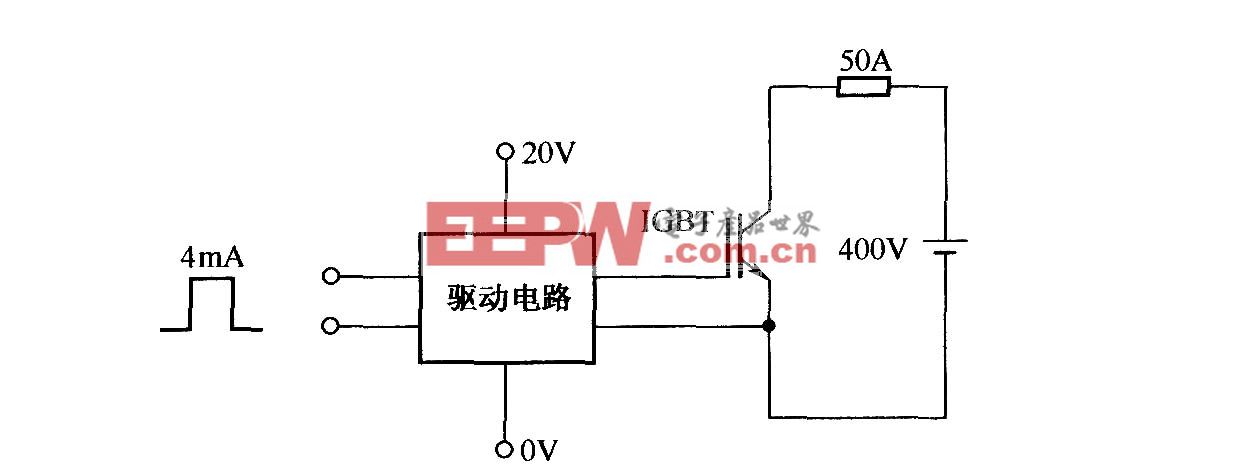





評論