高端封裝產能壟斷 明確目標把握細分市場
——
高端應用促使封裝向高檔發展
賽迪顧問調查報告顯示,2006年我國集成電路產業發展中最大的亮點當屬封裝測試業的加速發展。封裝測試業在近幾年一直呈現穩定增長的勢頭,2002年到2005這4年我國內地的年均增長率為25.6%,但進入2006年之后,出口需求大幅增長,現有企業大幅擴產,同時數個大型新建項目建成投產。在這些因素帶動下,我國內地封裝測試行業呈現加速發展的勢頭。其規模已接近500億元。
目前我國內地市場主要需求仍在DIP、SOP、QFP等中低檔產品上,但是隨著網絡通信領域技術的迅猛發展,數字電視、信息家電和3G手機等產品將大量需要IC高端電路產品,進而對高引腳數的QFP、MCM(MCP)、BGA、CSP、3D、SiP、PiP、PoP等中高檔封裝產品需求十分旺盛,畢克允介紹,國家“十一五”期間的16個專項中,設有核心器件專項,都需要采用先進封裝技術。未來5年,中高檔封裝產品需求將十分旺盛,對此,南通富士通微電子股份有限公司技術中心辦副主任王小江建議,政府部門應給予集成電路封裝業與集成電路設計制造業同樣的政策和扶持,積極引導并從資金上支持我國內地封裝測試企業開發具有自主知識產權的先進封裝測試技術,以提高我國內地封測企業在中高端封測市場的競爭實力。
整體技術水平有差距
雖然我國內地封裝測試產業近年來取得了長足的發展,但整體來講技術水平仍然相對落后。就封裝形式來講,我國內地市場目前的主要需求仍在DIP、SOP(SSOP、TSOP)、QFP(LQFP、TQFP)等中低端產品上,而且QFP(LQFP、TQFP)的引腳數還比較少。隨著通信技術的迅猛發展,我國內地IC市場對高端電路產品的需求不斷增加,IC設計公司和整機廠對QFP(LQFP、TQFP)高腿數產品及MCM(MCP)、BGA、CSP、3D、SiP等中高端封裝產品的市場需求已呈現出較大的增長態勢,在我國內地實現封裝測試的愿望十分強烈。這就要求我國內地封裝測試企業抓住商機,積極開發市場需求的MCM(MCP)、BGA、WLP、CSP、3D、SiP等中高端封裝技術,逐步縮小與國際先進封裝測試技術間的差距。
王小江介紹,2006年,我國內地封裝測試企業的技術能力有了較大幅度的提高。經過長期不懈的科技投入,像長電科技、南通富士通這樣的內資或內資控股的企業已在CSP、MCM、FBP、BGA、SiP等技術領域取得了突破性進展,部分技術產品已實現產業化。我國內地封裝測試整體水平與國際先進水平差距正在縮小。
中國半導體行業協會常務副理事長許金壽認為,目前我國內地多數IC企業投放市場的產品主要仍是以普通消費類IC為主的中低端產品,近幾年我國內地IC設計企業對CPU、高端MCU、通信和數字消費類所需高端芯片的開發取得了突破,但離實現產品化、產業化尚有很大差距。他建議,企業要敢于挑戰占市場份額80%以上的中高檔產品,不僅要有自主知識產權,而且要突破“產品化、產業化”瓶頸,加速IC產品創新。
江蘇長電科技股份有限公司沈陽強調,由于低端分立器件市場的進入門檻并不高,所以將會有更多的我國內地企業加入該低端市場,競爭將日益激烈。沈陽認為,在中高端分立功率器件的應用領域,能夠滿足高端客戶需求,生產出高可靠性分立器件的廠商并不是很多,而這些核心技術大多為國際巨頭所掌握,正是由于核心技術缺失制約,使得我國內地分立器件產業很難向更高層次發展。
明確目標把握細分市場
江蘇省半導體行業協會副秘書長葉如龍在接受《中國電子報》采訪時認為,世界半導體巨頭的封裝廠和我國臺灣先進封裝企業群聚內地,不僅帶來了先進封裝技術和人才,更帶來了先進封裝的客戶流和信息流,為我國內地封裝企業提供了直接或間接的學習交流機會,其培養的本土先進封裝技術人才,也可以為我所用。但同時,由于我國內地封裝測試產業整體水平不高,高端封裝產能幾乎全部被壟斷。
格蘭達科技集團有限公司董事長兼總裁林宜龍在接受《中國電子報》采訪時認為,我國內地封裝產業的市場龐大,全球巨頭都看好我國內地這塊“熱土”,高端封裝的產能早被壟斷,以最新在美國推出市場的蘋果iphone為例,其程式及影像核心處理器是三星的,射頻和基頻晶片是英飛凌的等,我國內地封裝企業還沒有這些能力和機會。雖然這樣,林宜龍認為,我國內地封裝企業的發展空間還是很大的,關鍵是戰略是否清晰,市場目標是否把握住細分了的市場。
林宜龍建議,首先要在傳統Lead frame封裝方面要做得更加成熟,不斷提升產能,不斷擴大規模,以爭取更大的市場占有率,這應該是我國內地企業發展的當務之急。當然,是迫切需要投資和更新工藝與設備的,這方面我國內地企業與國際巨頭的差距要小很多。第二,在高端封裝方面要投資,要有突破,甚至還可以爭取與國際巨頭合作,同時也要爭取中國政府的重點政策扶持,尤其是在封裝方面有規模的我國內地企業很有條件。這一步是奠定行業地位、實現結構調整的必經之路。第三,在新興的LED市場方面可以跟LED企業合作,這也是比較容易的,往往國際巨頭忽略這方面。第四,我國內地封裝企業需要強強聯合,應促成設計、制造、設備、材料等產業鏈上下游不同環節的企業有意識有規劃地建立合作伙伴關系,建立屬于自己的競爭優勢,這樣容易調動更多資源來滿足市場需求。第五,我國內地封裝企業也需要地方政府和各地方客戶群進行有意識有規劃的加強合作,我國內地企業需要更多的扶持。
臺灣封測業動態
臺灣初步批準日月光等
4家封裝測試廠投資祖國大陸
臺灣相關主管負責人目前表示,臺灣已初步批準4家臺灣芯片測試及封裝企業到祖國大陸投資。據港臺媒體報道,這4家公司分別是日月光半導體制造股份有限公司、硅品精密工業股份有限公司、超豐電子和華東科技。按收入計,日月光半導體是全球最大的芯片測試及封裝企業。
臺灣地區首家半導體
封測企業落戶蘇州
臺灣地區封裝測試企業華東科技日前發布了投資公告。公告稱將對華東科技(蘇州)有限公司增資1.3億元人民幣,以拓展公司封裝測試產業以及影像傳感器模塊的生產。
華東科技還傳出消息說,公司已接獲中芯國際內存封裝測試訂單,由于中芯國際內存大廠爾必達合作緊密,有望穩定公司生產線的訂單來源。
臺積電跨足
65納米、45納米SiP服務
臺積電擴大晶圓代工事業版圖,這次鎖定后段封裝工藝,據半導體業者透露,臺積電內部已成立封裝團隊,并展開對外招兵買馬,未來將提供廠內制造及服務。據臺積電內部規劃,2007年封裝主軸將著力于65納米工藝,包括無鉛倒裝芯片封裝及芯片尺寸倒裝芯片封裝(Flip Chip CSP),2008年則將跨入45納米工藝封裝,包括打線(wire bond)及無鉛、Flip Chip CSP等。
臺積電表示,SiP能快速解決上市問題,身為產業一員需進行了解并進行開發,至于封測廠對于臺積電跨入封測舉動,則密切關注。
由于SiP可將兩個以上芯片透過不同封裝技術疊在一起,技術及整合難度相對較SoC(System on Chip)更有效率及容易,SoC上市時程是以18個月為期,而SiP可能僅需6個月就可上市,快速縮短上市時間。
眾多封測廠
恐將成為臺積電轉包商
臺積電除提供工程服務,亦將提供先期(pilot run)倒裝芯片封裝及晶圓測試服務,并延伸與日月光等封測廠合作量產,而所有外部合作封測業者,將被定位為臺積電封測業務的轉包商。
值得注意的是,臺積電不僅內部增設團隊,轉投資公司精材亦與其共同研發后段晶圓工藝技術,除成功開發出3D封裝工藝,目前亦攜手研發微機電(MEMS)核心封裝技術。精材2廠已于第二季度正式開出新產能,預計微機電后段工藝服務最快在第三季度導入量產。臺積電2006年便已成功開發出3D芯片硅片直穿孔(Through Silicon Via;TSV)封裝技術,日前并已對外發表。
不過,封測業者對于臺積電策略性動作仍多處于觀望,封測業者指出,如果臺積電選擇在晶圓層次跨入封測,則對其晶圓代工核心事業具加分效果,但若是晶圓以外的封測技術,如牽涉到基板,那么封測廠仍具長期技術及產能優勢。
國際大廠競相投入SiP
IC設計業者指出,2005年市場規模約11億美元,2010年將增長至41億美元,呈現3倍速成長,同時SiP手機芯片應用市場年復合增長率約13%,高于其他電子產品,而通信產品已占臺積電生產最大宗,臺積電絕對必須策略性跨入封測領域。
臺封測業者則指出,國際半導體大廠對于SiP競相投入,其中,整合元件廠(IDM)由于自己擁有設計、制造及封測,最具先期優勢,像三星電子(Samsung Electronics)2007年第二季SiP標準型DRAM已量產,英特爾(Intel)亦將存儲器與處理器采用SiP進行整合,而臺積電將會是晶圓代工廠跨入封測領域的代表廠商。




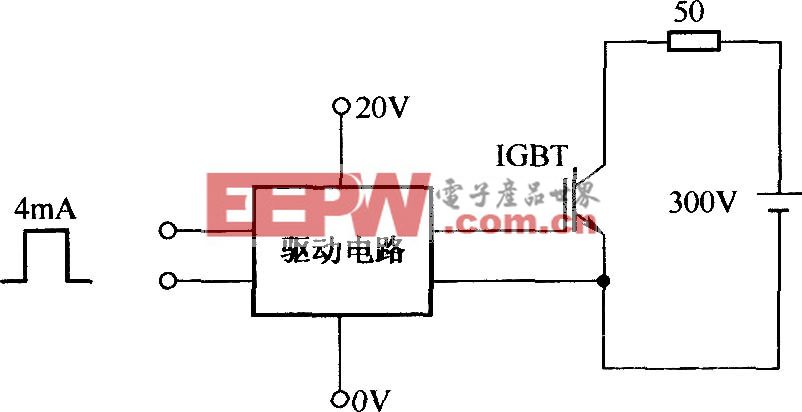








評論