ASML:數值孔徑0.75超高NA EUV光刻設備2030年登場
據日本媒體報導,光刻機設備龍頭阿斯麥(ASML)執行副總裁Christophe Fouquet近日在比利時imec年度盛會ITF World 2023表示,半導體產業需要2030年開發數值孔徑0.75的超高NA EUV光刻技術,滿足半導體發展。
本文引用地址:http://www.j9360.com/article/202306/447943.htmChristophe Fouquet表示,自2010年以來EUV技術越來越成熟,半導體制程微縮至2020年前后三年,以超過50%幅度前進,不過速度可能會在2030年放緩。
故ASML計劃年底前發表首臺商用High-NA(NA=0.55)EUV微影曝光設備(原型制作),2025年量產出貨。2025年開始,客戶就能從數值孔徑為0.33傳統EUV多重圖案化,切換到數值孔徑為0.55 High-NA EUV單一圖案化,降低制程成本,提高產量。
High-NA EUV預估會有五大客戶:英特爾、臺積電、三星、SK海力士、美光,可最早使用設備。科林研發、柯磊、HMI和JSR及TEL等正與ASML合作,開發High-NA EUV材料與特用化學品。
Fouquet表示,EUV光源輸出功率一直穩步增加,ASML傳統型號EUV光源輸出功率為250W~300W,最新型號3600D增加到350W,現在研究層面已做到600W,800W指日可待。
到2030年,使用High NA EUV的多重圖案將與單一圖案一起完成,以提高產量,并降低制程成本,需要更高數值孔徑的EUV曝光(NA=0.75)。藉DUV、ArF、EUV和High-NA EUV技術形成圖案的每個晶體管成本都不斷變化,考量到新技術價格一定高于EUV每套3億美元,High-NA EUV價格將非常可觀,但仍取決于客戶要求和開發成本。




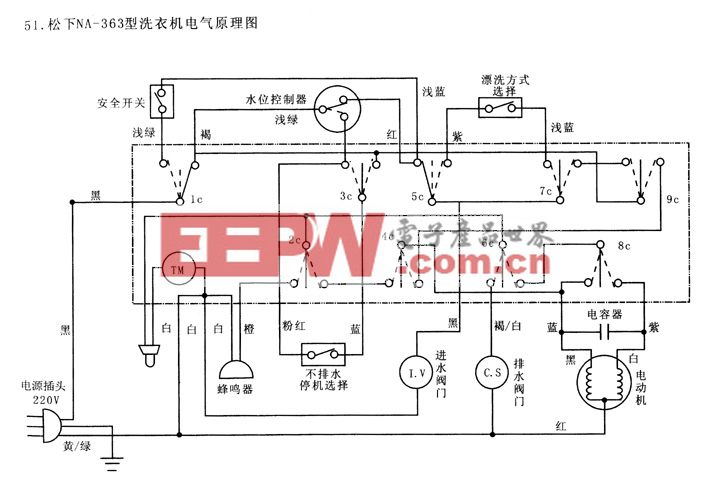
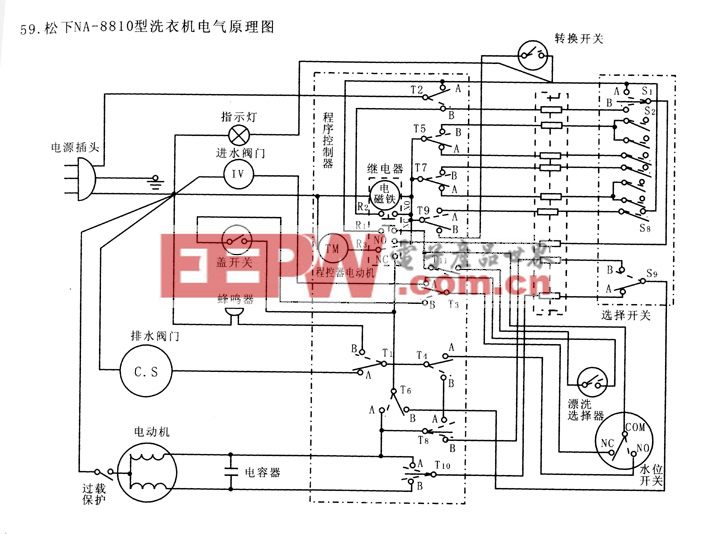
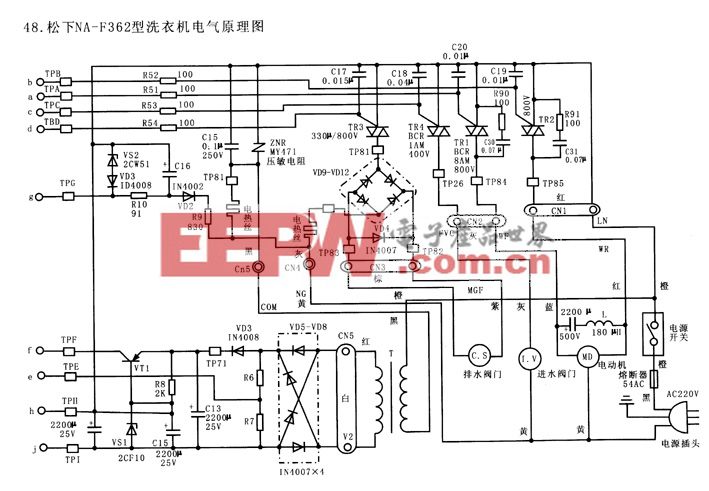
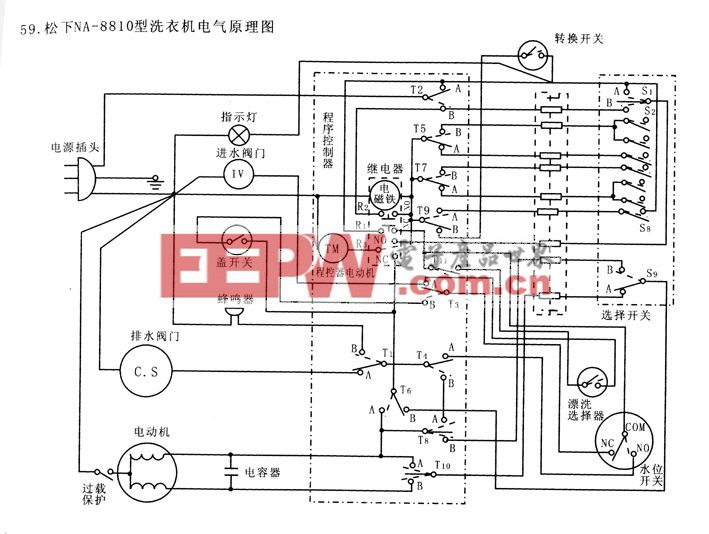
評論