一種增大質量塊的三軸MEMS加速度計的設計
馮?堃,張國俊,王姝婭,戴麗萍,鐘志親(電子科技大學?電子科學與工程學院,成都611731)
本文引用地址:http://www.j9360.com/article/202004/412567.htm摘?要:介紹了一種增大質量塊設計的三軸MEMS加速度計。該加速度計基于絕緣體上硅(SOI)硅片,采用雙面光刻、干法刻蝕的工藝,利用了部分SOI硅片的底層硅部分來增大加速度計的質量塊,設計了基于單一米字形質量塊的三軸MEMS電容式微加速度計。根據不同的外界加速度對器件產生的不同位移,研究了在三個軸向的加速度計的靈敏度,同時分析了加速度計的交叉軸耦合的影響。最后結合Ansys仿真結果得出:所設計的微加速度計具有較高的靈敏度、抗干擾能力強、噪聲較小的優點,在慣性傳感領域有一定的應用前景。
0 引言
SOI(silicon-on insulator,絕緣體上硅)晶片以其優越的單晶材料特性、易于實現大厚度器件、易于實現高深寬比的制造、良好的機械穩定性、殘余應力小以及后續制造工藝簡單的優點逐漸在慣性傳感器領域得到廣泛應用 [1~5] 。采用SOI晶片的MEMS加速度計很容易實現大的慣性質量塊和低布朗噪聲。因此,基于SOI的微加速度計是將來慣性傳感技術的重要發展方向。H.Hamaguchi等人采用了不等高梳齒電極電容設計制作了Z軸加速度計,并以此為基礎實現了三軸線加速度計的設計與制造 [2,3] 。Chia-Pao Hsu等人采用間隙閉合差分電容電極設計在SOI上實現了Z軸加速度計,并采用此技術制成了基于單質量塊的三軸加速度計 [6,7] 。
本文研究的三軸微加速度計采用中心對稱米字形結構設計,實現了只使用一個敏感質量塊來檢測三個方向的加速度,同時避免了交叉軸干擾。同時,由于基于SOI硅片制作,利用了SOI硅片的底層硅,得到了更大的質量塊,提高了靈敏度。
1 加速度計結構與原理
1.1 加速度計結構
圖1為所設計的三軸微加速度計的俯視圖。本文中設計的微加速度計為中心對稱結構,采用米字形質量塊設計,錨點電極采用折疊梁與質量塊連接。由于采用了SOI硅片,可以實現在加工工藝上保留了部分SOI硅片的底層硅部分,增大了加速度計敏感質量塊的質量,從而可以提高微加速度計的靈敏度。在米字形質量塊上包含了八組梳齒結構,與其對應的電容為C x1 ,C x2 ,C y1 ,C y2 ,C z1 ,C z2 ,C z3 和C z4 。
四組電容(C x1 ,C x2 ,C y1 和C y2 )結構相同,采用等高梳齒設計,如圖2,可以用來測量平面方向上,即X、Y軸的加速度。其中,C x1 與C x2 是用來測量X軸加速度的差分電容,C y1 與C y2 是用來測量Y軸加速度的差分電容。通過使可移動梳齒與固定梳齒之間的間距不同,即d 1 ≠d 2 ,實現了變間距的差分電容的設計,從而提高了可測量電容的靈敏度。
另外四組電容(C z1 ,C z2 ,C z3 和C z4 )采用不等高梳齒設計,如圖3,可以用來測量Z軸方向上的加速度。其中,C z1 和C z2 方向的可動梳齒高度為固定梳齒高度的一半,兩種梳齒的下邊緣為同一高度;C z3 和C z4 方向的固定梳齒高度為可動梳齒高度的一半,兩種梳齒的上邊緣為同一高度,實現了變面積的差分電容設計,從而提高了可測量電容的靈敏度。同時,Z軸方向上的可動梳齒與固定梳齒之間的間距相等,均為d 0 ,從而可以起到在電容器上施加調制電壓時減少零極點漂移的作用。
在加速度計的實現工藝上,分別通過采用聚酰亞胺和二氧化硅作為深硅刻蝕的掩膜,來分兩次進行干法深硅刻蝕來加工實現不等高梳齒。如圖2所示,電容C x1 ,C x2 ,C y1 和C y2 所在的梳齒為全高梳齒,需要兩種掩膜;如圖3所示,電容,C z1 ,C z2 ,C z3 和C z4 所在的梳齒為半高梳齒,需要一種掩膜。為了實現增大質量塊的設計,采用了了雙面光刻工藝對SOI硅片的背面進行了光刻,這樣可以保證部分SOI的底層硅得到保留作為加速度計的質量塊的一部分,從而極大增大了慣性質量塊的質量。
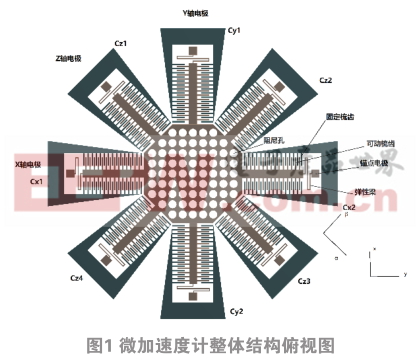


1.2 加速度計原理
所設計的微加速度計傳感原理如下:
對于單個平行板電容器的電容與位移的關系為:

其中,ε為介電常數,l,h和d分別代表梳齒電極的長寬高。
則在X軸的電容位移變化關系為:

同理,Y軸的為:

故當質量塊在X軸上下方向上同時發生位移時,電容變化只取決于X軸方向上的位移變化;當質量塊在Y軸上下方向上同時發生位移時,電容變化只取決于Y軸方向上的位移變化
對于Z軸,分別考慮Z 1,Z2,Z3,Z4 四個方向,同時為了方便討論,以偏離XY軸45°方向的α-β為參考平面。當位移發生在Z軸向上方向時,有


同理,當位移發生在Z軸向下方向時,有

故當質量塊在Z軸上下方向上同時發生位移時,電容變化只取決于Z軸方向上的位移變化,即

從上式(3)、(4)和(11)可以看出,?C x , ?C y和?C z 只與三個軸方向上的位移?x,?y和?z有關,故設計的三軸加速度計理論上并不存在兩個軸之間的交叉耦合。
2 仿真分析
微加速度計的材料為晶相100的硅材料,其彈性模量為190Gpa,密度為2330kg/m 3 。微加速度計中心八邊形部分質量塊邊長為500μm,厚度為SOI頂層硅部分60μm和部分底層硅250μm;中間有圓形阻尼孔,為了方便仿真將其等效為一個大的圓孔,其直徑為400μm。米字形伸長部分尺寸為750μm×100μm×60μm;電容Cx1,Cx2,Cy1和Cy2所在的梳齒厚度H=60μm,電容(Cz1,Cz2,Cz3和Cz4)所在的梳齒厚度h=30μm;靜止狀態時XY軸方向固定梳齒與可動梳齒的正對部分為120μm×60μm,梳齒間距分別為d 1 =5μm,d 2 =10μm;Z軸方向固定梳齒與可動梳齒的正對部分為120μm×30μm,梳齒間距分別為d 0=30μm。器件總質量為6.31×10 -7kg。
利用Ansys有限元分析軟件對器件進行靜力學分析。分別對器件施加1g的加速度,得到微加速度計三個軸向的位移靈敏度,如表1。

利用Ansys有限元分析軟件對器件進行模態分析,如圖4。
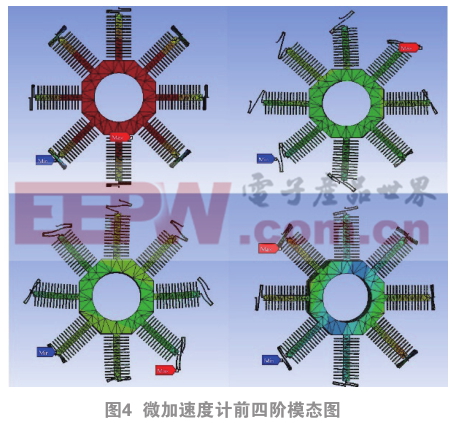

由表2可知,所設計的微加速度計結構對稱,前四階模態為沿Z軸平動、沿X軸平動、沿Y軸平動和沿Z軸轉動。其中,前三階是所設計的微加速度計的主模態,其他模態是頻率為主模態2倍的雜項模態,這樣基本可以實現避免雜項模態對主模態的干擾。同時,三個軸向的共振頻率相差較大,說明所設計的微加速度計的交叉干擾較小,符合設計目標。
3 加工工藝
本文中的微加速度計的加工工藝流程圖如圖2所示。(a)采用熱氧化工藝在SOI硅片兩面熱生長厚度為1μm的氧化硅為后續深硅刻蝕的硬掩膜。(b)第一次雙面光刻出X軸和Y軸所在的等高梳齒的平面方向區域,RIE刻蝕氧化硅形成圖形。(c)在SOI正面頂層硅上進行電子束蒸發鋁,然后第二次雙面光刻形成電極區域。(d)采用聚酰亞胺(PI)為光刻膠第三次雙面光刻整個米字形結構,亞胺化形成第二種后續深硅刻蝕的硬掩膜。(e)第一次深硅刻蝕,刻蝕厚度為頂層硅厚度的一半,然后氧等離子體RIE去除亞胺化后的聚酰亞胺。(f)第二次干法刻蝕,刻蝕到SOI硅片的絕緣層,至此正面結構已經完成。(g)背面第一次雙面光刻背面電極區域,RIE刻蝕氧化硅,形成背面第一次干法刻蝕時的硬掩膜,(h)背面第二次雙面光刻背面米字形結構,然后亞胺化形成硬掩膜。(i)背面第一次深硅刻蝕,刻蝕厚度為底層硅厚度的一半,然后氧等離子體RIE去除亞胺化后的PI。(j)背面第二次深硅刻蝕,刻蝕到SOI硅片絕緣層。(k)用氫氟酸蒸氣去除氧化硅絕緣層和掩膜層,釋放結構得到微加速度計。
4 結論
本文所設計的三軸微加速度計采用雙面光刻和干法刻蝕工藝,充分利用SOI硅片底層硅部分來增大質量塊的質量,差分電容結構設計,使得,靈敏度得到了提高。同時采用全對稱的米字形結構,有效地減小了三軸間加速度的交叉耦合干擾。所設計的微加速度計基于SOI硅片制作,避免了化學機械平坦化和鍵合等工藝,簡化了工藝。總體而言,該全對稱三軸微加速度計設計合理,具有較小的交叉軸干擾和較大的靈敏度,有良好的應用前景。


參考文獻:
[1] MATSUMOTO Y,NISHIMURA M,MATSUURA M,et al. Three-axis SOI capacitive accelerometer with PLL C-V converter[J].Sensors & Actuators A Physical,1999:75 77–85.
[2] TSUCHIYA T,FUNABASHI H. A z-axis differential capacitive SOI accelerometer with vertical comb electrodes[J].Sensors & Actuators A Physical,2004,116(3):378-383.
[3] HAMAGUCHI H,SUGANO K,Tsuchiya T,et al. A DIFFERENTIAL CAPACITIVE THREE-AXIS SOI ACCELEROMETER USING VERTICAL COMB ELECTRODES[C]// Solid-state Sensors, Actuators & Microsystems Conference, Transducers International.IEEE,2007.
[4] ABDOLVAND R ,AMINI B V,Ayazi F.Sub-Micro-Gravity In-Plane Accelerometers With Reduced Capacitive Gaps and Extra Seismic Mass[J].Journal of Microelectromechanical Systems,2007,16(5):1036-1043.
[5] ZAMAN M F,SHARMA A,HAO Z,et al.A Mode-Matched Silicon-Yaw Tuning-Fork Gyroscope With Subdegree-Per-Hour Allan Deviation Bias Instability[J].Journal of Microelectromechanical Systems, 2008, 17(6):1526-1536.
[6] HSU C P,YIP M C,FANG W.Implementation of a gap-closing differential capacitive sensing Z-axis accelerometer on an SOI wafer[J].Journal of Micromechanics & Microengineering,2009,19(7):75006-75007.
[7] HSU C P,HSU Y C,YIP M C,et al. A Novel SOI-Based Single Proof-Mass 3-Axis Accelerometer with Gap-Closing Differential Capacitive Electrodes in All Sensing Directions[C]//Sensors.IEEE,2011.
(注:本文來源于科技期刊《電子產品世界》2020年第05期第59頁,歡迎您寫論文時引用,并注明出處。)




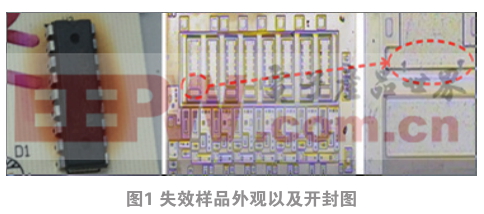



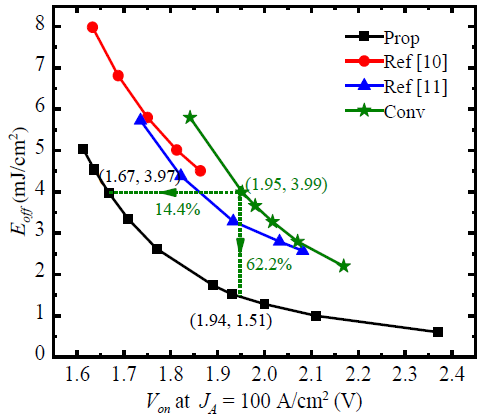


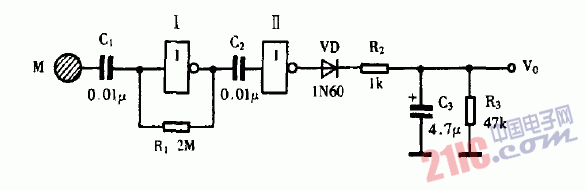


評論