A*STAR和Soitec宣布推出聯合計劃,以開發全新先進封裝層轉移工藝
北京,2019年3月27日 – 新加坡科技研究局(A*STAR)微電子研究院(IME)與設計和生產創新性半導體材料的全球領先企業Soitec宣布推出一項聯合計劃,將要開發采用先進多芯片晶圓級封裝技術的新一代層轉移工藝。基于微電子研究院的晶圓級扇出封裝(FOWLP)和2.5D硅中介層(TSI)以及Soitec的Smart Cut?技術,新的轉移工藝可實現高性能、高能效、高產量以及成本競爭力。
本文引用地址:http://www.j9360.com/article/201903/398932.htm先進封裝技術目前主要用于服務器、智能手機、工業和汽車應用領域的系統級芯片(SOC),通過將半導體芯片組合封裝的多種方式來降低成本、功耗和提供高效散熱。截至2022年,先進封裝市場預計將擴大三倍,為中高端應用提供200萬片初制晶圓1。隨著晶體管和電路尺寸日益縮小以及數量不斷增多,芯片變得日益復雜。這推動了先進封裝工藝的協同創新,通過尋找優化成本效益的制造方案并增加數據帶寬,以支持智能手機、云計算和邊緣計算應用。
先進封裝中的一項標準工藝涉及使用全硅晶片來進行層轉移,其成本高達3美分/ mm2。 Soitec在未來三年內將與IME合作,評估其Smart Cut?技術在IME兩個先進封裝平臺晶圓級扇出封裝(FOWLP)和2.5D硅中介層(TSI)的應用。這些測試的目的是開發出一種新的層轉移工藝,以促進未來封裝技術發展。此新工藝可實現更高性能、更低功耗,同時通過避免使用全硅片來降低生產成本。IME同時也會展開測試來評估新工藝的可靠性與穩健性,幫助Soitec檢測技術長期應用的可行性。
Smart Cut?技術利用光離子注入和晶圓鍵合來定位超薄單晶層,并將其從一個襯底轉移到另一個襯底。它的工作原理類似納米刀,可使有源層獨立于支撐機械襯底被管理。這樣做的主要優點在于可使用低溫鍵合和分離技術,創建多個薄至納米級別且幾近無缺陷的硅層。這些硅層之后將被置于有源晶體管電路的頂部,通過調節注入能量和工藝工程,可以高精度地調節被轉移的硅層厚度。最后經由蝕刻和沉積工藝,晶體管即可完成。 此外,供體襯底可以多次重復使用,因為每次層轉移操作之后,硅晶圓表面會被重新拋光。
作為領先的研究機構,IME匯聚了全球半導體供應鏈包括無晶圓設計公司、代工廠、外包半導體裝配和測試服務提供商(OSATs)、EDA供應商、設備制造商和材料開發商等,展示可用于智能手機、數據中心、高性能計算、5G 、物聯網以及汽車應用的先進封裝解決方案。在此次與Soitec的合作中,IME將在架構定義、建模、設計、流程集成、可靠性評估和故障分析這些先進封裝領域提供專業知識。 IME將在其功能齊全且先進的300mm晶圓級封裝線——2.5D / 3DIC試生產線中率先采用先進的封裝技術。 IME在高級晶圓級扇出封裝(FOWLP)和2.5D硅中介層(TSI)方面的端到端工藝能力和專有技術將縮短開發周期,并可提供基于Smart Cut?技術的經濟高效的封裝解決方案。合作期間,Soitec將在其位于新加坡的Pasir Ris工廠為IME提供設備、研發人員和凈室專用空間。
微電子研究院執行董事Dim-Lee Kwong教授說道:“先進封裝在高價值半導體市場上仍然是一個亮點,我們很高興能與Soitec合作開發封裝解決方案,這將有助于先進封裝在新加坡以及全球的細分市場發展。”
Soitec首席技術官Christophe Maleville表示:“Soitec和IME相信Smart Cut?技術將帶來突破性成果,徹底改變2.5D/3D層轉移工藝流程。這一戰略合作不僅將開發出先進封裝這一Smart Cut? 新應用場景,還將為Soitec開辟在優化襯底制造之外的全新市場。”
文獻來源:
1. Yole 2017發展報告關于12英寸晶圓中3D及 2.5D硅通孔(TSV) 技術









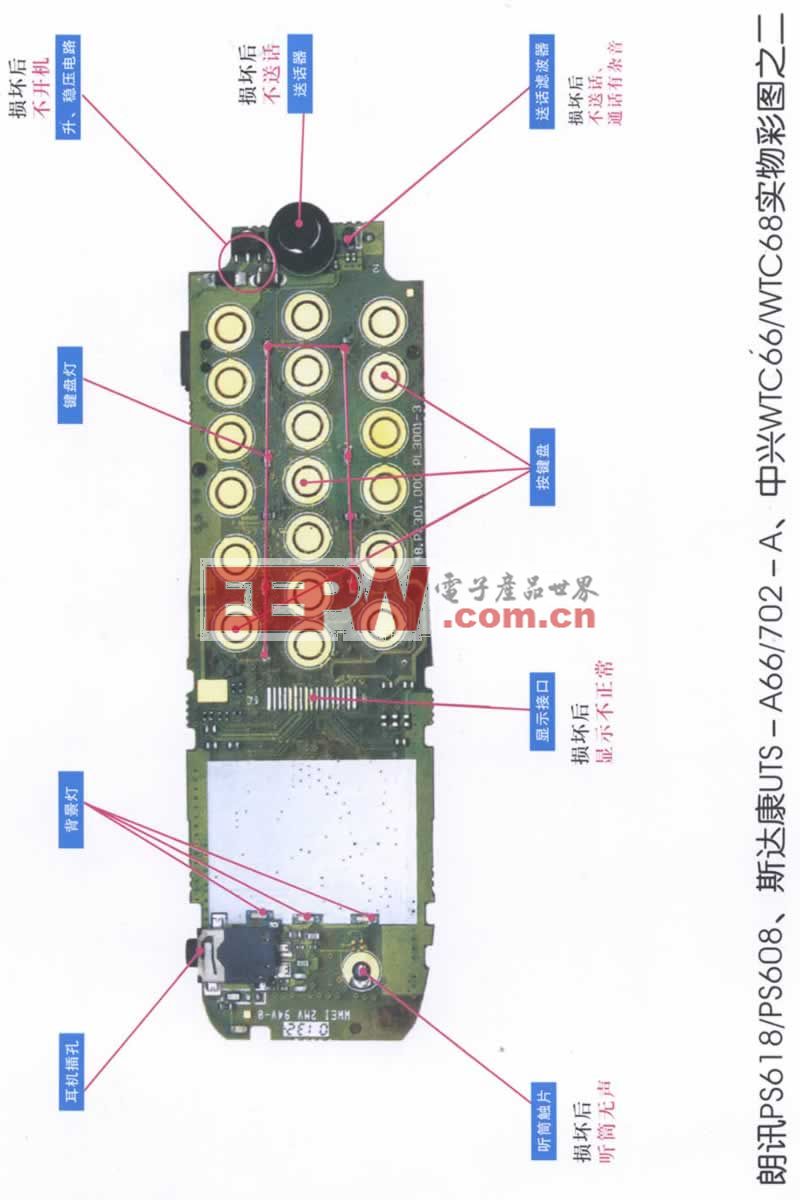
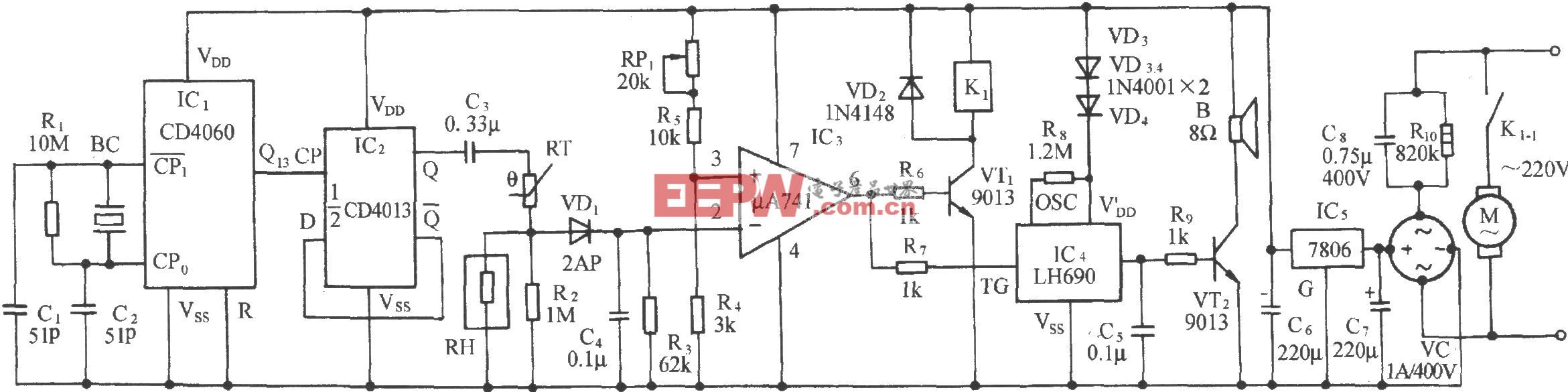



評論