AFM:應對65nm以下測量技術挑戰
半導體工業目前已經進入65納米及以下技術時代,關鍵特征通常為納米級,如此小特征的制造工藝要求特殊的測量儀器,以便能夠表征出納米級幾何尺寸,從而檢驗出任何偏離工藝規格中心值的情況,確保與設計規格保持一致。
本文引用地址:http://www.j9360.com/article/193845.htm掃描探針顯微鏡(SPM)已經應用在納米技術和納米科學中,主要包括以結構、機械、磁性、形貌、電學、化學、 生物、工程等為基礎的研究和工業應用。原子力顯微鏡(AFM)是以顯微力感應為基礎的SPM家族的一個分枝。工業用AFM是一種自動的,由菜單驅動的在線生產測量機臺,自動的硅片操作、對準、探針操作、位置尋找、抓圖和圖像數據分析等測量都被編程在菜單中,最終輸出測量數據。值得一提的是,AFM作為130納米及以下技術結點中表征刻蝕和化學機械拋光(CMP)的尺寸測量的先進幾何控制方法已經被廣泛應用于半導體制造業,與半導體工業工藝技術類似,光掩膜和薄膜為主的工業也采用了AFM作為工藝測量方法。
AFM可以測量表面形貌、3D尺寸和幾何形狀,水平表面輪廓和垂直側壁形狀輪廓。測量區域可以在很小(50μm)或很長(10cm)的范圍內。采用小比例AFM模式,可測量的變量有高度或深度、線寬、線寬變化、線邊緣粗糙度、間距、側壁角度、側壁粗糙度、橫截面輪廓、和表面粗糙度。在長范圍(Profiler模式),AFM用于CMP工藝總體表面形貌輪廓的測量。
AFM測量的優點
除AFM以外,CD SEM、橫截面SEM(X-SEM), TEM、Dual Beam、光學散射測量、光學輪廓儀和探針輪廓儀均為已有的表征和監控工藝尺寸的測量方法。通常認為最值得信任的3D尺寸分析方法應該是X-SEM或TEM,但是X-SEM或TEM的主要障礙是樣品制備、機臺操作、時間以及費用。X-SEM和TEM會破壞硅片,并且只能一次性的切入特征區域。TEM不能在光刻膠上工作。CD SEM會導致光刻膠吸收電荷、收縮、甚至損傷光刻膠, CD SEM幾乎無法提供3D形狀信息。光學散射測量具有快速和準確的特點,但是只能在特殊設計的結構上工作,并且無法提供LER和LWR數據。為特定的薄膜結構發展一套可靠的散射測量數據庫通常是非常困難并且耗時的。空間分辨率和光斑尺寸會限制X射線、光學厚度、或形貌測定儀器的應用。
由于AFM的獨特特性,使得它與其它測量技術相比具有更明顯的優勢。AFM可以在非真空環境中工作。它是一種表面力感應的顯微鏡,所以它可以提供非破壞性的,直接的3D測量,勝于模擬、 模型、或者推斷。AFM可以快速的檢查橫截面輪廓或表面形貌,以便檢測出尺寸是否在規格內,而不需像TEM一樣破壞制品。AFM沒有光斑尺寸限制,并且在CMP平坦化應用方面,它比光學或探針輪廓儀具有更高的分辨率。
AFM可以在線測量當今納米電子工業中的任何材料樣品,不管其薄膜層結構、光學特性或是組成。AFM對于最新的先進工藝和材料集成中涌現出來的新材料(SiGe、高K、金屬柵和低K)并不敏感。電路圖案的逼真度和尺寸取決于其附近的環境。然而,AFM測量與特征接近度或圖形密度效應之間沒有偏差,這些都是ITRS2005測量部分所列出的重要要求。因此,AFM在世界半導體工業贏得了廣泛應用,并且其在130納米及更小尺寸中的應用正在增加。在應用目的方面,AFM可以被用為在線監控深度、CD和輪廓,取代TEM進行橫截面輪廓的工程分析,是在線散射測量和CD校準以及追蹤的極好的參考。表1為自動AFM測量的典型應用。
操作原理
在一個反饋控制回路中,AFM掃描儀控制一個微小探針在X(或Y)和Z方向進行掃描,在探針和樣品表面間保持緊密的接近,從而獲得所有XY和Z方向的高分辨率方位數據,如圖1所示。

3D形貌的原始數據是由x/y/z空間數據構造而來的。然后,離線的軟件分析使探頭形狀不再環繞AFM圖像并且提取出測量目標相關的重要幾何參數, 如深度、 特定區域頂部/中間/底部的線寬、 側壁角度和輪廓形狀、 或表面形貌。
STI刻蝕
淺溝槽隔離(STI)是邏輯、 DRAM和Flash等硅器件中的一種普通工藝。STI形成晶體管中的活性硅區域和隔離氧化物區域。AFM在STI刻蝕深度、線寬、CD和側壁輪廓測量方面有著獨特的應用。圖2展示了與TEM橫截面相比典型的AFM輪廓。從比較中可以說明,AFM在表征窄深的STI溝槽全3D幾何形狀方面取代了冗長和高耗費的TEM,STI溝槽在活性硅區域頂部通常有一層氮化物作為硬掩膜,CD SEM通常很難準確測量從氮化物到硅轉換區域的硅的CD。高分辨率的AFM可以掃描出這個轉換點,可以在轉換位置編程出圖象分析,從而計算氮化物底部CD和硅頂部的CD。AFM可以對整片硅片進行快速非破壞性的描繪,而X-SEM和TEM是無法做到的。溝槽側壁角度(SWA)的微小變化會引起最終圖形特征上線寬的巨大變化,AFM為高深寬比的STI溝槽提供了非破壞性及高精度的SWA表征。

STI CMP
STI模塊進行化學機械拋光(CMP)和濕法氮化物去除以后,產生了多樣化的表面以及在活性區域及附近場氧化物區域的高度差(圖3)。硅片內實際電路區域的局部形貌變化是一個非常關鍵的參數。晶體管電學失效與較大的或反向的活性硅與場氧化物之間的步高差相關,CMP形貌取決于特征尺寸和圖形密度。然而,芯片內不同特征之間的步高相關性很差,這再一次證明了傳統的橢偏法和散射測量法在測量劃片區域里大塊的測試結構以反映芯片內真實的電路形貌時已存在不足。AFM是一種在線測量技術,可以在任何需要的測試點進行快速的和非破壞性的芯片內形貌監控。

AFM可以檢測和測量出由于硅片邊緣不均勻的拋光速率造成的反向的硅/氧化物步高(圖4),圖4展示了氮化物去除后活性區域和隔離區域交界處氧化物的轉換,以及何種轉換會影響晶體管的閾值電壓。AFM對轉換輪廓非常敏感,并且轉換深度可以得到監控。






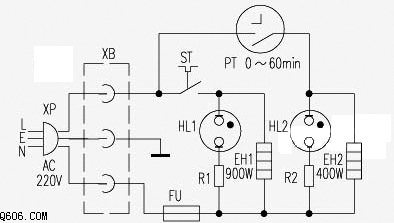
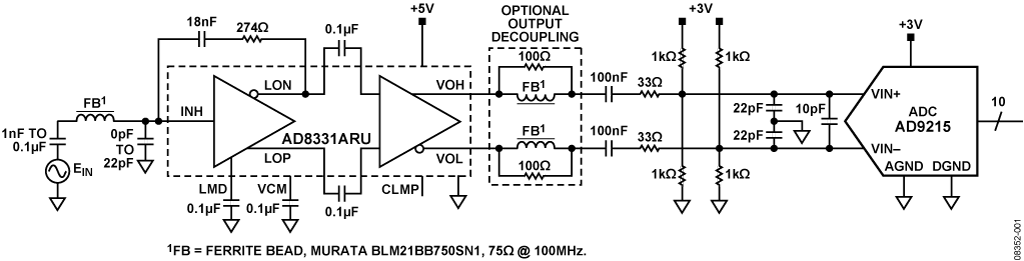


評論