基于Arrhenius模型快速評價功率VDMOS可靠性
0 引言
本文引用地址:http://www.j9360.com/article/186470.htm垂直導電雙擴散場(VDMOS)效應晶體管是新一代集成化半導體電力器件的代表[1]。與功率晶體管相比,具有輸入阻抗高、熱穩定性高、開關速度快、驅動電流小、動態損耗小、失真小等優點。因此VDMOS廣泛應用在電機調速、工業控制、汽車電器等領域。但功率VDMOS的高壓大電流的工作條件使得其功耗及自熱效應相當明顯,而溫度的升高又必然會加速微電子器件的退化機理[2-3],對其可靠性造成嚴重影響甚至引起失效,且器件的失效必然會影響整個系統的正常工作,帶來的損失不可估量。因此對功率VDMOS進行可靠性及失效分析顯得尤為重要,國外對功率VDMOS的可靠性[4]進行了初步分析,國內也已經對GaAs微波場效應晶體管[5-6]進行了研究,但對功率VDMOS場效應晶體管的可靠性研究特別是其完整的可靠性數據和失效機理的研究還比較少。本文采用恒定溫度應力加速壽命試驗對功率VDMOS的可靠性進行了研究,得到較為完整的可靠性數據,并分析得到引起其漏源電流IDS退化的主要失效機理是柵極擊穿,從而為功率VDMOS類型器件的加工制造及應用等方面提供有價值的數據。
1 理論
電子器件在正常工作狀態下,很難在短時間內得到有價值的壽命數據。本文采用恒定應力加速壽命實驗,通過施加溫度應力,加速了元器件的參數退化,縮短了壽命,在短時間內得到必要的壽命數據。
以溫度為加速應力的恒定應力加速壽命試驗多采用Arrhenius模型。該模型的阿列尼斯經驗公式可以反映電子元器件壽命與溫度之間的物理化學變化過程,即
![]()
式中:A為常數;k為玻爾茲曼常數;E為激活能;T為絕對溫度;t為時間。
從式(1)中可以看出,壽命的對數與絕對溫度的倒數之間滿足直線方程,因此通過施加幾組溫度應力得到元器件在這幾個溫度點上的壽命后,利用這一關系外推出表征元器件失效機理的激活能E和正常溫度下的元器件壽命。
若試驗中采取不同的溫度應力T1、T2,其他條件不變,要產生相同的退化量,所需時間分別為t1、t2,其比即為溫度加速因子τ,則
![]()
2 結溫的確定及試驗
2.1 結溫的確定
樣管在室溫(27℃)下的結殼熱阻RJC=1.7℃/W(廠家提供)。樣管偏置條件為VDS=7.5V、IDS=0.8A時,其在室溫(27℃)下的殼溫TC=107℃,由式(3)可得室溫下TJ=117℃,即
![]()
式中:TJ為結溫;RJC為結殼熱阻;P為功率;Tc為殼溫。
由熱阻定義,利用室溫下的數據,可以計算得到Rc-a=13.3℃/W,因此ΔTc-a=80℃,故環境溫度為150、165、180℃時樣管殼溫分別為230、245、260℃,利用式(3)即可得到其對應結溫分別為TJ150℃=240℃、TJ165℃=255℃、TJ180℃=270℃。
2.2 試驗
試驗器件為TO-3封裝的n溝道功率VDMOS場效應晶體管。試驗分三組進行,每組試驗樣品數均為6只,施加溫度分別為150、165、180℃(對應結溫分別為240、255、270℃),試驗時間分別為1058、920、690h,偏置條件為VDS=7.5V、IDS=0.8A;試驗前均對VDMOS場應晶體管特性(導通電阻、輸出特性、轉移特性)進行初測,測試周期為46h;失效判據為ΔIDS>初始值20%、ΔRDS>初始值20%、ΔIDSR>初始值20%,以大者為準。
3 試驗結果與數據處理
3.1 參數退化
試驗測試發現功率VDMOS的導通電阻、漏源電流、截止漏電流均發生退化,其結果見表1~3所示。



由表1~3所示結果,可以得出IDS退化是功率VDMOS的主要失效模式,因此以IDS的退化作為失效判據。
3.2 試驗結果
失效樣管(以3#為例)試驗前后輸出特性曲線對比如圖1所示,溫度應力為150℃,柵源電壓為4.2~4.8V時,試驗后(圖中細線)樣管漏源電流較試驗前(圖中圓點粗線)有明顯降低,說明柵極控制能力減弱,柵極可能發生累積失效。



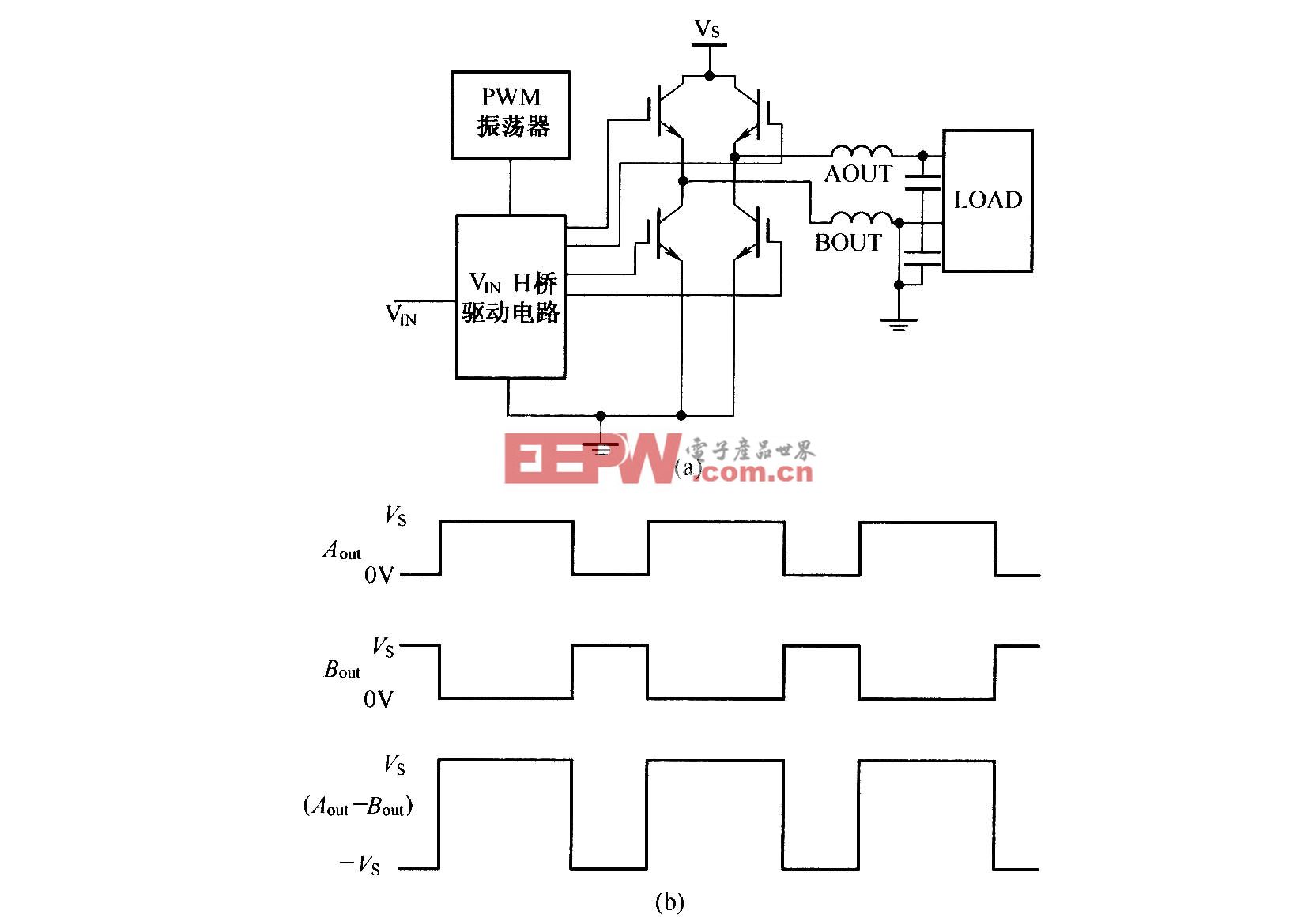







評論