以較高的開關頻率在負載點 (POL) 應用中工作
熱性能
本文引用地址:http://www.j9360.com/article/170366.htmPower Clip 33 的熱性能表現在一系列板設計上。 FDPC8011S 擁有從結到外殼/電路板的非常有效的熱傳遞。 板熱阻是限定封裝溫度上升以及相應的電流能力的主導因數。 HS 漏極朝下和 LS 源極朝下的 Power Clip 在典型的板設計中提供到兩個大銅箔的良好熱連接,V+ 和 GND。 為了實現最佳性能,使用 vias 增強到板 Vcc和 PGND 板架的熱互連。 有關最佳設計實踐的一個更詳細的討論,請參見FDPC8011S 數據手冊的“應用信息”部分。
圖16和圖17顯示分立式Mosfet和 Power Clip 封裝的相關溫度性能。 這一特性描述在一個可與服務器類產品設計相媲美的厚銅電路板上完成。 額定電流的一個常見性能指標是高于環境溫度 40 °C 的 Tj上升。 在 65 °C 環境溫度下,將產生 105 °C 的 Tj。如圖16所示,對于這一評測板,更小占位面積的 FDPC8011S 在分立Mosfet電流能力的 10% 內。 鑒于分立Mosfet的較大占位面積,這是一項卓越的性能。
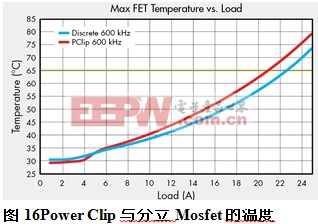
設計的額定溫度基于 HS 和 LS MOSFET 溫度的最大值。 對于該設計,圖17顯示,HS MOSFET 溫度上升對于分立設計和 Power Clip 設計來說都是限制性參數。
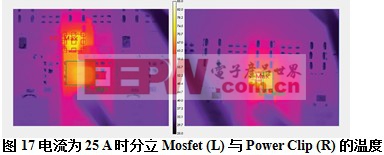
三個備用設計的熱阻數據表值如表4所示。 為標準的 1 平方英寸測試板上描繪的部件指定 RΘJA 的額定值。 一個典型的電源 PCB 擁有比測試板更低的熱阻。表5顯示在厚銅和薄銅評測板上測量的 RΘJA值。 分立Mosfet和 Power Clip 的最大額定電流在薄型銅板上較低,因為具有更高的熱阻。 表5所示的熱阻值同時描繪了結到環境和晶圓之間的耦合。 參考資料Error! Reference source not found.詳細介紹如何執行這些測量,以及如何使用產生的熱矩陣預測給定功率損耗的 HS 和 LS TJ。
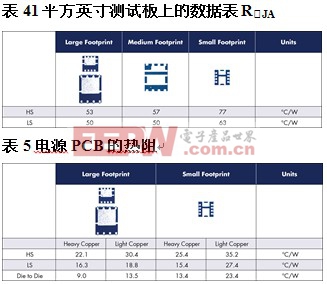
結論
結合先進硅和 Power Clip 封裝技術,FDPC8011S Power Clip 33 MOSFET 大大減少了封裝寄生參數并超越了之前的分立式 Power 33 / Power 56 或 Power Stage 56 Dual 組合的 A/mm2性能。 在同步整流降壓應用中,Power Clip 33 MOSFET 能夠以比分立Mosfet更高的頻率和效率在 20 A 負載下運行。
功率損耗降低,使得操作頻率和效率更高。 因此,與傳統的分立式 MOSFET 解決方案相比,Power Clip 33 MOSFET 可以節省 42% 的總面積。













評論