道康寧加盟EV集團開放平臺
全球MEMS(微電子機械系統)、納米技術和半導體市場晶圓鍵合及光刻設備的領先供應商EV集團(EVG)今天宣布,道康寧公司已加入該集團的“頂尖技術供應商”網絡,為其室溫晶圓鍵合及鍵合分離平臺——LowTemp?平臺的開發提供大力支持。道康寧是全球領先的有機硅及硅技術創新企業,此次加盟EVG這個業內領先的合作伙伴網絡堪稱此前雙方緊密合作的延續,之前的合作包括對道康寧的簡便創新雙層臨時鍵合技術進行嚴格的測試。今年7月,EVG推出全新的LowTemp公開平臺,并宣布擴大其全球材料供應鏈,以加速其高端三維集成電路 (3D-IC)封裝業務的發展。
本文引用地址:http://www.j9360.com/article/167297.htmEV集團業務開發總監Thorsten Matthias博士表示:“道康寧是全球先進有機硅技術及專業技能方面的領導者,他們的加入無疑將使我們的這個臨時晶圓鍵合/鍵合分離材料開放平臺錦上添花。他們的合作方式和優秀原材料能幫助我們開發出創新而又具有成本效益的臨時鍵合解決方案,為我們的客戶在室溫下采用傳統生產方式進行活性及載體晶圓的鍵合與鍵合分離提供了更多選擇。
EVG的LowTemp?臨時鍵合/鍵合分離(TB/DB)平臺具有三種不同的室溫下晶圓鍵合分離工藝——紫外(UV)激光分離、多層粘合劑分離以及ZoneBOND?技術——它們都可用于大批量生產。
道康寧的雙層TB/DB有機硅技術包含一個粘合劑層和一個脫離層,從而能夠在室溫下實現簡單的臨時鍵合與鍵合分離,并在總體厚度變化較小的情況下表現出最佳的使用性能,因此非常適合EV集團的平臺。此外,當工藝要求在300° C的高溫下,它還具有出色的耐化學性和熱穩定性。
通過此次將道康寧列為其開放材料平臺的合格供應商,EV集團的TB/DB技術實力將大大增強,全球供應鏈也將得到大大拓展。此非獨占協議的簽訂將使雙方得以聯手為先進半導體封裝行業提供經濟實惠的TB/DB解決方案,為3D-IC封裝應用的大規模生產提供支持。
道康寧先進半導體材料全球行業總監Andrew Ho表示:“此次雙方在3D-IC封裝和穿透硅通孔(TSV)開發領域達成合作,無論對于道康寧,對EV集團,還是整個半導體行業來說都是一個重要的里程碑。這不僅是對道康寧簡便室溫TB/DB技術的一次重要驗證,更將進一步實現EV集團業內領先的規模生產開放平臺的商業化。不僅如此,這項技術也是新一代微電子應用實現3D-IC封裝工藝集成的一項重大進步。”
3D-IC集成技術通過將水平芯片結構疊層組裝到垂直架構中,可大大提高微型電子設備的形狀因數(芯片尺寸)、帶寬(芯片晶體管密度)以及功能性。但是,要實現這項革命性的新技術首先需要簡便經濟的TB/DB解決方案將活性晶圓片鍵合到更厚的載體晶圓上,該技術能使活性晶圓的厚度減少到50 μm甚至更低,并通過穿透硅通孔(TSV)技術實現垂直方向芯片之間的相互連接。
EV集團將參加本周在臺北舉行的“國際半導體展(SEMICON Taiwan)”,屆時歡迎對EVG最新晶圓鍵合以及其他加工解決方案感興趣的媒體朋友和業內分析師前往臺北世界貿易中心南港展覽館416號展位,或參加公司在展會期間的技術推介活動。9月4日15:30~ 16:00,公司技術開發及IP總監Markus Wimplinger先生將在TechXPOT作題為“如何使用LowTemp?鍵合分離技術低成本地處理晶圓薄片” 的論文演講。Wimplinger先生還將于9月5日15:10~ 15:40在展會期間的MEMS論壇上發表題為“晶圓鍵合技術在大規模消費MEMS應用領域的發展趨勢”的演講。



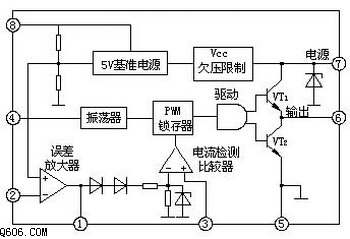










評論