IC測試的創新
—— Innovation of IC Test

隨著IC制程節點從90nm向65nm和45nm延伸,需要測試的數據量會激增,相應地會帶來測試成本的提高(圖1)。例如,從90nm到65nm時,由于增加了門數,傳統的測試量急劇增加;同時,在速(at-speed)測試也成倍增加,這是由于時序和信號完整性的敏感需求;到了45nm時代,在前兩者的基礎上,又增加了探測新缺陷的測試。
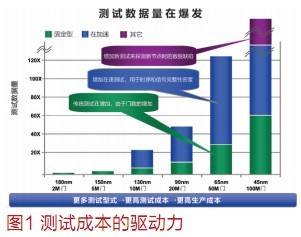
為了提高測試效率,對測試數據的壓縮持續增長。據ITRS(國際半導體技術發展路線圖)預測(圖2),2010年的壓縮需求比2009年翻番。










評論