臺積電將制造前所未有的巨型芯片
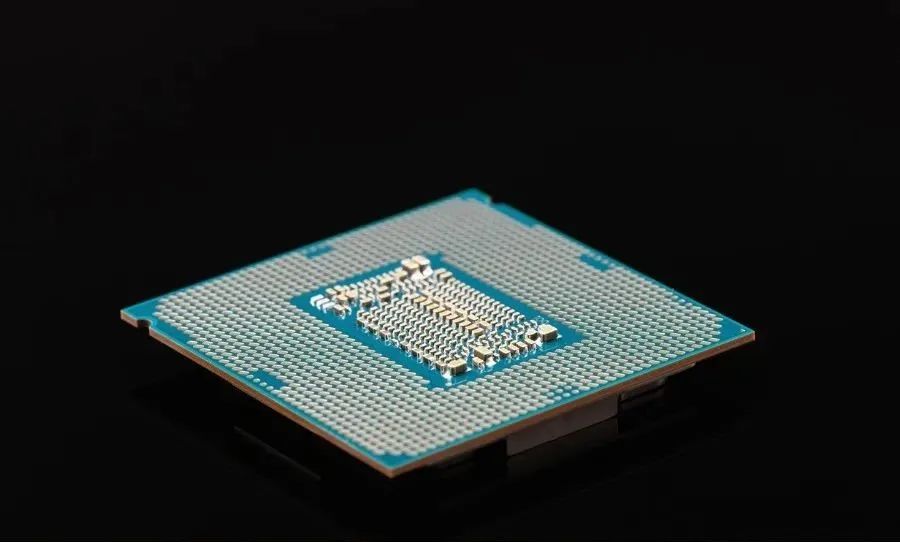
120x120mm的大芯片,有12個HBM4E堆棧。
 您是否認為AMD的 Instinct MI300X和英偉達B200是面積很大的GPU?再想一想:臺積電正在開發其基板芯片(CoWoS)封裝技術的一個版本,該技術將使系統級封裝(SiP)大兩倍以上,該公司在其北美技術研討會上宣布。這些將使用120x120mm的巨型封裝,并將消耗數千瓦的電力。最新版本的CoWoS允許臺積電構建是常規光掩模尺寸(858mm2)大約3.3倍的硅中介層。因此,邏輯電路、8個HBM3/HBM3E 內存堆棧、I/O和其它小芯片最多可以占用 2831mm2 的面積。AMD 的 Instinct MI300X 和英偉達的B200使用這項技術,盡管英偉達的B200處理器比 AMD 的 MI300X 大。下一代CoWoS_L將于 2026 年投入生產,將能夠實現約 5.5 倍的十字線尺寸的轉接板(這可能不如去年宣布的 6 倍十字線尺寸那么令人印象深刻)。這意味著 4719 mm2 將可用于邏輯、多達 12 個 HBM 內存堆棧和其他小芯片。這樣的SiP還需要更大的基板,根據臺積電的幻燈片,我們正在尋找100x100mm。因此,此類處理器將無法使用 OAM 模塊。臺積電不會止步于此,到2027年,它將擁有CoWoS技術的一個新版本,該技術將使轉接層的尺寸達到8倍或更多,這將使小芯片的空間達到6864平方毫米。臺積電設想的設計之一依賴于四個堆疊式系統級集成芯片 (SoIC),與 12 個 HBM4 內存堆棧和額外的 I/O 芯片配對。這樣一個巨人肯定會消耗大量的電力——我們在這里談論的是數千瓦,需要非常復雜的冷卻技術。臺積電還希望此類解決方案使用120x120mm的基板。有趣的是,今年早些時候,Broadcom 展示了一款定制的 AI 處理器,具有兩個邏輯芯片和 12 個 HBM 內存堆棧。我們沒有這個規格,但它看起來比 AMD 的 Instinct MI300X和英偉達的B200大,不過,它沒有臺積電2027年計劃的那么大。
您是否認為AMD的 Instinct MI300X和英偉達B200是面積很大的GPU?再想一想:臺積電正在開發其基板芯片(CoWoS)封裝技術的一個版本,該技術將使系統級封裝(SiP)大兩倍以上,該公司在其北美技術研討會上宣布。這些將使用120x120mm的巨型封裝,并將消耗數千瓦的電力。最新版本的CoWoS允許臺積電構建是常規光掩模尺寸(858mm2)大約3.3倍的硅中介層。因此,邏輯電路、8個HBM3/HBM3E 內存堆棧、I/O和其它小芯片最多可以占用 2831mm2 的面積。AMD 的 Instinct MI300X 和英偉達的B200使用這項技術,盡管英偉達的B200處理器比 AMD 的 MI300X 大。下一代CoWoS_L將于 2026 年投入生產,將能夠實現約 5.5 倍的十字線尺寸的轉接板(這可能不如去年宣布的 6 倍十字線尺寸那么令人印象深刻)。這意味著 4719 mm2 將可用于邏輯、多達 12 個 HBM 內存堆棧和其他小芯片。這樣的SiP還需要更大的基板,根據臺積電的幻燈片,我們正在尋找100x100mm。因此,此類處理器將無法使用 OAM 模塊。臺積電不會止步于此,到2027年,它將擁有CoWoS技術的一個新版本,該技術將使轉接層的尺寸達到8倍或更多,這將使小芯片的空間達到6864平方毫米。臺積電設想的設計之一依賴于四個堆疊式系統級集成芯片 (SoIC),與 12 個 HBM4 內存堆棧和額外的 I/O 芯片配對。這樣一個巨人肯定會消耗大量的電力——我們在這里談論的是數千瓦,需要非常復雜的冷卻技術。臺積電還希望此類解決方案使用120x120mm的基板。有趣的是,今年早些時候,Broadcom 展示了一款定制的 AI 處理器,具有兩個邏輯芯片和 12 個 HBM 內存堆棧。我們沒有這個規格,但它看起來比 AMD 的 Instinct MI300X和英偉達的B200大,不過,它沒有臺積電2027年計劃的那么大。 CoWoS結構及技術分類介紹CoWoS(Chip On Wafer On Substrate)是臺積電的一種 2.5D 先進封裝技 術,由 CoW 和 oS 組合而來:先將芯片通過 Chip on Wafer(CoW)的封裝制程連 接至硅晶圓,再把 CoW 芯片與基板(Substrate)連接,整合成 CoWoS。核心是將 不同的芯片堆疊在同一片硅中介層實現多顆芯片互聯。在硅中介層中,臺積電使 用微凸塊(μBmps)、硅通孔(TSV)等技術,代替了傳統引線鍵合用于裸片間連 接,大大提高了互聯密度以及數據傳輸帶寬。CoWoS 技術能夠提高系統性能、降 低功耗、縮小封裝尺寸,也為臺積電在后續的封裝技術保持領先奠定了基礎。根據采用的不同的中介層,臺積電把 CoWoS 封裝技術分為三種類型——CoWoS-S、CoWoS-R以及 CoWoS-L。CoWoS-S(Silicon Interposer)即 2011 年首次亮相的用硅(Si)襯底作為 中 介 層 的 先 進 封 裝 技 術 ( chip-on-wafer-on-substrate with silicon interposer),提供廣泛的中介層尺寸、HBM 立方體數量和封裝尺寸,可以實現大 于 2X 的光罩尺寸(1,700mm2),中介層集成了領先的 SoC 芯片和四個以上的 HBM2/HBM2E 立方體。在過去,“CoWoS”一般即指以硅基板作為中介層的先進封裝 技術。CoWoS-S 從 2011 年的第一代升級到 2021 年的第五代,第六代技術有望于 2023 年推出,將會在基板上封裝 2 顆運算核心,同時可以板載多達 12 顆 HBM 緩 存芯片。第五代 CoWoS-S 技術使用了全新的 TSV 解決方案,更厚的銅連接線,晶 體管數量是第 3 代的 20 倍。它的硅中介層擴大到 2500mm2,相當于 3 倍光罩面 積,擁有 8 個 HBM2E 堆棧的空間,容量高達 128 GB。并且,臺積電以 Metal Tim 形式提供最新高性能處理器散熱解決方案,與第一代 Gel TIM 相比,封裝熱阻降 低至 0.15 倍。CoWoS-R(RDL Interposer)是使用有機基板/重新布線層(RDL)替代了硅 (Si)作為中介層的先進封裝技術。CoWoS-R 采用 InFO 技術使用 RDL 作為中介 層并為 chiplets 之間的互連提供服務,特別是在 HBM(高帶寬存儲器)和 SoC 異 構集成中。RDL 中介層由聚合物和銅走線組成,機械靈活性相對較高,這種靈活 性增強了 C4 接頭的完整性,并允許新封裝可以擴大其尺寸以滿足更復雜的功能 需求。CoWoS-L是使用小芯 片(chiplet)和 RDL 作為中介層(硅橋)的先進封裝技術,結合了 CoWoS-S 和 InFO 技術的優點,具有靈活的集成性。CoWoS-L 使用內插器與 LSI(本地硅互連) 芯片進行芯片間互連,以及用于電源和信號傳輸的 RDL 層,從 1.5 倍 reticle interposer 尺寸和 1 倍 SoC+4 倍 HBM 立方體開始,并將向前擴展,將包絡擴大 到更大的尺寸,以集成更多芯片。CoWoS-L 服務的主要功能包括:第一,LSI 芯片,用于通過多層亞微米銅線實現高布線密度晶粒互連。LSI 芯片 可以在每個產品中具有多種連接架構(例如 SoC 到 SoC、SoC 到 chiplet、SoC 到 HBM 等),也可以重復用于多個產品。相應的金屬類型、層數和間距與 CoWoS-S 的 產品一致。第二,基于成型的中介層,正面和背面具有寬間距的 RDL 層,TIV(通過中介層 通孔)用于信號和功率傳輸,可在高速傳輸中提供低高頻信號損失。第三,能夠在 SoC 芯片下方集成其他元件,例如獨立的 IPD(集成無源器件), 以支持其與更好的 PI/SI 的信號通信。來源:半導體產業縱橫
CoWoS結構及技術分類介紹CoWoS(Chip On Wafer On Substrate)是臺積電的一種 2.5D 先進封裝技 術,由 CoW 和 oS 組合而來:先將芯片通過 Chip on Wafer(CoW)的封裝制程連 接至硅晶圓,再把 CoW 芯片與基板(Substrate)連接,整合成 CoWoS。核心是將 不同的芯片堆疊在同一片硅中介層實現多顆芯片互聯。在硅中介層中,臺積電使 用微凸塊(μBmps)、硅通孔(TSV)等技術,代替了傳統引線鍵合用于裸片間連 接,大大提高了互聯密度以及數據傳輸帶寬。CoWoS 技術能夠提高系統性能、降 低功耗、縮小封裝尺寸,也為臺積電在后續的封裝技術保持領先奠定了基礎。根據采用的不同的中介層,臺積電把 CoWoS 封裝技術分為三種類型——CoWoS-S、CoWoS-R以及 CoWoS-L。CoWoS-S(Silicon Interposer)即 2011 年首次亮相的用硅(Si)襯底作為 中 介 層 的 先 進 封 裝 技 術 ( chip-on-wafer-on-substrate with silicon interposer),提供廣泛的中介層尺寸、HBM 立方體數量和封裝尺寸,可以實現大 于 2X 的光罩尺寸(1,700mm2),中介層集成了領先的 SoC 芯片和四個以上的 HBM2/HBM2E 立方體。在過去,“CoWoS”一般即指以硅基板作為中介層的先進封裝 技術。CoWoS-S 從 2011 年的第一代升級到 2021 年的第五代,第六代技術有望于 2023 年推出,將會在基板上封裝 2 顆運算核心,同時可以板載多達 12 顆 HBM 緩 存芯片。第五代 CoWoS-S 技術使用了全新的 TSV 解決方案,更厚的銅連接線,晶 體管數量是第 3 代的 20 倍。它的硅中介層擴大到 2500mm2,相當于 3 倍光罩面 積,擁有 8 個 HBM2E 堆棧的空間,容量高達 128 GB。并且,臺積電以 Metal Tim 形式提供最新高性能處理器散熱解決方案,與第一代 Gel TIM 相比,封裝熱阻降 低至 0.15 倍。CoWoS-R(RDL Interposer)是使用有機基板/重新布線層(RDL)替代了硅 (Si)作為中介層的先進封裝技術。CoWoS-R 采用 InFO 技術使用 RDL 作為中介 層并為 chiplets 之間的互連提供服務,特別是在 HBM(高帶寬存儲器)和 SoC 異 構集成中。RDL 中介層由聚合物和銅走線組成,機械靈活性相對較高,這種靈活 性增強了 C4 接頭的完整性,并允許新封裝可以擴大其尺寸以滿足更復雜的功能 需求。CoWoS-L是使用小芯 片(chiplet)和 RDL 作為中介層(硅橋)的先進封裝技術,結合了 CoWoS-S 和 InFO 技術的優點,具有靈活的集成性。CoWoS-L 使用內插器與 LSI(本地硅互連) 芯片進行芯片間互連,以及用于電源和信號傳輸的 RDL 層,從 1.5 倍 reticle interposer 尺寸和 1 倍 SoC+4 倍 HBM 立方體開始,并將向前擴展,將包絡擴大 到更大的尺寸,以集成更多芯片。CoWoS-L 服務的主要功能包括:第一,LSI 芯片,用于通過多層亞微米銅線實現高布線密度晶粒互連。LSI 芯片 可以在每個產品中具有多種連接架構(例如 SoC 到 SoC、SoC 到 chiplet、SoC 到 HBM 等),也可以重復用于多個產品。相應的金屬類型、層數和間距與 CoWoS-S 的 產品一致。第二,基于成型的中介層,正面和背面具有寬間距的 RDL 層,TIV(通過中介層 通孔)用于信號和功率傳輸,可在高速傳輸中提供低高頻信號損失。第三,能夠在 SoC 芯片下方集成其他元件,例如獨立的 IPD(集成無源器件), 以支持其與更好的 PI/SI 的信號通信。來源:半導體產業縱橫*博客內容為網友個人發布,僅代表博主個人觀點,如有侵權請聯系工作人員刪除。



