- 據外媒報道,近日,三星公司已經完成了扇出晶圓級封裝(FOWLP)工藝的驗證,并已經開始向客戶交付產品,而首款采用該封裝工藝的芯片,會是明年搭載在 Galaxy S24 / S24+ 手機中的 Exynos 2400 芯片。據悉,FOWLP 技術被認為是提高半導體芯片性能的關鍵技術,也是三星追趕臺積電的重要法寶之一。據了解, 目前半導體芯片封裝主流需要芯片連接到PCB(印刷電路板)上來堆疊它們,而FOWLP不需要 PCB,因為芯片直接連接到晶圓上,與目前使用的FC-BGA(Flip Chip-Ball Gr
- 關鍵字:
三星 晶圓封裝 fowlp
- iPhone7采用的扇出型晶圓級封裝技術是什么?-傳蘋果在2016年秋天即將推出的新款智能型手機iPhone 7(暫訂)上,將搭載采用扇出型晶圓級封裝(Fan-out WLP;FOWLP)的芯片,讓新iPhone更輕薄,制造成本更低。那什么是FOWLP封裝技術呢?
- 關鍵字:
iPhone7 FOWLP 扇出型晶圓級封裝技術 芯片
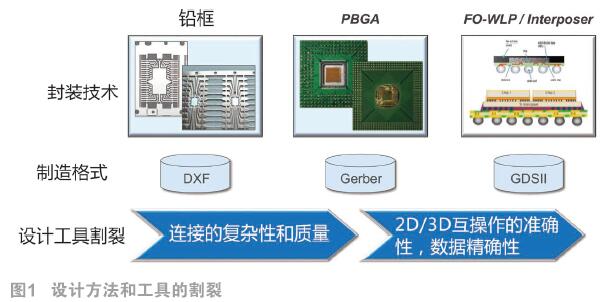
- 作者 王瑩HDAP的挑戰 有人認為摩爾定律在IC制程上已接近極限,但如果在封裝上繼續創新,例如利用疊層芯片封裝,摩爾定律還可以繼續走下去。因此,擴張式的摩爾定律會在封裝上實現,包括手機、通信、智能設備(諸如無人機等)、自動駕駛汽車、安全(security)、網絡、硬盤存儲器、服務器等,都將受益于HDAP(高密度先進封裝)的創新。 傳統封裝在基板上有引腳,現在基板上的引腳數量越來越多,誕生了各種新型封裝,諸如TSMC的扇出晶圓級封裝(FOWLP),interposer-based(基于中間層的) 封裝(
- 關鍵字:
HDAP Mentor IC設計和封裝 FOWLP 201708

- 日本市場研調機構17 日公布調查報告指出,隨著蘋果(Apple)于 2016 年在應用處理器(Application Processor,AP)上采用“扇出型晶圓級封裝(Fan-out Wafer Level Package,FOWLP)”技術,帶動該封裝技術市場急速擴大,且預期 2017 年會有更多廠商將采用該技術,預估 2020 年 FOWLP 全球市場規模有望擴大至 1,363 億日元,將較 2015 年(107 億日元)暴增約 12 倍(成長 1,174%)。
&
- 關鍵字:
FOWLP 封裝
- 臺積電搶下蘋果(Apple)A10處理器代工訂單,三星電子(Samsung Electronics)系統LSI事業部認為關鍵在于臺積電具備扇出型晶圓級封裝(Fan-out WLP;FoWLP)后段制程競爭力,臺積電稱其為整合型扇型封裝(Integrated Fan Out;InFO),為此三星決定整合集團力量,由三星電機(Semco)跨足半導體封裝市場,與三星電子合作研發FoWLP技術,以利在新一輪客戶訂單爭奪賽中,全面迎戰臺積電。
韓媒ET News報導,業界傳聞三星電機從三星顯示器(Sams
- 關鍵字:
三星 FoWLP
- 傳蘋果(Apple)決定在下一款iPhone上采用扇出型晶圓級封裝(Fan-out WLP;FOWLP)技術。由于半導體技術日趨先進,無須印刷電路板(PCB)的封裝技術出現,未來恐發生印刷電路板市場逐漸萎縮的現象。
據韓媒ET News報導,日前業界傳聞,蘋果在2016年秋天即將推出的新款智能型手機iPhone 7(暫訂)上,將搭載采用FOWLP封裝技術的芯片,讓新iPhone更輕薄,制造成本更低。
先前蘋果決定在天線開關模組(Antenna Switching Module;ASM)上導
- 關鍵字:
FOWLP PCB
fowlp介紹
您好,目前還沒有人創建詞條fowlp!
歡迎您創建該詞條,闡述對fowlp的理解,并與今后在此搜索fowlp的朋友們分享。
創建詞條
關于我們 -
廣告服務 -
企業會員服務 -
網站地圖 -
聯系我們 -
征稿 -
友情鏈接 -
手機EEPW
Copyright ?2000-2015 ELECTRONIC ENGINEERING & PRODUCT WORLD. All rights reserved.
《電子產品世界》雜志社 版權所有 北京東曉國際技術信息咨詢有限公司

京ICP備12027778號-2 北京市公安局備案:1101082052 京公網安備11010802012473