IC封測業新時代到來
近日,日月光研發中心的首席運行官何明東在接受媒體采訪時表示,隨著許多新的封裝技術導入以滿足市場需要,日月光(ASE)相信全球IC封裝測試業的新時代已經到來,各種IC封裝型式的呈現將更加促使產業間加強合作。
本文引用地址:http://www.j9360.com/article/82384.htm隨著摩爾定律緩慢地于2014年向16納米工藝過渡,與之前5至10年相比較,由于終端電子產品市場的需求,IC封裝的型式急劇增加,在過去的5年中己有4至5倍數量的增加,相信未來的5年將繼續增長達10倍。隨著IC封裝業的新時代到來肯定會給工業帶來巨大的商機。
2000年ASE認為倒裝技術(flipchip)是主流,現在來看穿透硅通孔技術(TSV)可能是下一代封裝的主流技術。自從業界開創硅片級封裝(WLCSP)的核心技術以來,意味著技術本身僅需要加進些新的設備到現有生產線中即能成功。目前,ASE的WLCSP和凸點封裝能力己是全球第一,通過構建ASE的WLCSP能力使ASE的硅通孔技術領先于競爭對手1至2年。因為整個ASE集團有能力支持測試和封裝技術,如ASE的測試系統可支持各種襯底材料的發展,以及獲得通用科學工業園(USI)的幫助來支持系統集成。對于穿透硅通孔技術,ASE有望在今明兩年成形,2010年開始有真正的銷售額。
當各種新的封裝形式剛進入研發階段時,成本上無法同技術合作者如IDM、設備制造商和供應商來分擔,而自己也不可能來承擔如此高額的費用。ASE的策略是轉向與研究所和對此項技術有興趣的客戶合作,通過合作開發擴大視野及分擔費用,因而ASE能保持研發費用控制在年銷售額的2至3%。
隨著工業的特征尺寸越來越小,材料和設備的重要性急劇上升,以及工業的人才資源越來越精,所以工業的發展總是趨于“大者恒大”,意味著新入門者的機會變小。12年前臺灣大約總計有60至70家后道封裝測試公司,但現在已經減小到只有個位數的公司仍在運行及有收益。
盡管倒裝芯片封裝目前仍是主流技術,但這并不意味著如引線框架及球柵陣列等封裝型式將消失。因為工業己出現很大的改變,可以看到在裸管芯和材料方面的成本壓力仍繼續存在。在如此嚴峻的環境下,對于那些小公司,由于缺乏支持,所以未來的工業兼并步伐將加快,這是總的趨勢。




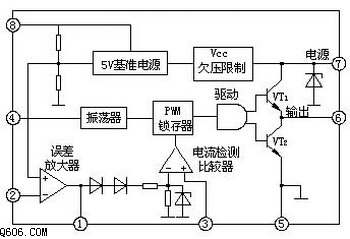









評論