電子封裝與SMT是平行還是相交?
目前,封裝技術的定位已從連接、組裝等一般性生產技術逐步演變為實現高度多樣化電子信息設備的一個關鍵技術。更高密度、更小凸點、無鉛工藝等都需要全新的封裝技術,以適應消費電子產品市場快速變化的特性需求。而封裝技術的推陳出新,也已成為半導體及電子制造技術繼續發展的有力推手,并對半導體前道工藝和表面貼裝()技術的改進產生著重大影響。
本文引用地址:http://www.j9360.com/article/81353.htm如果說倒裝芯片凸點生成是半導體前道工藝向后道封裝的延伸,那么,基于引線鍵合的硅片凸點生成則是封裝技術向前道工藝的擴展。我們不難觀察到,面向部件、系統或整機的多芯片組件()封裝技術的出現,徹底改變了封裝只是面向器件的概念,由于MCM技術是集、混合電路、SMT及半導體技術于一身的集合體,所以我們可稱之為保留器件物理原型的系統。
在整個電子行業中,新型封裝技術正推動制造業發生變化,市場上出現了整合主動和被動組件、模擬和數字電路,甚至含有功率組件的封裝模組,這種將傳統分離功能混合起來的技術手段,正在使后端組件封裝和前端裝配融合變成一種趨勢。新型封裝技術促使組件的后端封裝工序與貼裝工藝前端工序逐漸整合,很有可能會引發SMT產生一次工藝革新。
可以說,元器件是SMT技術的推動力,而SMT的進步也推動著芯片封裝技術不斷提升。片式元件是應用最早、產量最大的表面貼裝元件,自打SMT形成后,相應的IC封裝則開發出了適用于SMT短引線或無引線的LCCC、PLCC、SOP等結構。四側引腳扁平封裝(QFP)實現了使用SMT在PCB或其他基板上的表面貼裝,BGA解決了QFP引腳間距極限問題,CSP取代QFP則已是大勢所趨,而倒裝焊接的底層填料工藝現也被大量應用于CSP器件中。
隨著01005元件、高密度CSP封裝的廣泛使用,元件的安裝間距將從目前的0.15mm向0.1mm發展,這勢必決定著SMT從設備到工藝都將向著滿足精細化組裝的應用需求發展。但SiP、MCM、3D等新型封裝形式的出現,使得當今電子制造領域的生產過程中遇到的問題日益增多。由于多芯片模組等復雜封裝的物理設計、尺寸或引腳輸出沒有一定的標準,這就導致了雖然新型封裝可滿足市場對新產品的上市時間和功能需求,但其技術的創新性卻使SMT變得復雜并增加了相應的組裝成本。
可以預見,隨著無源器件以及IC等全部埋置在基板內部的3D封裝最終實現,引線鍵合、CSP超聲焊接、DCA、PoP(堆疊裝配技術)等也將進入板級組裝工藝范圍。所以,SMT如果不能快速適應新的封裝技術則將難以持續發展。
為了迎合后端組件封裝和前端裝配的融合趨勢,封裝業者及其設備供應商與SMT制造商和設備商之間只有密切合作,才能真正滿足消費電子時代的市場需求。由工藝決定設備及配置,這就是中國電子制造業未來的發展趨勢。中國的半導體封裝正處于高速發展階段,電子組裝業的擴張已有放緩之勢。在此背景下,加強封裝、組裝產業間的技術交流與協作,將對推動中國半導體封裝、電子組裝業持續高速發展起到積極的作用。但令人遺憾的是,目前國內將封裝與電子組裝有機銜接的交流平臺卻較少。
2007年首次將封裝與電子組裝結合起來進行交流的“CHINA SMT FORUM”引起了業內的關注。據悉,這個由德國美沙國際展覽公司(BMC AG)主辦的年度大會今年還將增設展覽內容,PACKAGING/SMT/ASSEMBLY展會將突出展示先進的和組裝技術,通過將電子封裝技術和組裝工藝設備進行整合,為電子封裝、組裝及相關領域的專業人士搭建一個有關各方相互間對上話的技術交流平臺。
BMC AG中國稱,2008中國國際電子封裝和組裝技術設備展暨大會,得到了德國機械設備制造業聯合會(VDMA)的主動支持。同時,國內主要封裝設備、封裝廠、SMT設備商、電子制造商等均表達出極強的參與愿望。中國已是全球電子制造中心,在不久的將來也勢必會成為全球封裝業的重鎮。所以,在解決好后端組件封裝和前端裝配融合的問題上,中國比世界上任何一個國家和地區都顯得迫切。



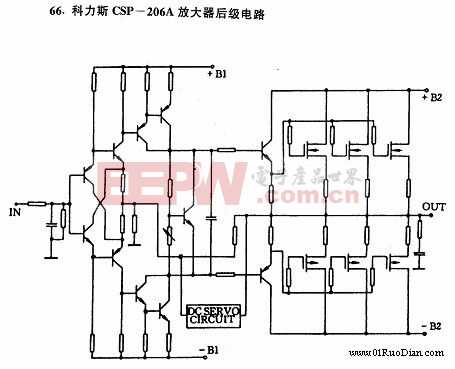






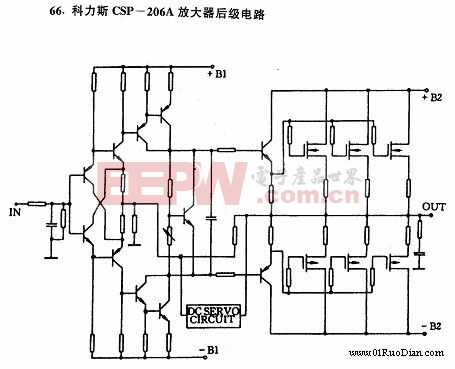
評論