光學光刻和EUV光刻中的掩膜與晶圓形貌效應
時域有限差分法(FDTD)將離散積分格式用于微分形式麥克斯韋方程。此方法非常靈活,易于適應各種不同的幾何形狀和入射場條件。這一方法的計算結果和精確度主要取決于依據每波長網格點數(GPW) 的空間離散化程度。計算時間和存儲要求與模擬體中網格點總數是線性比例關系。很多情況下,為了得到某些現象的直觀近場分布圖和定性研究,15-25 GPW就足夠了。光刻模擬的典型準確度要求多半需要100GPW以上。FDTD已被應用于解決先進光刻中的許多典型問題。
像波導法(WGM)和嚴格耦合波分析(RCWA)一樣,模態法也是用切割模擬體、切片內電磁場和光學材料特性的Fourier展開式,以及它們之間Fourier系數的耦合解麥克斯韋方程。散射場是以產生的代數方程式的解獲得的。WGM(及類似方法)的計算結果和準確度主要決定于Fourier展開式的階數(WG階)和切片數。計算時間和存儲要求隨WG階的三次方增加。一般說來,對于求解具有矩形塊結構幾何形狀(如垂直吸收側壁)的2D問題(線條和隔離),這些模態法是非常準確而有效的。這些方法縮微化能力差使其難以應用到更大的3D問題(如接觸孔的半密矩陣)。已開發了特殊的分解方法解決這一問題。有效執行WGM目前已用于光學和EUV掩膜及晶圓形貌效應的高效模擬。
其它EMF模擬方法基于麥克斯韋方程的積分表達式。最近的論文證明,對于模擬形狀復雜的掩膜幾何圖形的光衍射,有限元方法(FEM)和有限積分技術(FIT)具有極高的準確度。這使得這些方法對于標定其它方法和一些特殊場合的模擬非常有用。詳細了解和精確模擬從光刻掩膜和晶圓上的(亞)波長尺寸特征圖形產生的光衍射,對于開發和優化先進光刻工藝是不可或缺的。
掩膜形貌的影響
掩膜模型
圖1是光透射通過光掩膜用的二種本質上不同的模擬方法。在Kirchhoff方法中(左圖),透射光的幅值及相位直接由掩膜版圖確定。對于所示的二元掩膜,在鉻覆蓋的區域內,透射光的幅值為0.0,其余地方為1.0。透射光的相位是常數。精密掩膜模型(右圖)用麥克斯韋方程的數值解法計算透射光的幅值和相位。通過近場Fourier變換得到掩膜遠場內的衍射譜,示于圖1的下半部分。光刻成像系統的投影光瞳覆蓋一部分衍射譜,并將其轉換為晶圓一側的圖形。通常,掩膜是由不同方向照明的。特定照明方向的衍射光可以用二種方法得到:用精密EMF模擬相關的入射光方向;或對于計算前入射光方向的衍射譜進行角度偏移(旋轉)(Hopkins法)。對所有相關入射光方向的精密EMF模擬(不用Hopkins法)是最準確而又耗時的。
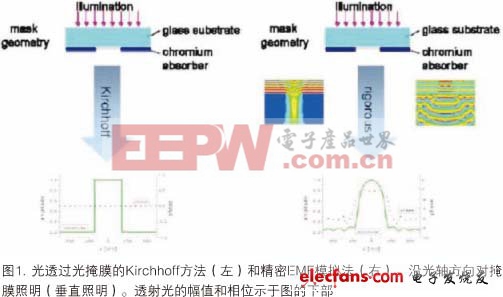
掩膜衍射分析
直接分析掩膜衍射譜或掩膜衍射分析可用來識別最重要的掩膜側散射效應的成像結果,即所謂的掩膜形貌效應。圖2顯示垂直入射光零級和一級衍射光的模擬衍射效率及這些衍射級間的相位差。
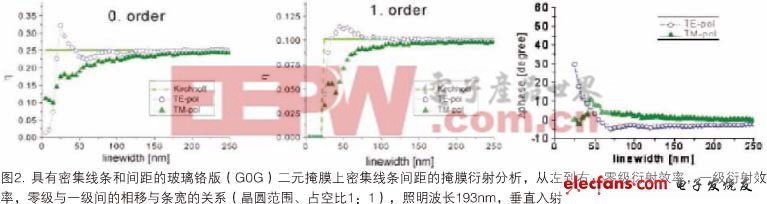
對比所謂的薄掩膜或Kirchhoff 法,EMF模擬結果證明掩膜特征尺寸和入射光的極化對衍射光的強度及相位有顯著影響。特征尺寸和極化的影響隨條寬的減小而增加。對于80nm以下的特征尺寸,可以觀察到顯著的掩膜引起的相位效應。這些相位效應產生像差一類的結果。
光學掩膜OPC效果
衍射效率變化與掩膜特征尺寸的關系在掩膜的光學鄰近修正(OPC)中是一定要考慮的。圖3比較了標準的衰減型移相掩模(AttPSM)上線條和間距的OPC曲線,它們是分別就不同的掩膜模型和特征尺寸計算出來的。模擬是對典型的晶圓堆疊進行的,采用與光刻膠全物理模型結合的矢量成像模擬。首先,計算產生有特定目標線寬的密集圖形的曝光劑量。然后改變節距。對每一節距計算掩膜特征尺寸(晶圓范圍),產生有特定劑量和目標的半密集圖形。特征尺寸和數值孔徑(NA)成比例產生約為0.31的恒定k1成像因子。
根據圖3,掩膜模型特定OPC曲線間的差異隨特征尺寸的減小而增加。對于90nm或更大的特征尺寸,有和沒有Hopkins法的精密模擬產生的結果幾乎是一樣的。此外,Kirchhoff模型與精密模型間的差異在節距上顯不出太多變化。有關影響很容易用OPC模型的光刻膠內核補償。對于45nm的特征尺寸,情況就不是這樣,此時可看到節距上模型差異有顯著變化。圖4說明了照明形狀對45nm線條OPC曲線的影響。依據這些結果,更為局部的(特定特征)照明設置(如偶極照明)提高了沒有Hopkins法的高精度精密EMF模擬的重要性。



EUV掩膜的OPC和其他結果
圖5左是目標尺寸22nm EUV工藝的模擬OPC曲線。由于波長降低及k1成像因子增加,鄰近效應和掩膜模型的絕對影響比高NA光學情況時小得多。剩余的模型差異很容易用OPC模型的光刻膠內核補償。但是,尚有另一個對于光學掩膜不大明顯而又很重要的效應。EUV掩膜上的吸光體厚度很大,會產生顯著的相變及像差一類的效應。圖5右說明了節距上最佳聚焦位置的明顯變化。有關效應難以用掩膜幾何圖形的修改補償。這些效應對EUV光刻性能的全部影響仍需進一步研究。
晶圓形貌效應
對有圖形晶圓曝光會產生晶圓形貌效應,例如反射V型槽口、光刻膠footing、底部抗反射涂層(BARC)的效率降低,以及其它曝光副產品。不過,晶圓上各種形貌特征光衍射的精密EMF模擬在過去受到的關注還比較少。BARC的應用減少了從晶圓圖形上散射光對光刻曝光的影響。隨著對二次圖形和雙重曝光技術興趣的增加,這種情況已完全改變。在標準的光刻-刻蝕-光刻-刻蝕(LELE)二次圖形曝光工藝中,用有圖形的硬掩膜進行第二次光刻曝光。采用不同形式的光刻膠凍結技術,不同光刻膠光學性質的差異和BARC的光引起的折射率改變能修改光刻-凍結-光刻-刻蝕 (LFLE)工藝的光刻結果。
圖6是LFLE工藝的模擬光刻膠軌跡。第一次光刻工藝用來產生y軸平行的密集(左)或半密集(右)線條,這些用淺藍色圖形顯示。得到的光刻膠圖形凍結后,旋轉涂敷第二次光刻膠,并以密集的x軸平行線條和間距圖形曝光。模擬中假定第一次(凍結)和第二次(沒凍結)光刻膠之間的折射率差為0.03。因此,光刻膠內的強度分布用精密EMF模擬法計算。
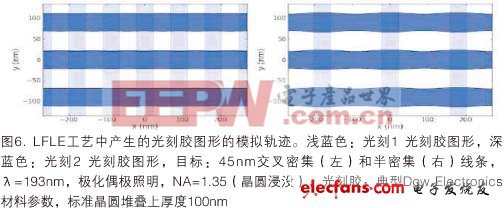
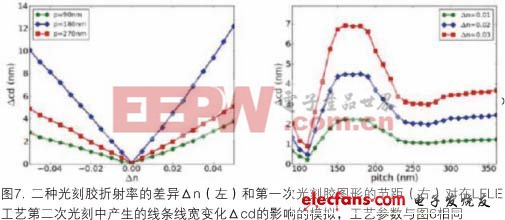
根據圖6,第一次光刻-凍結-旋涂后,不同質光刻膠的光衍射導致第二次光刻工藝中產生的線條線寬變化。線寬變化量Δcd取決于第一次和第二次光刻膠間折射率的差異,及第一次光刻中產生的圖形的節距。定量分析示于圖7。圖7的結果可用來確定合適的光刻膠材料性能指標。
總結與展望
對先進光刻掩膜光衍射的精密EMF模擬已成為預知光刻模擬的必做工作。未來的研究將包括深入探討晶圓形貌影響和亞波長特征圖形的光學計量技術模擬,特別是開發從散射光提取輪廓和材料信息的逆向方法。
透射電鏡相關文章:透射電鏡原理 全息投影相關文章:全息投影原理


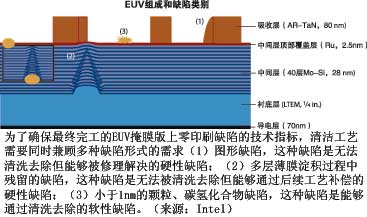
評論