硅片級可靠性測試詳解
引言
硅片級可靠性(WLR)測試最早是為了實現內建(BIR)可靠性而提出的一種測試手段。硅片級可靠性測試的最本質的特征就是它的快速,因此,近年來它被越來越多得用于工藝開發階段。工藝工程師在調節了工藝后,可以馬上利用WLR測試的反饋結果,實時地了解工藝調節后對可靠性的影響。這樣就把可靠性測試糅合和工藝開發的整個過程當中。如今,工藝更新換代非常快,所以,WLR就成為了一種非常有效的快速方法使工藝開發的進程大大加快。同時,各個公司在工藝開發后都會發行一個針對WLR的技術報告,這也為業界廣泛接受。JEDEC也為此專門制定了一個標準,而且不定時的更新其內容。
WLR要測試的項目主要有以下幾大類:①互連線可靠性(電遷移);②氧化膜可靠性;③熱載流子及NBTI;④等離子損傷(天線效應)等。用于工藝開發的WLR流程主要如下。
首先,制定一個WLR計劃,包括對測試樣品的要求(樣品數、測試面積、Lot數等),一些設計規則和所有達到的規范。比如說電遷移中,要給出最大設計電流,器件使用溫度等,評價氧化膜的可靠性時,如果是用斜坡電壓法則要求測試面積大于10cm2,缺陷密度不能大于一定的值(D0);如果是用恒定電壓法,則要給出加在柵極上的電壓分別有多大等等。在評價熱載流子效應時,一般要求熱載流子中直流壽命大于0.2年等。下面詳細介紹一下各個項目。
互連線可靠性(電遷移)
電遷移(EM)是微電子器件中主要的失效機理之一,電遷移造成金屬化的開路和短路,使器件漏電流增加。在器件向亞微米、深亞微米發展后,金屬化的寬度不斷減小,電流密度不斷增加,更易于因電遷移而失效。因此,隨著工藝的進步,EM的評價備受重視。
導致電遷移的直接原因是金屬原子的移動。當互連引線中通過大電流時,靜電場力驅動電子由陰極向陽極運動,高速運動的電子與金屬原子發生能量交換,原子受到猛烈的電子沖擊力,這就是所謂的電子風力。但是,事實上金屬原子同時還受到反方向的靜電場力。當互連線中的電流密度較高時,向陽極運動的大量電子碰撞原子,使得金屬原子受到的電子風力大于靜電場力。因此,金屬原子受到電子風力的驅動,使其從陰極向陽極定向擴散,從而發生電遷移。
傳統的評價電遷移的方法是封裝法。對樣品進行封裝后,置于高溫爐中,并在樣品中通過一定電流,監控樣品電阻的變化。當樣品的電阻變化到一定比例后,就認為其發生電遷移而失效,這期間經過的時間就為在該加速條件下的電遷移壽命。但是封裝法的缺點是顯而易見的,首先封裝就要花費很長的時間,同時,用這種方法時通過金屬線的電流非常小,測試非常花費時間,一般要好幾周。因為在用封裝法時,爐子的溫度被默認為就是金屬線溫度,如果有很大的電流通過金屬線會使其產生很大的焦耳熱,使金屬線自身的溫度高于爐子的溫度,而不能確定金屬線溫度。
所以,后來發展了自加熱法(ISO-thermal)。該方法不用封裝,可以真正在硅片級測試。它是利用了金屬線自身的焦耳熱使其升高。然后用電阻溫度系數(temperature coefficient of resistance,TCR)確定金屬線的溫度。在實際操作中,可以調節通過金屬線的電流來調節它的溫度。實際應用表明,這種方法對于金屬線的電遷移評價非常有效,但是對于通孔的電遷移評價,該方法就不適用了。因為,過大的電流會導致通孔和金屬線界面出的溫度特別高,從而還將無法確定整個通孔電遷移測試結構的溫度。針對這種情況,又有研究者提出了一種新的測試結構——多晶硅加熱法。這種方法是利用多晶硅作為電阻,通過一定電流后產生熱量,利用該熱量對電遷移測試結構進行加熱。此時,多晶硅就相當于一個爐子。該方法需要注意的是在版圖設計上的要求比較高,比如多晶硅的寬度,多晶硅上通孔的數目等都是會影響其加熱性能的。
以上三種方法得到的都是加速測試條件下的電遷移壽命,我們需要的是在使用條件和設計規則電流下的電遷移壽命,利用Black方程來推得我們想要的電遷移壽命。 氧化膜可靠性
集成電路以高速化和高性能化為目標,實現著進一步的微細結構。隨著微細結構在工業上的實現, 降低成本和提高集成度成為可能。另一方面,隨著MOS 集成電路的微細化,柵氧化層向薄柵方向發展,而電源電壓卻不宜降低,柵氧化層工作在較高的電場強度下,從而使柵氧化層的抗電性能成為一個突出的問題。柵極氧化膜抗電性能不好將引起MOS器件電參數不穩定,進一步可引起柵氧的擊穿。柵氧擊穿作為MOS 電路的主要失效模式已成為目前國際上關注的熱點。
評價氧化膜可靠性的結構一般都是MOS電容,評價氧化膜不同位置的特性,需要設計不同的結構,主要有三種結構:大面積MOS電容,多晶硅梳狀電容,有源區梳狀電容等。評價氧



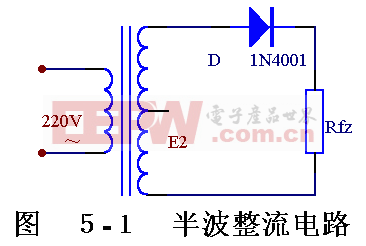

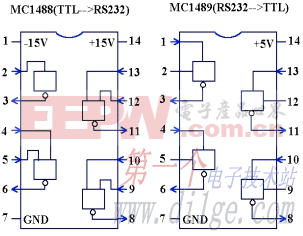


評論