三維集成技術何以助力人工智能芯片開發,推動“新基建”?
2020年4月,國家發展改革委首次明確“新基建”范圍包括三大領域:信息基礎設施、融合基礎設施和創新基礎設施。
本文引用地址:http://www.j9360.com/article/202008/417133.htm其中,兩大領域都直接提及人工智能,在信息基礎設施領域,人工智能與云計算、區塊鏈一起被視為一種新技術基礎設施;在融合基礎設施中,人工智能則被視為支撐傳統基礎設施轉型升級的重要工具。

三維集成技術助力人工智能芯片開發
人工智能作為“新基建”的一部分,發力于科技端,旨在為新一代信息技術和相關行業產業的創新提供算力、算法及算據(數據)層面的基礎支持。其中算力作為人工智能應用的基礎平臺,從技術角度體現為各類型的人工智能芯片。
隨著數據洪流時代的到來,人工智能的重要性日益凸顯,而人工智能芯片的開發成為人工智能技術發展的關鍵一環。在面對急劇攀升的數據量和計算量時,計算和存儲成為了人工智能芯片開發面臨的兩座大山,大規模的數據計算會造成存儲的讀取和返回遠跟不上芯片的頻率,產生嚴重的延遲,影響芯片整體性能的提升。
最理想的解決方案,其實是在三維集成技術架構下,打造真正的存算一體,突破“存儲墻”的限制,所以集超高容量、超大帶寬等特點于一身的存算一體人工智能芯片便應運而生。利用三維集成技術,可實現不同功能、不同技術節點芯片的整合、高密度互連,在成本可控的情況下又不損失性能。三維集成技術正是打造人工智能芯片的理想技術,可推動“新基建”所需要的人工智能的快速發展。

三維集成新技術:多片晶圓堆疊和
芯片-晶圓異質集成
三維集成技術的代表企業武漢新芯,作為國內首家采用三維集成技術生產圖像傳感器、存儲器和AI加速器芯片的制造商,已積累了多年大規模量產經驗,產品集高性能、低功耗、高集成的優點于一體。其中武漢新芯硅通孔(TSV)和混合鍵合技術(Hybrid Bonding)已量產,并應用于兩片晶圓堆疊的非存儲類產品。如基于武漢新芯混合鍵合技術生產的AI加速器芯片正是打破傳統的馮·諾依曼結構的例證,該芯片利用武漢新芯領先的三維集成堆疊技術,將ASIC和Memory芯片堆疊在一起,CPU可直接從堆疊后的芯片中調取數據,縮短了連接距離,增加帶寬的同時降低了功耗,大大提升了芯片的運行效率,該芯片可應用于人工智能和高性能處理器等產品中。
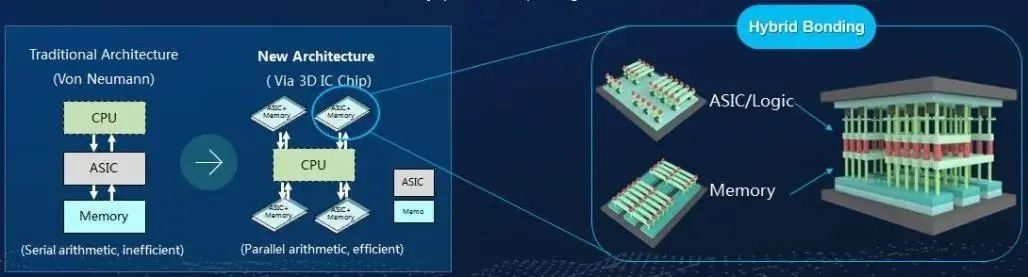
基于現有的三維集成技術平臺,武漢新芯正在積極研發多片晶圓堆疊和芯片-晶圓異質集成技術。
武漢新芯多片晶圓堆疊技術,將晶圓級混合鍵合和高深寬比硅通孔技術結合起來,配合相關臨時鍵合和解鍵合工藝,實現不同功能晶圓垂直互連。運用該技術將DRAM晶圓堆疊互聯,作為數據緩沖,實現對存儲體的高速數據存取。現階段采用后段封裝工藝制造的HBM,因其凸點工藝的局限,存在散熱性能差、連接數有限、生產效率不高等先天弊端,影響存儲容量和帶寬提升空間。針對此問題,利用多片晶圓堆疊技術工藝精度高、連接熱阻低和生產效率高的優勢可進一步減小芯片尺寸,增加帶寬,降低延時和功耗,帶來更好的產品體驗。
武漢新芯多片晶圓堆疊技術計劃于2021年量產,可實現三層及以上的多片晶圓堆疊,達到更低功耗,更高帶寬和更快的傳輸速度,廣泛應用于大數據時代高容量高帶寬存儲產品。

隨著三維集成技術的深入迭代,晶圓廠和封裝廠的技術相互借鑒和融合,逐漸催生出設計與工藝靈活度更高的芯片-晶圓異質集成的技術。
武漢新芯芯片-晶圓異質集成技術突破傳統封裝級連接方式,基于“類晶圓堆疊”混合鍵和技術,可提供晶圓和芯片堆疊在一起的多層解決方案,不再受上下die尺寸要求一致的限制,從而使堆疊方案更靈活,提升堆疊后產品的良率,降低產品成本。

武漢新芯計劃于2022年推出芯片-晶圓異質集成技術,可實現容量和帶寬的倍增,未來將廣泛應用于物聯網、人工智能和5G等多模塊異質系統集成基礎硬件。
武漢新芯三維集成技術平臺可充分滿足客戶靈活多樣的三維集成需求,為下一代全新架構的芯片系統提供強大技術支持。基于三維集成技術平臺開發的人工智能芯片可以使傳統的基礎設施煥發全新的動能,幫助打造信息數字化的基礎設施,助推新基建的實踐發展。







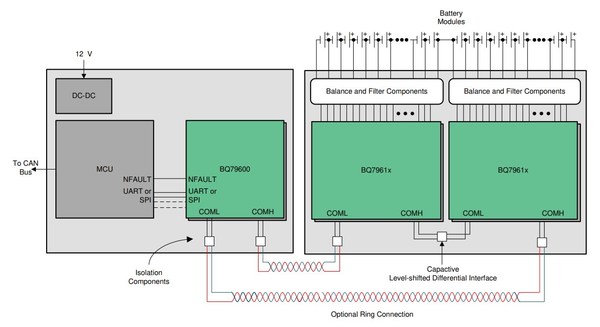


評論