低功耗制造性測試的設計-第二部分
通過設計分割反映功率預算
本文引用地址:http://www.j9360.com/article/201706/347943.htm假設設計的某個時鐘驅動了大量觸發器,以至它們的峰值開關動作超過設計的總體功率預算。我們不希望測試邏輯去改變任何時鐘,相反我們將設計分割成N個模塊,各模塊具有自己的掃描啟動引腳,并且包含自己的掃描壓縮邏輯和掃描鏈。(如圖2所示)模塊的數量和組成需要仔細選取,以便任何單個模塊(包括具有大部分觸發器的模塊)的觸發器開關速率不超過總功率預算。從這方面講,可以認為分割將功率預算硬連(hardwire)進了設計。
向量產生是受限的,因而只有一個掃描啟動腳被激活(SE=1),而ATPG一次只處理一個模塊。ATPG工具以捕獲啟動(SE=0)模塊中的故障和模塊間的故障為目標,將所有其它模塊中的故障都指定為“ATPG不可測試”。所有模塊依次重復這一過程,并在為模塊產生向量之前使用單個命令將模塊中的故障狀態從“ATPG不可測試”改變為“檢測不到”。
將所有開關動作限制于用來測試的模塊,可以有效地降低捕獲模式期間的峰值功耗。但要注意的是,在捕獲模式期間消除其它模塊開關動作的唯一方法是確保上個周期的掃描移位模式和下個周期之間的邏輯狀態沒有變化(對應于被測模塊中捕獲模式的發送階段)。這可以通過將全1或全0掃描進被測模塊實現。遺憾的是,該方法會導致故障覆蓋率的損失,同時需要更復雜的故障清單處理以及產生結束向量進行補償。即使一次只測試一個模塊,我們也希望將向量同時裝載進所有模塊以鎖定模塊間故障。
解決這個兩難問題的方案是利用新思公司的TetraMAX ATPG工具提供的“低功率填充”功能。TetraMAX通常需要用掃描向量中不到10%的位建立并傳播故障效應,因此其不再隨機填充剩余位,而是將每個關注位的值復制到掃描鏈中的后續位,直到下一個具有相反值的關注位。(如圖3所示)
關注位值的復制可以將激勵向量中的邏輯狀態變化減少90%以上。而在不在測試的模塊中,減少程度接近99%(只需要少量關注位即可鎖定模塊間故障),因此足以確保輸入向量的上次移位及后面的發送周期之間幾乎沒有邏輯狀態的轉換。
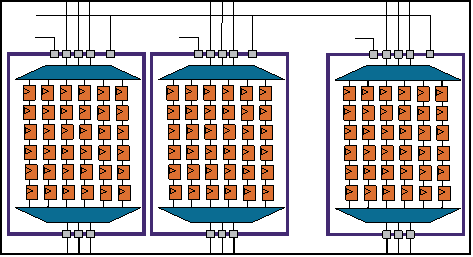
圖2:將設計分割成N個模塊以指定功率預算。
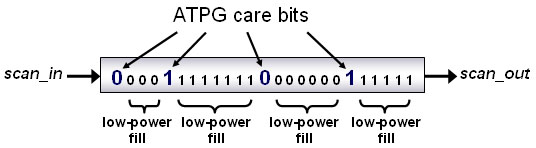
圖3:TetraMAX ATPG工具的“低功率填充”。
低功率填充向量可以檢測額外故障,但比標準ATPG向量要少,因為每個低功率填充激勵中的偽隨機位都被移除了。因此,低功率填充ATPG一般要比標準ATPG產生更多的向量才能獲得相同的故障覆蓋率。盡管如此,本節所描述的技術在壓縮方面非常靈活,如圖4所示:當應用更多的壓縮時,測試周期數只比基本案例(所有掃描啟動沒有被激活,沒有低功率填充)稍多一些。該圖也顯示了在捕獲模式期間由完整向量集與壓縮率之間關系所得到的峰值開關動作。而峰值開關動作的減少幾乎與壓縮率無關。

圖4:測試周期數和峰值開關動作與壓縮率之間的關系。
低功率填充ATPG還能降低掃描移位期間的平均功率,從而節省花在測試儀上的時間乃至成本。一般來說,復制關注位值可以減少激勵向量中90%以上的邏輯狀態轉換,以及減少響應向量中10-50%的邏輯狀態轉換。由于激勵和響應是同時被掃描的,因此觸發器開關動作的凈平均減少量約為50%。本文介紹的技術可以減少更高的量,因為模塊中只有極少的關注位沒被測試到。
在理解低功率填充功能如何工作之后,就很容易了解為什么各模塊要擁有自己的壓縮電路。如果壓縮是“平坦的”(指單個解壓器/壓縮器被嵌在各模塊的頂層而不是里面),那么解壓器輸出就可以分別輸入到所有模塊上的掃描鏈。被測模塊的關注位因而無需被掃描進所有的其它模塊,并導致大量的邏輯狀態轉換。相反,將壓縮電路嵌入到模塊中會使到各模塊掃描鏈的輸出受到限制,從而形成了在移位操作時無法通過的關注位“邊界”。將壓縮邏輯嵌入進設計物理層里還有進一步的好處,即可以減少布線擁塞,最終減少壓縮的面積開銷成本。
通過時鐘域反映功率預算
雖然物理模塊內的嵌入式壓縮有助于減少布線擁塞,但本節介紹的技術無需通過分割設計以反映功率預算。相反,可以使用TetraMAX中獨特的功能將觸發器開關動作預算規定為ATPG制約。
在該種情況下假設設計具備足夠多的時鐘,因而單個時鐘不能控制足夠的電路以超出功率預算。該工具試圖在捕獲模式下只啟動某些時鐘來滿足功率制約。剩余時鐘在捕獲模式中不工作,在移位操作結束時保持其狀態。這意味著這些范圍(邏輯網絡或時鐘網絡)內沒有開關動作,低功率填充的好處僅限于降低掃描移位期間的平均功率。需要注意的是,ATPG必須完全控制所有的時鐘(外部時鐘或PLL產生的時鐘由一個或多個片上時鐘控制器所管理)。
圖5所示設計具有受ATPG控制的7個時鐘域。值得注意的是,用于壓縮的物理模塊的分割不需與時鐘域一致,以確保測試期間的低功率操作。設計中的所有觸發器共享相同的掃描啟動,從而使得所有的故障包括域間故障能一次性地被ATPG發現。這種簡單、高度自動化的流程可以產生緊湊格式的低功率向量集。

圖5:具有7個時鐘域的設計。
本文小結
本文介紹了制造測試過程中引入的動態功耗如何反過來影響被測器件的性能。測試中過高的峰值功耗會增加延遲并導致不可預料的測試結果,而測試期間中過高的平均功率所引起的熱問題則會損壞器件。上述兩個功率問題如果處理不正確將增加制造商的成本,而使用最先進工藝制造的大規模SoC尤其容易受這些問題的影響。
不僅因為這些設計中使用了大量的觸發器,同時還因為需要用更高時間分辨率的實速測試來檢測小延遲故障。為了解決這些問題,設計師們正在整合測試自動化的先進成果和DFT方法來創建低功率制造測試。本文重點介紹了兩種創新性技術,它們可將開關動作降低到與器件任務模式工作時相當的水平。這兩種方法的主要區別在于設計師將功率預算并入DFT過程中的方式。
作者:Chris Allsup
市場經理
測試自動化產品部
Synopsys公司










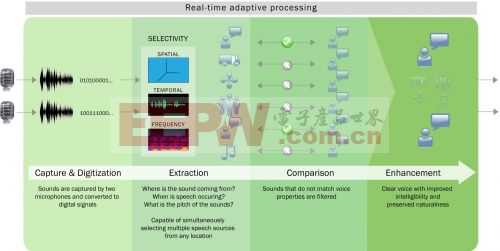
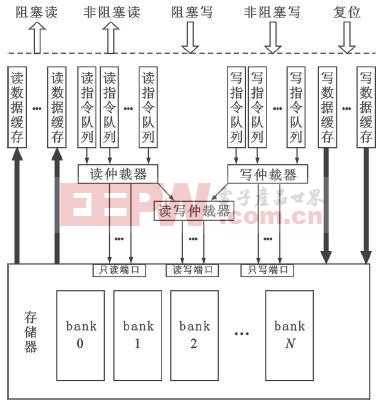
評論