短溝道MOSFET散粒噪聲測試方法研究
近年來隨著介觀物理和納米電子學對散粒噪聲研究的不斷深入,人們發現散粒噪聲可以很好的表征納米器件內部電子傳輸特性。由于宏觀電子元器件中也會有介觀或者納米尺度的結構,例如缺陷、小孔隙和晶粒等,因而也會產生散粒噪聲,并且可能攜帶內部結構的信息。這使人們對宏觀電子元器件中散粒噪聲研究產生了極大的興趣。另一方面,隨著器件尺寸的不斷縮小,MOSFET器件中散粒噪聲成分也越來越顯著,已經嚴重影響器件以及電路的噪聲水平,人們必須要了解電子元器件中散粒噪聲的產生機理和特性,以便更好的抑制器件的散粒噪聲,實現器件和電路的低噪聲化。
對于短溝道MOSFET器件,在室溫條件下,散粒噪聲被其他類型的噪聲所淹沒,一般在實驗中很難觀察到它的存在。目前國內外對于散粒噪聲測試技術的研究取得了快速的進展,但是普遍存在干擾噪聲大、測試儀器價格昂貴等問題,難以實現普及應用。文中所介紹的測試系統是在屏蔽環境下將被測器件置于低溫裝置內,抑制了外界電磁波和熱噪聲的干擾;同時使用低噪聲前置放大器使散粒噪聲充分放大,并顯著降低系統背景噪聲;通過提取噪聲頻譜高頻段平均值,去除了低頻1/f噪聲的影響,使測試結果更加的準確。使用本系統測試短溝道MOSFET器件散粒噪聲,得到了很好的測試結果。文中的工作為散粒噪聲測試提供了一種方法,對短溝道MOSFET散粒噪聲測試結果進行了討論。
1 測試原理
對于短溝道MOSFET中散粒噪聲的測試,主要影響因素包括:外界電磁干擾、低頻1/f噪聲、熱噪聲以及測試系統背景噪聲等。散粒噪聲屬于微弱信號,在實際測試中外界電磁干擾對測試結果影響顯著,將整個實驗裝置放置于電磁屏蔽環境下進行測試,這樣就有效地抑制了外界電磁干擾。散粒噪聲和熱噪聲均屬于白噪聲,在室溫下由于熱噪聲的影響,一般很難測量到散粒噪聲的存在,因此需要最大限度降低熱噪聲的影響。在測試中將待測器件置于液氮環境中,在此溫度下器件熱噪聲相對于散粒噪聲可以忽略。對于器件散粒噪聲的測試,必須通過充分放大才能被數據采集卡所采集,所以要、求放大器要有足夠的增益,同時要求不能引入太大的系統噪聲,否則系統噪聲會淹沒所測器件的散粒噪聲,因此采用低噪聲高增益的前置放大器。對于短溝道MOSFET,其低頻1/f噪聲非常顯著,它對散粒噪聲的影響很大,由于1/f只是在低頻部分明顯,在高頻部分很小,因而可以通過提取噪聲高頻部分的平均值來降低1/f噪聲對測試的影響,使測試結果更加的準確。據此,設計了一種低溫散粒噪聲測試系統。
2 測試系統設計及測試方案
2.1 測試系統設計
測試系統,如圖1所示,主要由偏置電路、低噪聲前置放大器、數據采集和噪聲分析系統組成。將所有測試設備放置于雙層金屬網組成的屏蔽室內,可以有效的抑制外界電磁噪聲的干擾;測試系統低溫裝置是一個裝有液氮的杜瓦瓶,它可以提供77 K的測試溫度,這樣就有效的降低了熱噪聲的影響。Vcc1和Vcc2為電壓可調的低噪聲鎳氫直流電池組,分別為器件提供柵源電壓和漏源偏壓,電池組不能用直流電源代替,因為直流電源的噪聲比較大。
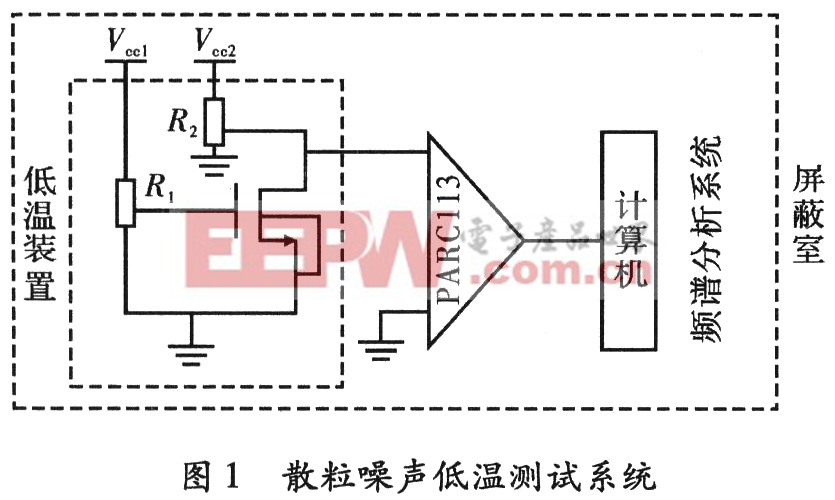














評論