高頻硅PNP晶體管3CG120高溫失效機理研究
摘要:為了保證在高溫條件下,正確使用高頻硅PNP晶體管3CG120,文中對3CG120在不同溫度段的失效機理進行了研究。通過對硅PNP型晶體管3CG120進行170~340℃溫度范圍內序進應力加速壽命試驗,發現在170~240℃,240~290℃,以及290~340℃分別具有不同的失效機理,并通過分析得到了保證加速壽命試驗中與室溫相同的失效機理溫度應力范圍。
關鍵詞:高溫;失效機理;加速壽命試驗;PNP
失效分析的目的是通過總結失效現象,分析失效模式,研究其失效原因和失效機理,為器件的可靠性設計,工藝改進及可靠性增長提供有益的信息。
電子器件有時需要在宇宙空間中運行的衛星、火箭等高溫、高輻射等極端條件下使用,條件非常惡劣,超出了正常使用溫度范圍。并且,隨著技術的進步,對電子器件所要求的可靠壽命也越來越長。這就使得研究器件高溫特性和高溫下的退化特性,分析其高溫下的失效機理及失效原因,從而保證器件在各種溫度條件下正常工作具有重要意義。
文中使用溫度斜坡法,對樣品硅PNP型晶體管3CG120進行170~340℃溫度范圍內序進應力加速壽命試驗,得到樣品在不同溫度下電流增益、擊穿電壓、反向漏電流等電參數的退化規律。并通過對不同電參數退化規律的分析,初步分析在不同溫度范圍內的樣品失效機理。
1 試驗
為了研究樣品3CG120在高溫下的失效模式,失效機理等,文中對樣品3CG120進行序進應力加速壽命試驗,試驗條件及測試參數如表1所示。

2 結果與分析
試驗的樣本量為3支,在Ti=170~340℃溫度范圍內,試驗樣品372#、373#、374#表現出的退化規律比較一致。測試數據hFE如圖1所示。

如圖1,參數hFE的退化過程可分為A、B、C、D 4段。各溫度段內參數的退化規律如表2所示。
分析各參數的退化規律,直流增益hFE仍然是第一位的失效敏感參數,下面從理論上分析其退化機理,同時,參照其他參數的變化規律對其進行分析。
本試驗中,根據晶體管原理:hFE=IC/IB (1)
式中,IC、IB分別為收集極、基極電流。
根據半導體物理關于PN結的理論可知:PN結的正向電流由擴散電流和復合電流Ire兩部分組成。當晶體管工作在有源放大區時,發射結勢壘區內存在著凈復合,這股復合電流的表達式為:![]()
式中:xm為發射結耗盡層厚度;AJ為發射結面積;VE為正向電壓。
由(2)式可知,復合電流Ire和耗盡區的體積xmAJ成正比;由(1)式可知,直流增益與復合電流成反比。當存在表面電場時,就會影響耗盡層總的體積,從而影響到發射結正向電流中復合電流的成分變化,進而影響直流增益hFE的大小。
根據文獻,pn結總的反向電流IR為:![]()
式中,Igen,MJ為結耗盡區中形成的產生電流;Igen,FIJ為柵電極下的表面耗盡區產生電流;Igen,s為Si-SiO2界面陷阱引起的產生電流。
下面結合試驗情況對樣品的失效機理進行分析。
第1段:175~240℃,在進行序進應力加速壽命試驗時,發射結通過正向大電流,由于基區濃度遠小于發射區濃度,故正向電流主要由空穴組成。這些空穴通過發射結耗盡層時形成正的空間電荷,這種正空間電荷在發射結Si-SiO2界面形成的電場,將排斥SiO2層中的可動正離子趨向遠離Si-SiO2界面。故可動正離子會被排斥到SiO2上表面,相當于在SiO2上表面加一負電場VGBE,如圖2所示。試驗過程中的溫度上升會促使正離子的這種運動,而且時間愈長在正離子在SiO2上表面堆積愈多,也即相當于VGBE愈大,這將使基區表面從堆積到耗盡。集電結也通過反向空穴大電流,在集電結耗盡層Si-SiO2界面形成相對于SiO2層的正向電場,排斥SiO2層中的可動正離子趨向遠離Si-SiO2界面,使集電結基區表面逐漸耗盡,集電區表面逐漸堆積。
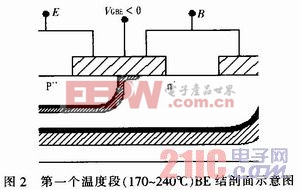
隨著溫度的升高,發射結基區耗盡層逐漸擴展,表面復合電流也逐漸增加,導致基極電流IB隨之增加。由公式(1)可得,hFE隨著試驗的進行在第一個溫度段(170-240℃)逐漸下降如圖1所示。

而由于IEBO的測試條件是反向電壓2 V,2 V反壓造成的耗盡層寬度大于表面感應耗盡層的寬度,故表面耗盡層的變化沒有影響到ICEO的大小,如圖3所示。而ICBO的測試條件是反向電壓10V,由于集電結基區表面耗盡,集電區表面堆積,對漏電流影響不大,故ICBO在此溫度段變化也不大,如圖4所示。

擊穿電壓BVCEO、BVCBO形成的耗盡層都大大超過試驗條件下產生表面耗盡層的寬度,故在本溫度段耗盡層的變化不能影響BVCEO、BVCB O,即二者在此溫度段變化不大,如圖5所示。
第2段:240~290℃,進入第二段后,溫度達到240℃以上,結溫達到270℃以上,集電區摻雜密度為1015。在此條件下,集電區產生本征激發,出現大量熱電子、空穴,在反向偏壓VBC及第一段積累形成的VGBC的作用下,BC結上方Si-SiO2界面發生熱空穴注入,SiO2界面中空穴的積累,將導致集電區表面耗盡。而ICBO隨溫度上升指數增加,同時由于集電區本征激發產生的大量電子及集電結耗盡層的增加,進一步加大了ICBO。在試驗條件下,過大的ICBO大大超過了IB,造成大量電子在基區堆積,使基區電位下降,與發射區形成正向壓降,降低發射結勢壘,基區大量電子擴散過發射結。此時,發射結電流不再主要由空穴組成,而由電子、空穴共同組成,即空穴在發射結Si-SiO2界面形成的電場被抵消。這就導致在高溫下,發射結SiO2層中的可動正離子將逐漸恢復正常分布,從而使第二段hFE恢復到正常值附近如圖1所示。
在此溫度段,發射結空穴注入,并在SiO2界面處形成堆積,使集電結基區表面耗盡層逐漸消失,集電區表面逐漸耗盡。由于集電結表面耗盡層的增大,由公式(3)可知,柵電極下的表面耗盡區產生電流Igen,FIJ和Si-SiO2界面陷阱引起的產生電流Igen,s都大大增加,從而導致了ICBO的大大增加,如圖4所示。
擊穿電壓BVCEO、BVCBO形成的耗盡層都大大超過試驗條件下產生表面耗盡層的寬度,故在本溫度段耗盡層的變化不能影響BVCEO、BVCBO,即二者在此溫度段變化不大。
第3段:290~340℃,隨著溫度繼續升高,BC結上方Si-SiO2界面熱空穴持續注入,在SiO2界面空穴繼續堆積,使集電區表面反型,如圖6所示。歐姆接觸的金屬A1離子開始融入發射結,造成結損傷,使hFE重新下降。
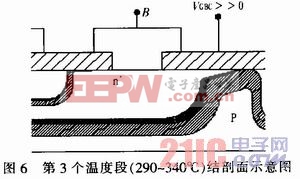
在這一試驗溫度段,漏電流ICBO和ICEO出現了圍繞初始值減小的現象,如圖3、圖4。分析認為:BC結表面出現反型層,由于失掉了Si-SiO2界面處復合中心,所以反向電流變成了:IR=Igen,MJ+Igen,FIJ,所以反向電流相對于第二溫度段(240~290℃)的反向電流大大減小,但仍大于Igen,MJ。
第4段:340℃-,試驗溫度在340℃之后,直流增益hFE表現出迅速減小的現象。使得該電流驟增,造成發射結局部發生不可逆的損傷,直流增益hFE迅速減小。同時造成了漏電流IBEO迅速增大,而擊穿電壓BVBEO快速減小的退化現象,如圖5所示。
3 結論
文中通過對硅PNP型晶體管3CG120進行170~340℃溫度范圍內序進應力加速壽命試驗,對3CG120在不同溫度段的失效機理進行了研究,發現在170~240℃溫度段內,樣品的失效機理是:發射結中通過的正電荷,排斥SiO2層中的可動正離子趨向遠離Si-SiO2界面,這將使基區表面從堆積到耗盡,導致復合電流增大,而引起增益的下降。
而在240~290℃溫度段內,集電區產生本征激發,出現大量熱電子、空穴,在反向偏壓VBC的作用下,BC結上方Si-SiO2界面發生熱空穴注入,導致增益改變;在290~340℃溫度段內:BC結上方Si-SiO2界面熱空穴持續注入,在SiO2界面空穴繼續堆積,使集電區表面反型,導致增益的迅速下降。與室溫失效機理一致的范圍為:室溫至240℃。




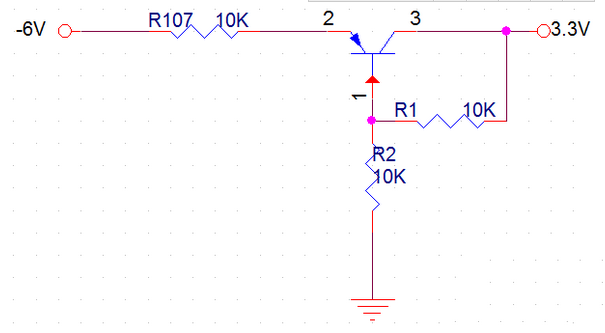
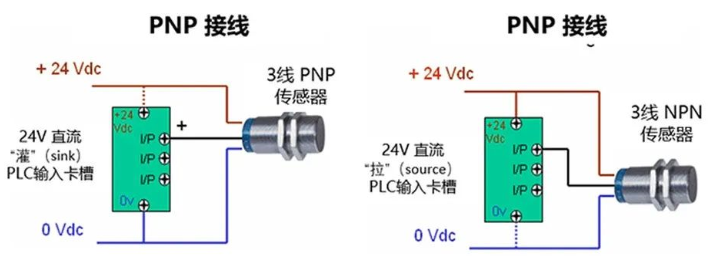

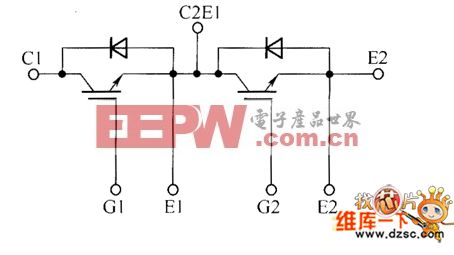
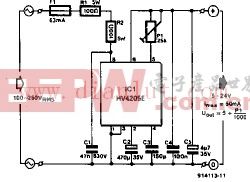

評論