2.5D封裝+28nm,FPGA迎來革命性突破
68億只晶體管、1,954,560個邏輯單元(容量相當于市場同類最大28nm FPGA的兩倍)、305,400個CLB切片的可配置邏輯塊(CLB)、21,550Kb的分布式RAM容量、以及2,160個DSP slice、46,512個BRAM、24個時鐘管理模塊、4個PCIe模塊、36個GTX收發器(每個性能達12.5 Gbps)、24個I/O bank和1,200個用戶I/O、19W功耗……是的,您沒有看錯,這一連串令人眼花繚亂的數字,就是賽靈思(Xilinx)日前宣布可正式供貨的“世界最大容量”FPGA Virtex-7 2000T為我們呈現出的令人震撼的性能指標。
本文引用地址:http://www.j9360.com/article/127251.htm 2010年10月,Xilinx高調宣布推出業界首項堆疊硅片互聯技術(SSI,Stack Silicon Interconnect)。該公司全球高級副總裁兼亞太區執行總裁湯立人強調說,之前曾有廠商試圖通過將兩個或多個FPGA進行邏輯互聯,創建出更大型的“虛擬FPGA”,最終實現復雜設計。但往往由于可用I/O數量有限,再加之FPGA間信號傳輸造成的時延限制性能,以及使用標準的器件I/O來創建多個FPGA之間的邏輯連接增加功耗等因素,這些努力都宣告失敗。而SSI技術的核心則來自于賽靈思專利的ASMBL架構、微凸塊技術以及TSMC的硅通孔(TSV)技術。
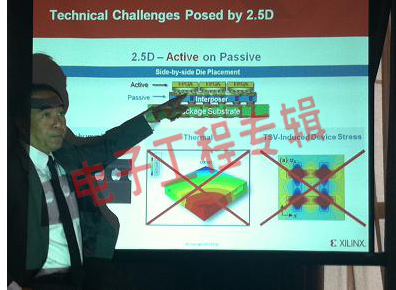
2.5D SSI的主要技術突破
Virtex-7 2000T是Xilinx采用臺積電(TSMC)28nm HPL工藝(低功耗高介電層金屬閘技術)推出的第三款FPGA。更重要的是,這將是“世界上第一個采用SSI技術的商用FPGA”。賽靈思方面將該項技術命名為2.5D SSI。湯立人堅持認為,2.5D并不意味著就比傳統意義上的3D封裝性能差。事實上,如果將邏輯單元與內存進行垂直堆疊(Vertical Stacking),也就是所謂的3D封裝,現在面臨著散熱、RAM/Logic等有源層之間因為膨脹系數不同,導致內部應力不均,影響晶體管性能等多項重要挑戰。“賽靈思同樣看好不帶中介層的完全3D IC堆疊技術前景,但從目前來看,該技術在整個產業中實現標準化還要花更長的時間。”
“我們的2.5D SSI結構采用并排式芯片布局,將4個經ASMBL架構優化的FPGA Slice并排排列在硅中介層上,Slice之間擁有超過10,000個過孔走線,時延僅為1納秒。然后再通過微凸塊將硅片連接至硅中介層。”湯立人進一步解釋說,“由于采用的是大量低延時、芯片間互連,并連接至球形柵格陣列,從而也避免了垂直硅片堆疊方法出現的熱通量和設計工具流問題。”
幾項關鍵技術中,賽靈思專有的ASMBL架構是實現SSI技術的基礎。在該基礎之上,賽靈思又進行了三項重大改進:首先,每個芯片Slice接收自己的時鐘和配置電路;其次,對走線架構進行了改進,通過對芯片進行表面鈍化處理,實現了FPGA邏輯陣列內部布線資源的直接連接,繞開了傳統的并行和串行I/O電路;最后,對每個芯片Slice進行進一步加工,形成微凸塊,以便將芯片連接到硅基片上。與采用傳統I/O相比,正是這項創新使連接的數量大幅增加,同時又顯著降低了時延和功耗(與標準I/O相比,單位功耗芯片間連接功能可提高約100倍)。
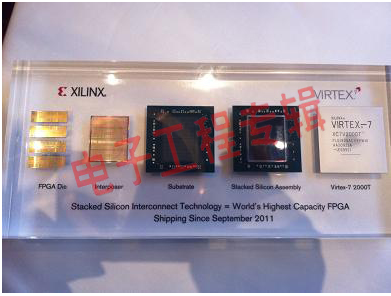
來自TSMC的無源硅中介層也功不可沒。湯立人介紹說,硅中介層最初是針對各種芯片堆疊設計方法而開發的,相當于硅片中一種微型電路板,其上并行放置多個芯片并相互連接。與有機或者陶瓷基片相比,硅中介層能夠提供更好的互聯幾何構造(走線間距可縮小約20倍),以提供器件規模的互聯層級,實現超過1萬條芯片間連接。
通過結合使用硅通孔技術與受控的塌落芯片連接(C4)焊錫凸塊,賽靈思得以將FPGA/中介層堆疊用倒裝片組裝技術貼裝到高性能封裝基片上。這種大節距硅通孔為并行和串行I/O,電源/接地、時鐘、配置信號等提供了封裝和FPGA之間的連接。




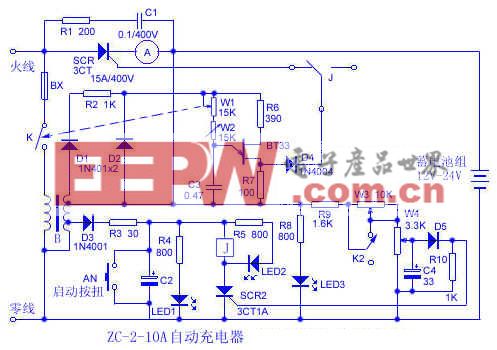







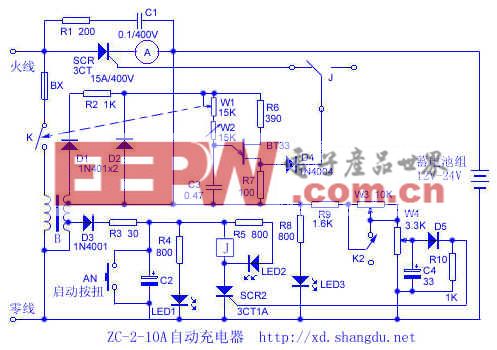


評論